Введение
Сегодня с быстрым развитием электрифицированных отраслей, таких как электротранспорт, самолётостроение, средства электропитания и т.д., очень актуальным становится создание эффективных силовых ключей. Ключевые высоковольтные тиристоры из-за наличия на пути протекания тока трёх p-n-переходов и низкого быстродействия не отвечают современным требованиям по статическим и динамическим потерям. Зарубежные полупроводниковые компании при построении высоковольтных ключей активно переходят на широкозонные материалы (SiC). В России из-за отсутствия технологий по созданию широкозонных материалов SiC работы по созданию таких приборов находятся на начальных этапах.
Транзисторы со статической индукцией (СИТ) с планарным затвором с доработанной конструкцией способны работать на частотах до 10 мГц при рабочих напряжениях 500–1200 В [1]. В этом диапазоне рабочих напряжений они имеют очень низкое сопротивление канала и высокое быстродействие. Дальнейшее повышение рабочего напряжения требует увеличения ширины высокоомной области стока. Это приводит к существенному росту сопротивления канала и снижению быстродействия, так как модуляция канала неосновными носителями – дырками из затвора, из-за их низкой подвижности, на большую глубину происходит медленно и неэффективно. Поэтому при рабочих напряжениях выше 1500 В наиболее эффективно применять тиристоры.
Тиристор – это прибор, у которого низкоомная подложка имеет р⁺-область. В открытом состоянии прибора из подложки в канал впрыскиваются неосновные носители и эффективно модулируют его.
Первые управляемые тиристоры появились в 1955 г., когда стало возможным получение кремния высокой чистоты. Они имели четырёхслойную структуру и получили название «тиристор». Он включался подачей импульса на электрод управления при положительном напряжении между анодом и катодом. Выключение тиристора обеспечивается снижением протекающего через него прямого тока до нуля. Это требует дополнительно большого количества элементов, что увеличивает стоимость и массо-габариты [2].
Следующее развитие тиристор получил в 1960 г., когда в США был разработан прибор, способный запираться с помощью управляемого электрода, и получил название Gate Turn Off (GTO) – выключаемый тиристор. Выключаемый тиристор – полностью управляемый полупроводниковый прибор. Включение и выключение происходит путем подачи положительного и отрицательного, соответственно, импульса на электрод управления. На рис. 1 приведены условное обозначение (а) и структурная схема (б) выключаемого тиристора [2].
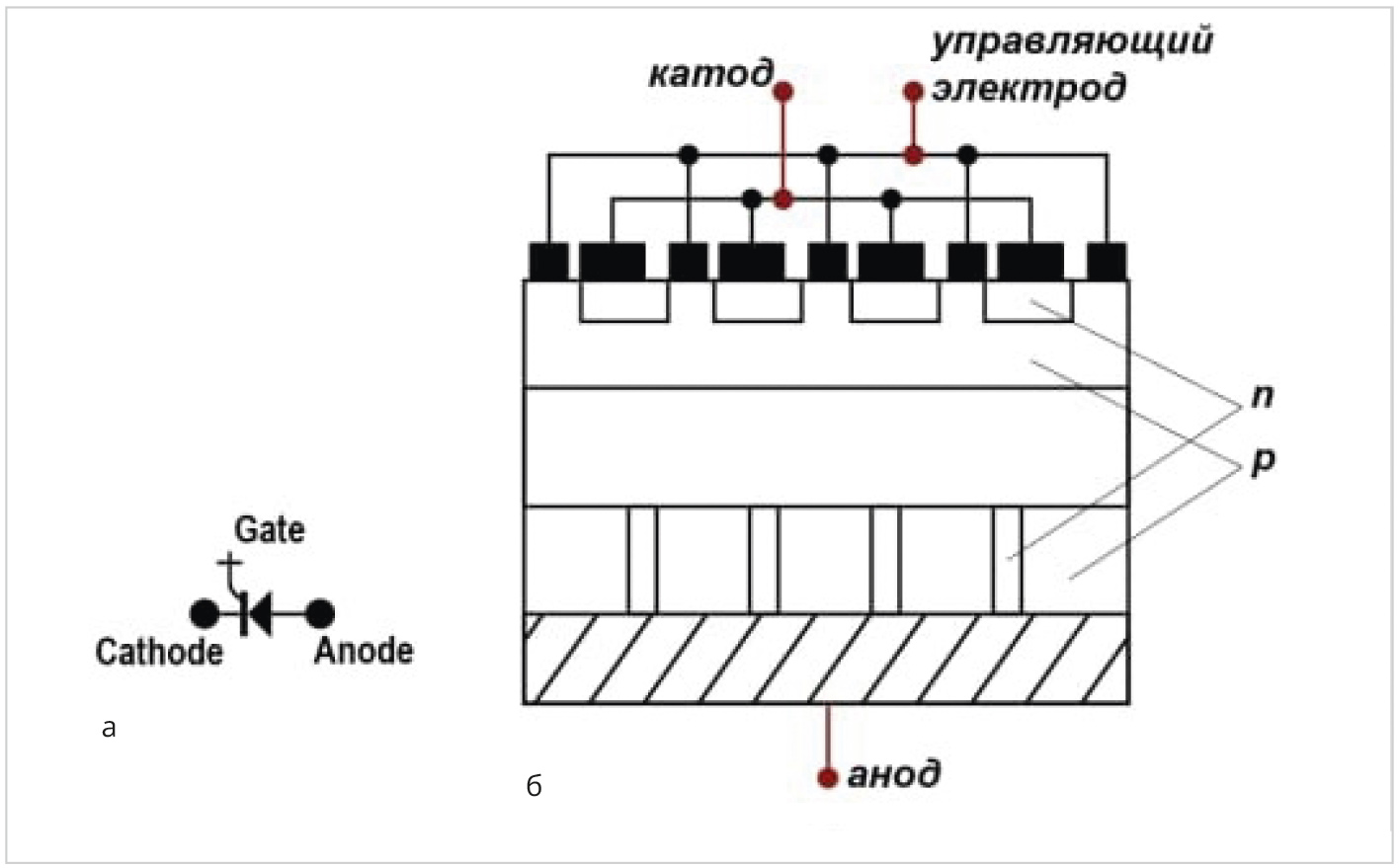
В середине 90-х годов был разработан новый вид тиристоров Gate Commutated Thyristor (GCT). Он является дальнейшим усовершенствованием GTO и лишён его недостатков. Далее развитие тиристоров пошло по пути создания жёсткого управления – создание драйверов, совмещённых с пластинами охлаждения (англ. Integrated Gate – Commutated Thyristor (IGСT)) [3].
Быстрое развитие в начале 90-х годов технологии силовых транзисторов привело к появлению нового класса приборов – биполярных транзисторов с изолированным затвором (IGBT – Insulated Gate Bipolar Transistors). Основными преимуществами IGВT являются высокое значение рабочей частоты (20–30 кГц), КПД, простота в управлении. В последние годы IGВT потеснили тиристоры GTO в устройствах мощностью 1 МВт и напряжением до 3,5 кВ.
Первый тиристор со статической индукцией (ТЭУ) был изобретён И. Нишизавой в 1975 году [4]. Он, как и первые СИТ, имел заглублённый затвор. Заглублённый затвор имеет недостаток – большое сопротивление. Это ограничивает высокочастотные свойства прибора и не позволяет вводить прибор в биполярный режим работы. В 1982 году Й. Накамура предложил конструкцию ТЭУ с планарным затвором [5], свободную от этого недостатка. Однако обе эти конструкции обладают ещё одним негативным свойством: у них в открытом состоянии инжекция неосновных носителей из области затвора происходит по всей площади затвора и на периферии. При выключении тиристора неосновные носители в канале выводятся гораздо быстрее, чем на периферии и под площадками катода и затвора (рис. 2).
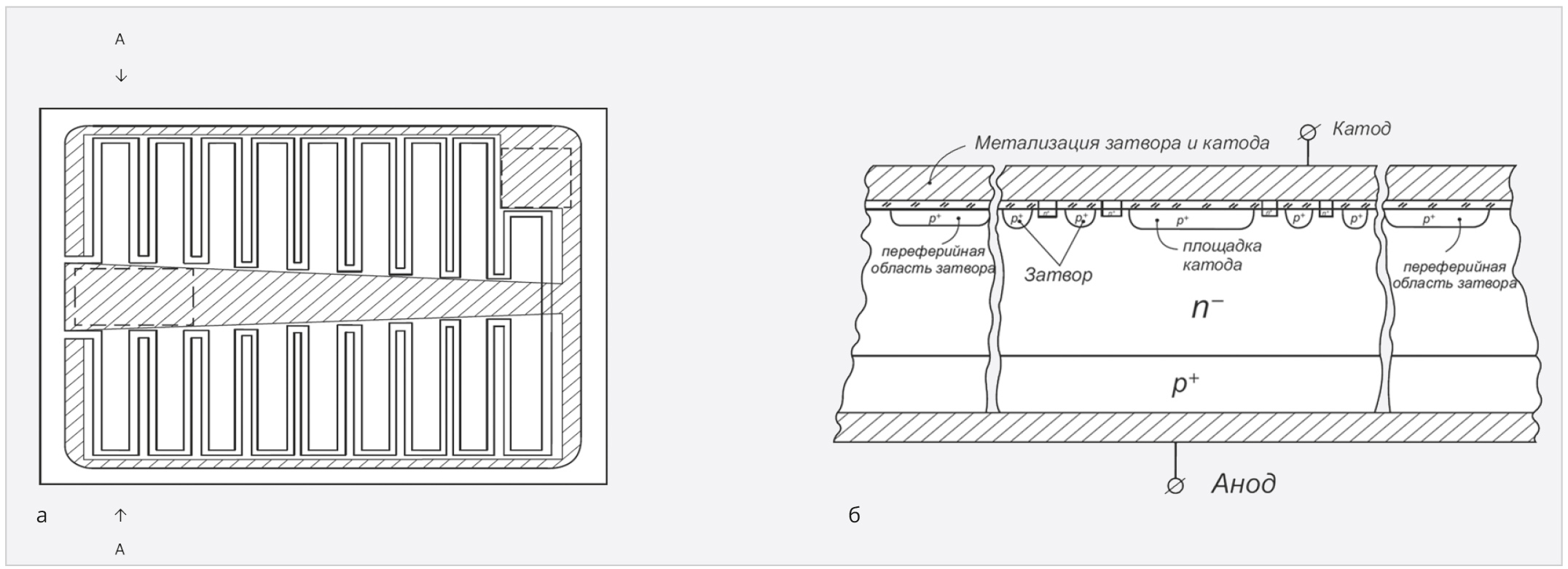
Это приводит к затягиванию выключения и ограничивает быстродействие.
Тиристоры с электростатическим управлением имеют преимущество по остаточному напряжению перед биполярными тиристорами и приборами IGBT, так как на пути протекания тока имеют один р-n-переход, а не три, и, соответственно, падение напряжения на них в открытом состоянии меньше. Также они более скоростные, потому что удаление неосновных носителей происходит через затвор. В IGBT, после закрытия входного МОП-транзистора, цепь эмиттер-коллектор прерывается, и неосновные носители медленно рекомбинируют в базовой области, что затягивает выключение.
Автором данной работы предложена конструкция ТЭУ, свободная от недостатков конструкций, описанных в [4, 5]. Для исключения «паразитной» инжекции дырок из затвора под площадками катода, затвора и периферийных областей последние отключаются от области затвора высокоомной n–-областью стока (рис. 3). Причём расстояние a между затвором и областями под площадками и периферией должно быть как можно больше, но не более значения, при котором происходит преждевременный поверхностный лавинный пробой. Отключение этих областей от затвора имеет ещё один положительный момент – уменьшается ёмкость затвора. При увеличении напряжения на тиристоре происходит смыкание ОПЗ этих областей и подключение к ёмкости затвора ёмкостей отключённых областей, поэтому а должно быть как можно больше. Правда, их подключение происходит через высокоомный резистор, и увеличение ёмкости затвора незначительно.

Для исключения «паразитной» инжекции дырок из анода между n–- и р⁺-областями анода в местах под площадками и на периферии формируется стопорный слой n+ (рис. 4). Этот слой не даёт дырок в местах инжекции.
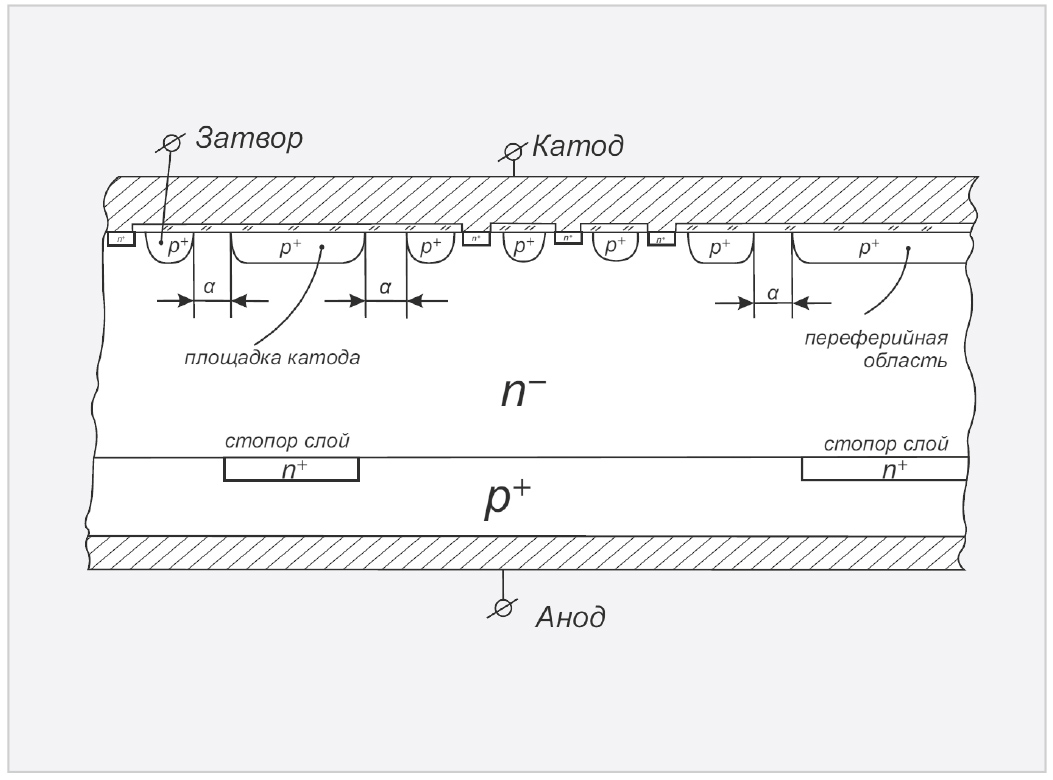
В современных тиристорах между n–- и р+-областями есть стопорный слой, но он формируется для ограничения ОПЗ и повышения, соответственно, максимального рабочего напряжения. Концентрация примеси в нём невысокая, что не препятствует инжекции дырок из р+-области в n–-область.
Время переключения тиристора зависит от величины эффективной ёмкости затвора (Свх эф), которая определяется уравнением:
Свх эф = Сзи + Сзс (1 + M*) + Сз к + Сз пл, (1)
где M* – коэффициент усиления;
Сз к – ёмкость, определяемая неосновными носителями в канале;
Сз пл – ёмкость, определяемая неосновными носителями под площадками и на периферии.
В линейном приближении Tпер = 2,2Свх эф (Rг + Rз), (2)
где Tпер – время переключения;
Rг – выходное сопротивление генератора запускающих импульсов;
Rз – сопротивление области затвора транзистора.
Точный расчёт Сз к и Сз пл не представляется возможным, но очевидно, что неосновные носители, определяющие их величину в канале и под площадками катода, затвора и на периферии, рассасываются по разным законам: в канале они вытягиваются полем и рекомбинируют с электронами, летящими из катода; под площадками и на периферии – медленно дрейфуют к затвору.
Ясно, что Сз пл больше всех остальных, и её устранение существенно повышает быстродействие тиристора. Кроме того, отключение «паразитных» областей уменьшит Сзи и Сзс почти в два раза. Сегодня ТЭУ с такой конструкцией ещё не изготовлены, но ожидается, что при её реализации уменьшение Тпер будет более чем на порядок.
Замена n+-областей катода на изотипный гетеропереход позволит проводить глубокую модуляцию высокоомной области анода основными носителями, что, в свою очередь, позволит увеличить рабочее напряжение тиристора до 10 кВт и выше и снизить сопротивление канала в открытом состоянии на несколько порядков, увеличить быстродействие. Это, в свою очередь, позволит снимать больший ток с единицы площади кристалла.
Данная конструкция ТЭУ является одной из лучших, выполненных на Si. Для её реализации можно использовать хорошо отработанную технологию, описанную в [6]. Однако наиболее интересные конструкции ТЭУ будут на GaAs, так как этот материал имеет подвижность электронов почти в восемь раз выше, и ширина запрещённой зоны больше. Это позволяет создавать более высоковольтные приборы с более высокой скоростью переключения.
Авторами данной работы предложена конструкция для создания ТЭУ на GaAs по технологии Trench на принципе максвелловского «сшивания» пограничных сред [7]. Схематичный разрез кристалла показан на рис. 5.
![Рис. 5. Разрез кристалла ТЭУ с МОП полевым управлением [7]](/images_soel/publications/2023/2023-5/Максименко%20ТИРИСТОР%20СО%20СТАТИЧЕСКОЙ%20ИНДУКЦИЕЙ%20pic05.jpg)
Тиристор представляет собой ТЭУ с МОП полевым управлением. Подзатворный окисел должен быть выполнен из диэлектрических материалов с высоким значением диэлектрической проницаемости εox >> εGaAs, т.е. из комбинаций окислов металлов, таких как Ti, Ta, Hf, Cd и др., с обязательным буферным нанослоем (< 10 нм) широкозонного изолятора. Это не позволит переходить грань плотности поверхностных зарядовых состояний Nss больше чем 3…5⋅1011см–2. В конструкции, приведённой на рис. 4, применён диэлектрик из двуокиси гафния.
Из соотношения Масквелла ε₁ε₀E₁ = ε₂ε₀E₂ (3) следует, что соотношение выделяемого падения напряжения на р-n-переходе и в оксиде гафния определяется как
Up-n-= (εHf02 · UHf02 · Wр-n) / (εSi · dHf02); (4)
К = Up-n-/ UHf02 = (εHf02 · Wр-n) / (εSi · dHf02), (5)
т.е. К ≈ от 200 ~ 250. Это говорит о том, что все приложенное напряжение к затвору будет переходить на р-n-переход.
Плотность заряда инверсного канала несравнимо более высокая, чем в кремниевых JGT и карбид-кремниевых MOSFET, а подвижность электронов в канале, или, точнее говоря, дрейфовая скорость пролёта электронов в i-GaAs-MOSFET, в 20 раз превышает кремниевый дрейф и тем более карбид-кремниевую скорость пролёта. Что же касается «проходных» и «выходных» RC-цепочек, то и здесь преимущество будет за GaAs вследствие того, что выходная ёмкость при нуле смещения как минимум в 30 и в 10 раз меньше, чем в SiC- и Si-MOSFET соответственно (мощность динамических потерь при перезарядке/переключении управляющего драйвера). Сопротивление открытого канала у GaAs-TЭУ (Rk GaAs) меньше, чем в Rk SiC-MOSFET, так как идёт мощная инжекция носителей из анода.
Катод можно делать как n⁺-область либо гетероинжекционным. На рис. 6 и рис. 7 показаны зонные энергетические диаграммы активной истоковой области кремниевого и арсенид-галлиевого ТЭУ с гетероистоком. Принципы работы обеих конструкций одинаковы, а именно: при подаче положительных потенциалов относительно катода на анодную и затворную активные области происходит инжекция дырочных носителей заряда в зону канала катод-анод с одновременной термоэмиссионной (на начальной стадии) и инжекционной поставкой электронов в канал катод-анод для создания нейтральной проводящей электронно-дырочной плазмы (ЭДП) в n-канале, вследствие чего его проводимость возрастёт на порядки. Но имеются и существенные отличия.

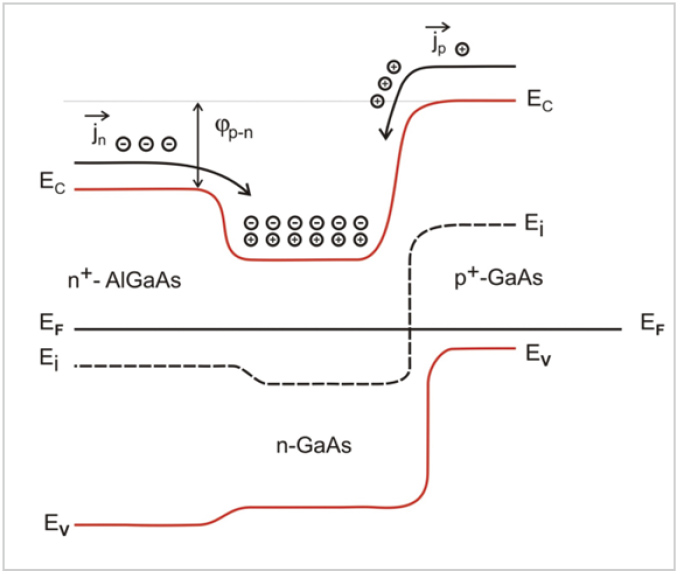
1. На зонной диаграмме видно, что из-за наличия гетеропереходного n+-эпитаксиального слоя резко снижается барьерный потенциал ϕp-n затвор-катод, а это означает резкое снижение динамических потерь при подаче импульсного тока прямого смещения через затвор-канал, что повысит КПД коммутации ТЭУ.
2. Катод выполнен в виде изотипного гетероперехода n+-AlGaAs − n-GaAs, который представляет собой униполярно-инжекционный диодный переход, т.е. n-канальная область, в принципе, даже при отсутствии инжекции на p+-n-переходе затвор-канал, может модулироваться достаточно плотной инжекцией электронов из гетерослоя с уровнем энергии от 1,6 до 1,8 эВ, с диффузионной длиной электронов Ln до 30…60 мкм, что на 0,17…0,37 выше, чем в n-канальной области, и к тому же с большой глубиной модуляции проводимости в канале σ = qnµn, где q – заряд электрона, n – концентрация инжектированных носителей заряда, µn – подвижность электронов.
3. В связи с тем, что соотношение µn GaAs/µn Si ≈ 6,6, а в кремниевом канале (без инжекции дырок из затвора) при полевом воздействии катод-анод доминирует термоэмиссионный механизм, который хорошо раскрыт в монографиях по диодам Шоттки, или, иными словами, протекание тока в кремниевом n+-n-р+-канале будет представлять собой не что иное, как перенос тока в слаботочном стабисторе с насыщением тока вследствие насыщения подвижности электронов. В отличие от кремниевого n+-n-типа катода, в нашем случае из катода n+-AlGaAs/n-GaAs будет наблюдаться мощная инжекция электронов изотипного перехода в n-типа канал. Образуется высокоплотная электронно-дырочная плазма (ЭДП).
Электронно-дырочная плазма в GaAs канале очень подвижна из-за высокой амбиполярной подвижности электронно-дырочных носителей заряда.
При подаче запирающего напряжения (Uз < 0 В) на p+ затвор будет происходить процесс релаксации ЭДП-заряда с дифференцированным вытеканием дырок в затворную область, электронов – в анодную область, а также с процессами рекомбинации носителей заряда (зона/зона); зона – рекомбинационные центры в запрещённой энергетической зоне. Например, на атомах кремния, являющегося катализатором LPE (Liquid-Phase Epitaxy) – жидкофазного эпитаксиального процесса.
При запорном (отрицательном) напряжении на затворе после релаксации ЭДП в истоковой области между затворами p+-типа возникает область пространственного заряда, блокирующая протекание тока в канале между гетероистоком n+-AlGaAs/n-GaAs и GaAs р+-анодом.
Конкретный пример исполнения AlGaAs/GaAs ТЭУ состоит в следующем.
На р+-GaAs монокристаллической подложке после химико-динамической полировки (ХДП) пластины, в частности, на установке Logitech в реакторе кварцевой трубы с заданным градиентом температуры в пределах 750…900°С, из расплава GaAs (источник атомов As) и Ga выращивается эпитаксиальный слой GaAs n-типа проводимости.
Концентрация доноров ND контролируется уровнем лигатуры атомов Si, Te или Sn. В частности, как правило, ND регулируется в пределах 1014…1015 см–3, с толщинами эпитаксиального слоя от 10 до 50 мкм, что соответствует диапазону электропрочности p-n-перехода (затвор-сток) в пределах максимальных напряжений пробоя Uпроб. СИ = 200…800 В.
Затворная p+-область создаётся методом диффузии атомов Zn (из насыщенного цинком графита) в среде водорода через маску из плёнок Si3N4 толщиной от 0,3 мкм (нитрида кремния с усилением в некоторых случаях дополнительным оксидным слоем кремния SiO2, осаждённого газофазным методом, толщиной от 0,5 мкм).
Расстояние Ln (ширина канала под катодом) между p+-затворными областями при проектировании полосковой топологии катода и затвора транзистора выбирается из условия:
 , (6)
, (6)
где ϕT – собственный потенциал p+-n-перехода, который рассчитывается по формуле:
 , (7)
, (7)
где k – постоянная Больцмана; T – температура по Кельвину; ND – концентрация донорной примеси в n-типа канале; NA – концентрация акцепторной примеси в p+-типа затворе(справочно: при T = 25°C значение kT/q = 0,026 эВ).
Исходя из вышеприведённых формул, n-типа канал под гетерофазным катодом при UЗИ > 0 В – открыт и является проводящей областью; при UЗИ << 0 область канала под гетероистоком становится не проводящей для потока электронов, а изотипной. n+-AlGaAs/n-GaAs переход будет закрыт для инжекции электронов.
Эпитаксиальный AlGaAs слой толщиной 1...3 мкм выращивается либо LPE, либо MOCVD-методом, легируется атомами теллура или олова с уровнем концентрации примеси выше, чем 1018см–3.
Для снижения прямых потерь напряжения на омических контактах на поверхности n+-AlGaAs может быть нанесён дополнительный LPE или MOCVD эпитаксиальный n+-GaAs слой в пределах 1…3 мкм с более высокой концентрацией донорной примеси, чем в n+-GaAs слое, с туннельно-дрейфовым переносом заряда электронов из n+-GaAs слоя в n+-AlGaAs слой. Омические контакты выполняются на основе системы AuGe (80 нм) / Ni (100 нм) / Au > (2000 нм).
Травление меза-области проводится в две стадии (в магнитомешалке):
- глубокое травление в серно-перекисном растворе в соотношении 1:1;
- полирующее травление в серно-перекисном растворе с более слабой концентрацией серной кислоты в соотношении 1:3.
Контроль параметров кристалла производится на зондовой установке с подогревом кристалла на контактном столике до +250…+300°С.
Данный тиристор, вероятно, следует принимать во внимание в качестве абсолютного конкурента Si-IGBT-, SiC-MOSFET- и Si-MOSFET-транзисторам. Фактически это новое семейство ещё неизвестных на мировом рынке GaAs полевых тиристоров с изолированным затвором, которые можно будет обозначить следующим образом: гетероинжекционный полевой тиристор со статической индукцией, имеющий комбинированное гетеро-MOS/p-n-управление проводимостью канала, или HMOSJFET (где H – гетероинжекционный, MOS – МОП-затвор, J – p-n-затвор, FET – полевой тиристор с управляющим p-n-переходом). В зависимости от параметров (толщины, концентрации свободных носителей) n+-AlGaAs-, n-GaAs-, in-GaAs-, n–-GaAs-слоёв вольт-амперные характеристики нового тиристора будут или триодного, или пентодного типа, т.е. иметь либо нормально открытый канал, либо нормально закрытый. Входные ёмкости HMOSJFET-структур (эквивалент выходной мощности управляющего драйвера) практически на три порядка (в 1000 раз) меньше, чем входные Сgs у SiC- или Si-MOSFET, чем и объясняется их быстродействие. Триодная структура GaAs полевого тиристора вследствие мощной электронной инжекции гетероизотипного катода (n+-AlGaAs / n-GaAs / i-GaAs) по плотности тока будет выше, чем Si-IGBT. По сути, триодная структура – электронный прототип Si-IGBT приборов с той лишь разницей, что частота коммутации таких тиристоров будет находиться в мегагерцевом диапазоне, а на пути протекания тока только один переход.
Данную конструкцию ТЭУ можно выполнять и Si, используя объединение технологий Trench и [6]. Себестоимость такого прибора будет гораздо ниже, чем на основе GaAs, но по статическим и динамическим параметрам он будет превосходить приборы типа Si-IGBT и MOSFETы.
В 2020 году фирма Gree наладила производство серийных МОП-транзисторов на карбиде кремния (SiC), которые из-за широкозонности материала показывают рекордные значения по сопротивлению канала в открытом состоянии (Rk) и максимальному рабочему напряжению по сравнению с обычными МОП-транзисторами и могли бы составить конкуренцию ТЭУ. Однако из-за низкой подвижности электронов (900 см2/(В·с), а в канале и того меньше – 200–300 см2/(В·с), у Si – 1450 см2/(В·с)), они могут работать на частоте не выше 150 кГц. Также они проигрывают ТЭУ и по Rk.
В ТЭУ плотность электронно-дырочной плазмы на несколько порядков выше, чем в МОП-транзисторах на SiC. Кроме того, они имеют такие недостатки, как высокая себестоимость (SiC по твёрдости не уступает алмазу и имеет высокую дефектность кристаллической решётки), низкая спецстойкость, высокая вероятность включения паразитного диода и сложность в управлении из-за низкой зависимости ширины ОПЗ от приложенного напряжения.
ТЭУ существенно отличается от обычных тиристоров. Обычные тиристоры имеют четырёхслойную структуру, а ТЭУ – двухслойную, как диод, поэтому его правильней называть диодом с электростатическим управлением (ДЭУ). В табл. 1 приведены характеристики мощных силовых высоковольтных современных ключей.

Заключение
Авторами данной статьи разработаны новые конструктивно-технологические приёмы построения высоковольтных тиристоров со статической индукцией (ТЭУ) на Si и GaAs, которые позволят создать приборы с параметрами, превосходящими лучшие зарубежные тиристоры и приборы на SiC во всем диапазоне рабочих напряжений. В связи с тем, что у ТЭУ на пути протекания тока только один p-n-переход, авторы предлагают их называть диодами с электростатическим управлением (ДЭУ).
Литература
- Максименко Ю.Н. Транзистор со статической индукцией КП926 с повышенным быстродействием // Электронная техника. Сер. 2. Полупроводниковые приборы. 2022. Вып. 3 (266).
- Рогачев К.Д. Современные силовые запираемые тиристоры // Рынок микроэлектроники. 2015.
- Ржеусская А.Д., Корнюшко О.А. Устройство и применение запираемых тиристоров // Актуальные проблемы энергетики. 2016.
- Nishizawa I., Nonaka T., Mochida Y. Static induction transistor logik // Proc. 1979 Int. Conf. Solid State Pevicea (Tokyo) lap, I. Appl. Phys. Suppl. 19.01.1980.
- P. 279–282.
- Normally-off type high speed SI-thiristor / Y. Nakamura, H. Tadano, S. Sagiyama at al. // International Electron Devices Meet. Sun-Fransisco, Calif. 1982. P. 480–483.
- Авторское свидетельство № 1215546 СССР, МКИ HOI 21/18. Способ изготовления полевых транзисторов с управляющим р-n-переходом и вертикальным каналом: № 3052227 : заявл. 22.06.1982 : зарег. в Госреестре изобретений СССР 01.11.1985 / Ю.Н. Максименко, С.Н. Корнилова, Н.М. Жуковский.
- Максименко Ю.Н. Мощные полупроводниковые приборы со статической индукцией: монография. Новосибирск: PVN, 2022.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!







