Введение
Уровень современной экономики определяется уровнем электроники.
Массовое производство терагерцовых микропроцессоров [1] к 2025 году (сотни миллионов чипов в год, с проектными нормами до 3 нм [2]) и ввод в эксплуатацию систем беспроводной связи и цифровой информации 6G делает переход на «терагерцовую цифровую экономику» [3] для стран «Большой семёрки» всё более реальным.
Вице-премьер Ю. И. Борисов оценил состояние дел в российской электронике [4, 5]. Оценка такова, что добавить, собственно, и нечего. Она также отражает и положение дел по программе импортозамещения. Особенно опасно отставание по радиационно-стойким СВЧ-приборам короткого, миллиметрового диапазона для оборонных систем связи, локации и навигации.
Для спецприменения в программе импортозамещения нет аналогов младше 10 лет.
Вице-премьер сообщил о необходимости создания в госсекторе двух ультрасовременных фабрик, специализирующихся на наноэлектронике. Также чиновник призвал к жёсткой централизации развития отечественной электроники. Видимо, госструктура, непосредственно подчиняющаяся вице-премьеру, должна иметь автономное госфинансирование. Острейшая необходимость есть в разработке и реализации программы развития отечественной электроники, в перспективе опережающей мировой уровень на 3–5 лет (на одну–две ступени закона Мура).
Опережающая электроника – новые продукты и товары, поставляемые на мировой рынок с признаками национальной монополии. Появление таких инноваций исключительно важно в условиях грядущего падения доли отечественного топливно-энергетического комплекса в объёме ВВП и, следовательно, консолидации госбюджета (сегодня доля ТЭК достигает 40%).Снижение доминанты ТЭК связано с резким переходом автопрома в странах G7 на производство электромобилей: до 100 млн электромобилей и от 200 млн электромагнитных велосипедов и мотоциклов ежегодно к 2030 году. Ключи к космосу определяются уровнем терагерцовой твердотельной электроники в спецтехнике.
Базовые фундаменты экономики – транспорт, энергетика, машиностроение – целиком и полностью зависят от уровня электроники.
В итоге экспортозамещение продуктов топливно-энергетического комплекса – важнейшая текущая государственная задача. Опять же, решение этой задачи возможно только на базе современной электроники. Реализация важнейших национальных проектов, таких как «Цифровая экономика», «Искусственный интеллект», «Наука» и др., целиком и полностью зависит от подходов в развитии электроники, её уровня и места на мировом рынке.
Есть ли в России интеллектуальная, технологическая, материальная, проектная базы, стартаповские исследования и разработки для создания программы развития отечественной электроники, опережающей мировой уровень? В России – всё есть. Россия – самодостаточная страна. В частности, авторами статьи разработан проект опережающего развития СВЧ, силовой электроники, фотоники, фононики, магнетоники и «аналоговой цифры» с температурами эксплуатации вдвое выше, чем это принято по американским военным стандартам (MILSTD 810G).
Россия может приступить к разработкам СВЧ и силовых приборов с рабочими температурами от 500 до 1000°С уже сегодня. Это послужит толчком к развитию не только экономики, оборонной техники (гиперзвук в тропо- и стратосфере), но и к созданию отечественного аппарата более совершенного в сравнении с американским солнечным зондом PARKER от НАСА.
Авторский проект – основа систем 6G, он также позволяет приступить к 7G (GSM) на частотах 5–7,5 ТГц. Прогнозируемый объём рыночных продуктов только 6G к 2030 году будет эквивалентен ВВП России – $1,25 трлн.
Цель данной статьи – показать стартаповскую часть проекта на примере GaAs-диодов с потенциалом на мировом рынке как минимум $1 млрд ежегодно на 5–7-й год после освоения.
Новые классы и группы LPE GaAs-диодов на фоне Si-, SiC-, GaN-, Ge-диодов
Новый LPE-материал, сочетающий свойства полупроводника (кулоновской энергетики), диэлектрика (фотоники и фононики), проводника и диэлектрического сверхпроводника, позволяет резко расширить функциональные возможности диода. Его можно перевести из классической «электро-шрёдингеровской» зоны, которая чаще всего базируется на теории Шокли – инжекции с обязательным уравнением дивергенции тока, уравнением непрерывности для неосновных носителей заряда, в более современную энергетическую зону. Такой средой могут выступить электромагнитные, оптические, фононные, доменные энергетически нормализованные зоны, например вентильно-оптические ПЗС, или диоды с металлической базой, или квантовые вентили (оптико-электронный вентиль). Электронные функции открытия и закрытия у диода в условиях терагерцовых 7G надо будет списать как устаревшие. Точно также придётся поступить, впрочем, и с вентильными матрицами и др.
В таблице 1 отражены тенденции развития диода как электромагнитного клапана в нашем понимании.

Для демонстрации перспективных характеристик полупроводниковых, оптических, фононных диодов необходима целая серия статей.
Пока ограничимся диодными структурами, работающими либо на электронно-дырочной плазме (ЭДП), в том числе с оптическим возбуждением (квантовый вентиль), либо на термоэмиссионной или униполярно-инжекционной плазме.
К таким диодам из таблицы 1 относятся: p-i-n, n-i-p («ниппель»), SBD, JSBD, электромагнитные и лазерные диоды, фотодиоды, диоды с металлической базой.
LPE p-i-n-GaAs-диоды
Диоды GaAs – p-i-n-серия ультра- и гипербыстровосстанавливающихся (по критерию «обратное сопротивление») диодов с рабочими токами от 1 до 200 А на один чип, со временем восстановления trr до 100 нс (250°С) у 1700-вольтовых диодов и до 20 нс (250°С) – у 600-вольтовых диодов.
Время восстановления, частотные характеристики данного типа диодов определяются степенью растворимости в i-SiGaAsSi-слое амфотерных атомов кремния и соотношением с n– -высокоомной эпитаксиальной областью. Диоды имеют сверхмалую равновесную ёмкость (< 3 пФ/мм2 у 1200-вольтовых чипов, что приблизительно в 30–40 раз меньше, чем у SiC SBD (1200 В). Особенностями также являются исключительно высокая радиационная стойкость и потолочные значения рабочей температуры p-i-n-структур до 320–350°С (что, в принципе, было показано Ж. И. Алфёровым [6]). К «экзотике» этого класса приборов следует отнести COOL HBD (Hetero Bipolar Diodes) – диоды с токами двойной инжекции (например, в 600-вольтовых структурах) до 500 А на чип, что проблематично с позиции токоотвода от силового чипа (медный провод сечением 1 см2 способен отвести ток не более 300–400 А).
Реальные практические характеристики, профили легирования, структурное исполнение, осциллограммы di/dt и dU/dt силовой коммутации приведены в [7, 8]. Подробная электрофизика изложена в фундаментальной статье [9], где фактически представлена «новая теория мультизонной проводимости». Теория основана на эффекте расщепления оптической запрещённой зоны GaAs. Сравнительные характеристики (конечно же, экспериментальные) на предметном языке приведены в таблицах 2, 3.


Новое поколение GaAs-диодов: n-i-p («ниппель») диоды
Диоды n-i-p – биполярная уникальность, это связано с двухсторонней инжекцией в высокоомную p-базу из:
- n+-GaAs-подложки;
- p+-AlGaAs-анода (изотипный инжектор).
В итоге образуется мощная, быстро аннигилирующая при переключении ЭДП-плазма. Электроны – неосновные носители «с потолочной», согласно классическим представлениям, подвижностью µn® 8000 см2/В•с. При включении диодов формируется релятивистский импульс «подготовки к включению» (в среднем или дальнем СВЧ-диапазоне) p-n-переходов (n+- p– и p+- p–). В силу большой скорости проникновения дырок в p–-область формируется плюсовой динамический заряд вблизи границы n+-p–перехода, который и приводит к механизму дифференциального отрицательного сопротивления (ДОС) на прямой вольт-амперной характеристике (то есть приводит к снижению UF против изначального UF0).
Мало того, что n-i-p-диоды в перспективе вытеснят SiC SBD в классе 600–800 В, к тому же от них можно ожидать и таких проявлений, как вполне объяснимая с физической точки зрения ДОС на прямой ВАХ в случае гетероанода.
Гетероструктура n-i-p («ниппель») диода способна совмещать в себе силовой гиперскоростной диод (допустим, на 600 В при частотах коммутации 10–20 МГц) и объёмный лазер со сверхмощным излучением на единицу объёма. Пожалуй, самый мощный, по прогнозам, в своём классе. Также гетероструктура может выступать в качестве эффективнейшего солнечного элемента, сверхдобротного варикапа, великолепного коммутатора (СВЧ) или СВЧ-смесительного диода. ДОС в этом случае будет играть непоследнюю роль. В силу специфики структуры на таких диодах могут быть выполнены сверхмощные ЛПД-генераторы со SMART-оптическим управлением.
Материнские n+-p–-плёнки под n-i-p («ниппель») структуры – это возможность построения СВЧ n-i-p-диодов и мощных фотодиодов (фотодетекторов) с рабочими частотами вплоть до 60 ГГц.
Почему всё вышеперечисленное имеет чёткое обоснование? Дело в исходном уникальном материале. LPE n+-p– -GaAs-структуры содержат в p–-слое квантово-точечно-атомные магнитные центры, что также имеет место и в n+-n–-GaAs-структурах под перспективные высоковольтные, с субнановременами SBD (см. далее). Профиль легирования исходной n+-p–-структуры под гетеродиодную структуру (HBD) был представлен в материалах Международного IEEE семинара по проектированию и технологии производства электронных средств (SED-2019). Мероприятие состоялось в апреле 2019 года в Праге. В том числе был представлен и типовой вариант HBD-диода в качестве фотовольтаического диода [10]. Фотодиоды с высочайшим уровнем реакции на солнечное излучение в комбинации с фононной LPE GaAs-электроникой идеальны для измерения спектра излучения магнитного поля Солнца. Они используются в космических аппаратах, таких как упомянутый зонд PARKER. Частотные и динамические характеристики n-i-p («ниппель») отражены в таблицах 3, 4, 5.
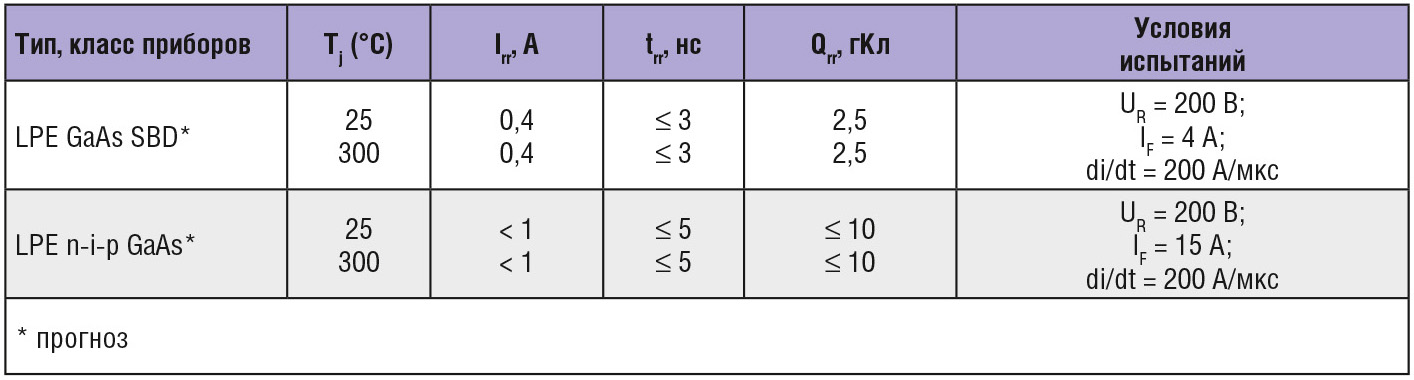
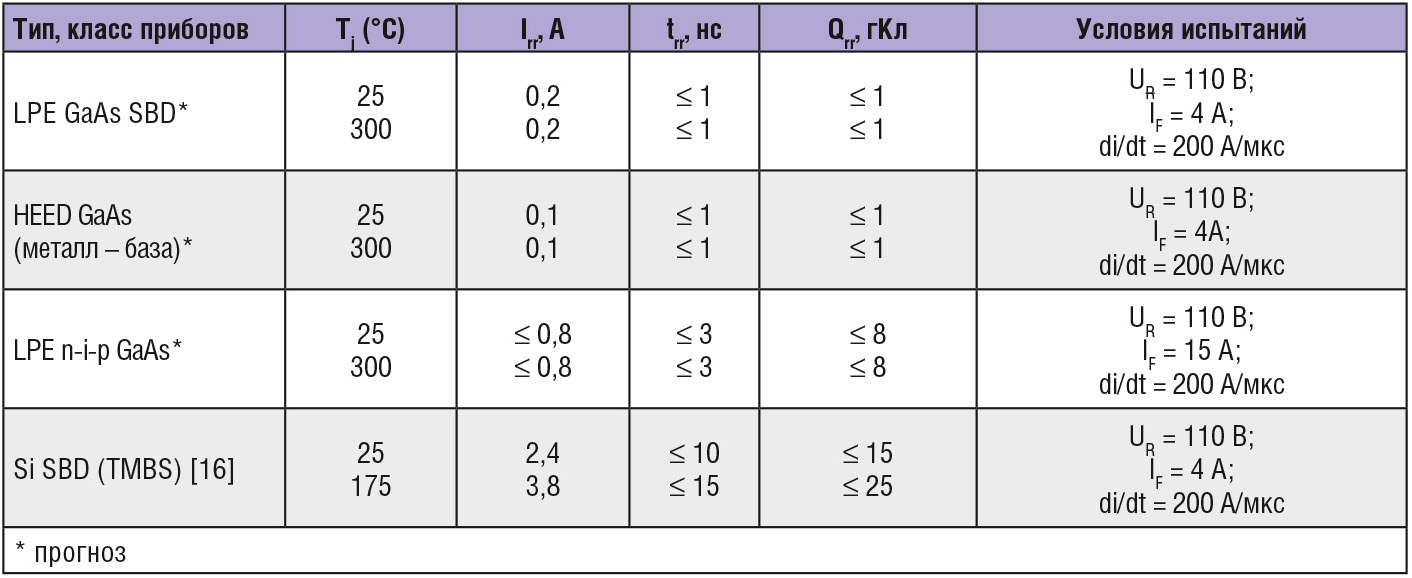
Комплементарные LPE GaAs-диоды Шоттки (SBD) на базовых эпитаксиальных плёнках n- и p-типов проводимости
MOCVD GaAs SBD широко распространены на СВЧ-рынке. Силовые MOCVD GaAs-диоды появились в начале 2000-х годов, когда на мировой рынок с ними вышла американская фирма IXYS. Но газотранспортная эпитаксия не позволяла получить диодные SBD-чипы с уровнем напряжений выше 250–300 В и токами свыше 15 А на чип. Фирма выпускала GaAs-диоды и через 10 лет сняла их с производства. По инерции несколько лет выпускала их английская фирма Semelab. Эстафету подхватили и в НИИПП в Томске (производили с помощью хлоридного метода), но пока сложно судить о результате.
Потенциал LPE GaAs SBD на эпитаксиальных структурах с квантово-точечными атомно-магнитными центрами, радиус которых идентичен радиусам атомов Ga и As, очень велик.
Данная оценка базируется на макетных, пробных чипах GaAs SBD, полученных в Великом Новгороде на базе АО «ОКБ-Планета». Оценка позволяет с большим оптимизмом смотреть на рынок GaAs SBD для инверторов и конверторов с рабочими напряжениями до 600–800 В и рабочими токами на чип до 20–30 А при URRM> 100–200 В c IFmax до 100 А. Впервые с приёмкой заказчика (ОКР «Бадминтон») 50-амперные 70-вольтные SBD впервые были созданы по LPE-технологии в 80-х годах в СССР.
Профиль распределения примесей в новых, изготовленных по авторской технологии структурах показан в материалах SED-2019. Профиль просканирован на STM в одном из научных центров Германии.
Если сравнивать LPE GaAs SBD и Si SBD c URRM=200 В (SiC SBD по технологическим причинам отсутствуют в диапазоне 100…400 В), то результат окажется впечатляющим. При сравнении GaAs SBD с 200-вольтовыми Si SBD фирмы Vishay (CША), последние могут показаться «динозаврами» (по меткому выражению представителей компании IBM, сравнивавших в 2015 году освоенные 7-нм чипы с 14-нм [11]).
Особенность электронных LPE GaAs SBD состоит в том, что это циклоидные диодные структуры, где электроны из объёма накопленного заряда дрейфуют в катод по ярко выраженной циклоиде. Это происходит из-за наличия магнитных квантово-точечных центров, снижающих сечение захвата атомов решётки. Имеет место деформация ионного радиуса атомов Ga и As, особенно атома Ga с ярко выраженными поляризованными свойствами, и, соответственно, увеличение эффективных длин пробега электрона без столкновений в твёрдовакуумном пространстве решётки GaAs.
Что касается p-канальных LPE GaAs SBD. Разница работы выхода из металла и GaAs практически идентична n-канальным, то есть классическим SBD. Однако общий потенциал UF снижается из-за разности электрохимических потенциалов SB-барьера и p-типа полупроводника. Поэтому ожидается (на основе физических моделей), что у 100-вольтовых p-канальных LPE GaAs SBD UF будет примерно равно –(0,15…0,2) В, а у 600-вольтовых – не более –0,5 В. Естественно, на прямовключённых LPE GaAs противофазных полумостах с «нулевой точкой» можно получить как превосходные СВЧ-смесители, так и усилители (в пределах сигнала Uвх=–1…+1 В) с неплохими симметрично-запорными напряжениями. Прогнозируемые характеристики переключения и коммутации n-канальных LPE GaAs SBD показаны в таблицах 3, 4, 5.
В диапазоне частот 100–107 Гц силовые SBD-диоды могут быть выполнены в вертикальном исполнении, а в среднем и дальнем СВЧ-диапазоне – только горизонтальные конструкции чипа (оба вывода – на планарной стороне чипа).
Инжекционно-униполярные гетероструктурные диоды Шоттки (HJSBD)
В перспективе униполярные диоды с плотностями прямовключённых токов могут в разы превышать плотности прямых токов SiC SBD и GaN SBD. При этом высоковольтные конструкции по плотности токов приблизятся к p-i-n-диодам, опережая их по быстродействию на полтора порядка.
Физическая модель таких диодов на десятки ампер и URRM до 1200 В опубликована в материалах IEEE по результатам семинара SED-2019 [12]. Такие диоды с уровнем блокирующего напряжения до 1200 В и при IF в несколько десятков ампер, а в импульсном режиме как минимум – на полпорядка выше частотные свойства. В частности, коммутации до 10 МГц и выше исключительно перспективны для нового поколения конверторов под обеспечение терагерцовых цифровых систем 6G и дальнего СВЧ-диапазона (100–300 ГГц).
Что касается p-канальных HJSBD, то для этого есть все условия с учётом упомянутых LPE-структур:
- вертикальных, на основе структур p+-p-i (они имеются в серийном исполнении);
- горизонтальных, на основе p–-MOCVD-слоёв на базовых структурах n+-n–.
600-вольтовые p-типа LPE GaAs HJSBD c p+-инжектором в i-области, как ожидается, смогут показать себя не хуже 600-вольтовых SiC SBD, с той лишь разницей, что частоты коммутации ожидаются в разы выше, и при этом рабочая температура GaAs HJSBD-чипов будет удвоена.
Оценочная характеристика параметров 1200-вольтового GaAs HJSBD приведена в вышеуказанных материалах IEEE по результатам семинара SED-2019 [11], а сравнительные характеристики приведены в таблицах 2, 5 и 6.
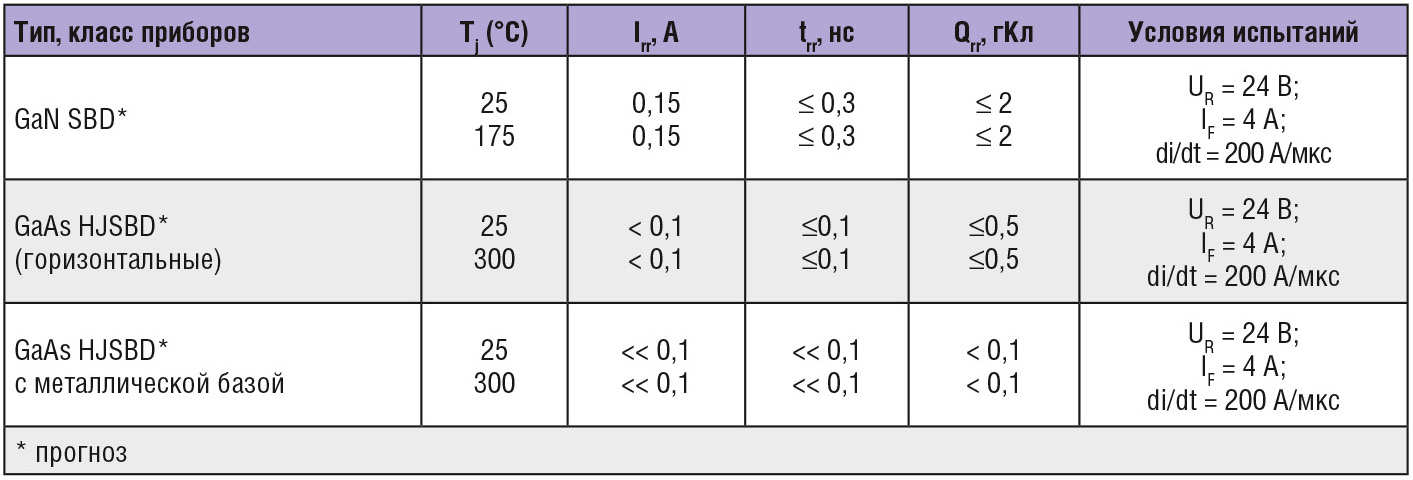
Горизонтальные n-канальные и p-канальные HJSBD предназначены для СВЧ-целей вплоть до 100 ГГц, а мощные силовые СВЧ-диапазона HJSBD (10–50 В) предназначены для силового питания в исполнении СВЧ-силовых конверторов (цифровая экономика, 6G, СВЧ приёмо-передающие устройства, GPS и другие).
Квантовые вентили
Структура LPE GaAs-квантового вентиля чрезвычайно проста. Она выполнена из кристалла изолятора (r > 109 Ом•см) – i-SiGaAsSi. В анодной и катодной областях i-SiGaAsSi изолятора (NSi< 1015cм–3) выполняются барьеры Шоттки из тугоплавких металлов (Ni, Mo, Pt, Ti и др.). Наиболее предпочтительны W и Mo (ТКР абсолютно идентичен ТКР кристалла GaAs). Поверхность i-SiGaAsSi-кристалла покрывается тонкими слоями или комбинацией слоёв Al2O3; AlN; Si3N4; TiO2 и др., которые имеют большую ширину запрещённой зоны – от 5,1 эВ (Si3N4) до ≥ 8 эВ (Al2O3). Большая ширина запрещённой зоны просветляющих покрытий гарантирует прозрачность как во всём рабочем ИК-диапазоне, так и практически во всём видимом оптическом диапазоне длин волн (до 0,4 мкм) и далее до начального ультрафиолета.
При воздействии на прямосмещённый изолятор i-SiGaAsSi лазерного пучка на волне, близкой к энергии запрещённой зоны GaAs (1,43 эВ) с плотностью квантов вблизи 1017–1018 см–2, в изоляторе i-SiGaAsSi образуется ЭДП-плазма с падением сопротивления кристалла i-SiGaAsSi на 10 порядков. При коммутации прямого смещения на обратное, то есть блокирующее напряжение, происходит процесс дрейфово-рекомбинационного рассасывания заряда ЭДП-плазмы.
На основе SMART квантово-вентильного ключа можно построить цепи «защиты слива» в DC-цепях СВЧ-трактов от сверхмощных электро-магнитных импульсов (ЭМИ). К примеру, типовые 24-вольтовые цепи можно защитить квантовыми вентилями со временем срабатываниия («КЗ по входу», то есть слив мощного многокиловаттного ЭМИ) за ≈ (1…5)×10–12 с. При этом, конечно, своевременно должен сработать лазерный фемтодиод с GaAs 5-вольтовым или 10-вольтовым драйвером управления лазерным диодом, допустим на волне 0,85 мкм. Возбуждающими элементами образования скоростной лавины между анодом и катодом служат амфотерные атомы кремния, генерирующие «стартаповскую лавинизацию». Энергия генерации электронов и дырок с амфотерных Si-центров в i-SiGaAsSi в 2 раза меньше энергии фотоэффекта в GaAs.
По совокупности статических, динамических параметров, температуро- и спецстойкости LPE GaAs-диоды обладают внеконкурентными свойствами.
Проблемы. Конкуренты
Первое предложение по созданию гиперскоростной энергоплотной радиационно-стойкой силовой GaAs-элементной базы от авторов статьи поступило в государственные институты в 2010 году. Такая база была бы полезной для гиперзвуковых аппаратов, поскольку удваивается рабочая температура ЭКБ в сравнении со стандартами «Климат-7» (РФ) и MILSTD 810G (США), к тому же радиационная стойкость выше на порядок.
Из-за откровенного недопонимания сути предложенного оппонентами и ограничения доступа к бюджетному финансированию, к сожалению, кроме экспериментальных работ в ряде фирм ОПК РФ, не удаётся продвинуть проект далее.
Необходимо отметить и важнейшую технологическую проблему, без решения которой невозможен серийный выпуск GaAs высоковольтных приборов, а также СВЧ и ТГц-приборов. Это – ALD-технология (Atomic Layer Deposition – «атомно-слоевое осаждение»). К данному заключению авторы статьи пришли несколько раньше, чем вышла публикация Криса Ходсона, ведущего специалиста по атомно-слоевому осаждению на AIIIBV британской компании Oxford Instruments Plasma Technology (Low damage plasma processes for compound semiconductor applications – «Плазменные процессы с низким повреждением для сложных полупроводниковых применений» – прим. ред.).
На это всё требуются средства, и немалые. Тем не менее первые ALD-опробования на p-i-n-GaAs-структурах в Саранске и Ставрополе (на благотворительных началах) дали просто необычайно перспективный технологический результат.
В таблице 7 приведены результаты измерений p-i-n-GaAs-структур после Al2O3 ALD-нанопассивации на установке Picosun (Финляндия). Комментировать – нет смысла.

«А что за рубежом? – неизбежно заметят представители научных кругов и, в частности, специалисты в области силовой ЭКБ. – Мы же не можем “генетически” жить без “клонирования”!» Наш ответ прост: «клонированием» наших результатов занимаются в Китае, Украине, а также в Германии, где выделено на эти цели примерно €5,3 млн (или $6,10 млн) [13]. В этих странах, в сущности, проводится работа по воспроизведению технологии нашего проекта.
Заключение
Активная разработка нового полупроводникового LPE GaAs-материала должна стать платформой для абсолютно новой стратегии развития отечественной электроники, опережающей мировой уровень, в том числе и в областях СВЧ-приборостроения, фотоники, фононики и магнетоники.
Коммерциализация нового направления в гиперскоростной силовой электронике затронет многие направления: электроэнергетику, транспорт, СВЧ-технику, цифровую экономику и др.
Статья нацелена на привлечение отечественных инвесторов в проект в области электроники, фотоники, фононики, магнетоники.
Литература
- Samsung создала прототип 3-нм полупроводников GAAFET. Медиапоток. 2020: https://potokmedia.ru/russia_world/138633/?utm_source=yxnews&amp;utm_medium=desktop&.....
- TSMC планирует начать выпуск 3-нм полупроводников в 2022 году. Overclockers.ua. 2019: https://www.overclockers.ua/news/hardware/2019-12-07/125816/.
- Гордеев А. И. Проблемы становления российской цифровой экономики и способы исключения ошибок при их решении. Современная электроника. 2019. №2.
- Приватизация убила российскую микроэлектронную промышленность, бюрократия её добивает – Юрий Борисов. Bryansk.news. 2019: http://bryansk.news/2019/12/25/microelectronic/.
- Борисов раскритиковал бюрократию в ВЭБ, Минфине и Минэкономики. Коммерсант. 2019: https://www.kommersant.ru/doc/4188501.
- Алфёров Ж. И., Андреев В. М., Корольков В. И., Портной Е. Л., Третьяков Д. Н. Гетеропереходы AlxGa1-xAs-GaAs. Физика электронно-дырочных переходов и полупроводниковых приборов.1969.
- Войтович В. Е., Гордеев А. И., Думаневич А. Н. Чем заменить SiC-диоды Шоттки? Силовая электроника. 2009. № 5.
- Войтович В. Е., Гордеев А. И., Думаневич А. Н. GaAs-диоды для PFC, SMPS, UPS, IPM, Solar invertors и замены синхронных выпрямителей. Силовая электроника. 2012. № 6.
- Гордеев А. И., Войтович В. Е., Звонарёв А. В. Новая физическая твердотельная электроника на основе терагерцового расщепления и деформации запрещённой зоны LPE SiGaAsSi-кристаллов (ч. 1). Радиотехника. 2017. № 10.
- Voitovich V. E., Gordeev A. I.,Saytiev A. B., Sysoev I. А. Extreme environment wideband, high-efficiency photovoltaics based on new physical principles and hyperfast LPE GaAs power electronics.Seminar on Electron Devices Design and Production (SED). 2019.
- IBM представила «процессор будущего» с 7-нанометровыми транзисторами. Вести.ru. 2015: https://www.vesti.ru/doc.html?id=2639598.
- Voitovich V. E., Gordeev A. I., Prokopenko N. N., Bugakova A. V. Prospects for Development of Fast Recovery Power GaAs SBD on the basis of LPE-Technology. International Seminar on Electron Devices Design and Production (SED). 2019.
- 3-5 Power Electronics Secures New Financing. Globenewswire. 2018: https://www.globenewswire.com/news-release/2018/11/13/1650816/0/en/3-5-Power-Electronics-Secures-New.....
- www.infineon.com.
- www.cree.com.
- www.vishay.com.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!







