Карбид кремния (SiC) и нитрид галлия (GaN) являются идеальными материалами для силовых приборов. На настоящий момент, благодаря своим электрофизическим параметрам, эти материалы всё более широко используются для изготовления силовых приборов, в том числе и сверхвысокочастотного (СВЧ) диапазона. Также считается, что SiC и GaN станут основой ключевых компонентов силовой электроники, радио- и оптоэлектроники следующего поколения. Основные области применения приборов на основе этих материалов: ВЧ-электроника (преимущественно GaN-приборы), импульсная силовая электроника, включая драйверы электродвигателей, системы распределения питания и резонансные преобразователи питания с высокой надёжностью, в том числе для аппаратов бортовых систем. Согласно исследованиям Yole Developpement, ожидается, что только для EV/HEV-применений объём рынка SiC-приборов достигнет $400 млн к 2022 году, а рынка GaN-приборов – $420 млн к 2023 году. В целом Yole прогнозирует рынок в размере $1,5 млрд как для SiC-, так и для GaN-приборов в 2023 году с 31% совокупным среднегодовым темпом роста для SiC- и 93% – для GaN-.
Данные материалы в сравнении с кремнием обладают большей критической напряжённостью поля пробоя (приблизительно 1,8…3,5 MВ/см в зависимости от используемого материала), большими скоростями насыщения электронов (2,0…2,5×107 см/с). Кроме того, SiC обладает высокой теплопроводностью (3,9…4,9 Вт/(см•К)), что позволяет создавать приборы, способные работать при температурах выше +800°C [1]. Достигнутый за последние 15 лет прогресс в развитии технологий выращивания подложек и эпитаксиальных слоёв SiC и GaN с приемлемым уровнем дефектности и воспроизводимости электрофизических параметров позволил изготовить на основе этих материалов практически все типы полупроводниковых приборов, в том числе вертикальные GaN-диоды и транзисторы. Наряду с широко известными компаниями в области производства изделий из широкозонных полупроводников, таких как Cree, Infineon, NXP, Episil, ROHM, Nitronex, ST, EPC, GeneSiC, MicroSemi, приборы на основе SiC и GaN начинают разрабатывать и изготавливать совершенно новые компании, такие как FMI, Cerromax, UnitedSiC, SiC Semiconductor и другие, в том числе СКТБ «Микроника» (г. Минск), выполняющее совместные проекты с компаниями Юго-Восточной Азии. Также немалую роль играет усовершенствование TCAD-программ таких фирм, как Cadence и Synopsys, в части развития моделей расчёта техпроцесса и электрических параметров разрабатываемых SiC- и GaN-приборов. Целью данной статьи является краткий обзор уровня производства, основных преимуществ и параметров силовых приборов на основе карбида кремния и нитрида галлия, изготавливаемых широко известными компаниями.
SiC-диоды Шоттки и FET-транзисторы
SiC-диоды Шоттки характеризуются исключительными динамическими характеристики для работы с напряжениями выше 200 В. Заряд обратного восстановления Qс этих диодов более чем на порядок меньше, чем у кремниевых MPS-диодов с контактом Шоттки (см. рис. 1) и, кроме того, не зависит от скорости нарастания тока di/dt [2]. Сверхмалое значение заряда Qс уменьшает потери на переключение. Максимальная температура перехода до +250°С, указанная в ряде спецификаций (GeneSiC), ограничивается в основном возможностями корпуса.

Основные электрические параметры SiC-диодов Шоттки таких известных компаний, как Cree, GeneSiC, Infineon, Rohm, представлены в таблице 1.

По сравнению с кремниевыми диодами с контактом Шоттки (Si-FRD) SiC SBD-диоды могут работать в устройствах с частотой преобразования до 500 кГц, что позволяет снизить габариты и, соответственно, массу индуктивностей. Также они позволяют снизить электромагнитные помехи благодаря чрезвычайно малой величине тока обратного восстановления, что в ряде случаев даёт возможность не использовать сетевой фильтр.
Преимуществами SiC FET-транзисторов являются:
- большая частота переключения – на порядок выше, чем у лучших IGBT-транзисторов [2];
- низкое сопротивление в открытом состоянии (на порядок ниже, чем у лучших кремниевых приборов), что даёт возможность при приемлемом размере кристалла (~25…28 мм2 у Cree) получать 1200 В приборы с сопротивлением в открытом состоянии 16…25 мОм;
- высокая рабочая температура перехода до +250°С (ограничивается в основном возможностями корпуса).
По сравнению с мощными кремниевыми IGBT+FRD приборами транзисторы FET+SBD на карбиде кремния могут работать в устройствах с частотой преобразования до 50 кГц и выше. Основные электрические параметры SiC FET-транзисторов производства Cree, GeneSiC, ST и Rohm приведены в таблице 2.

По результатам сравнительных исследований, проведённых компаниями Rohm и STMicroelectronics, использование SiC FET + SiC-диодов Шоттки в сравнении с IGBT и FRD на кремнии позволяет снизить потери мощности более чем на 50% и увеличить эффективность конечных устройств более чем на 5% [3, 4]. При этом за счёт использования частоты 100 кГц (вместо 25 кГц в случае с IGBT и FRD на кремнии) в boost-конвертере мощностью 5 кВт стоимость индуктивностей на плате снижается примерно на 40% (см. рис. 2), конденсаторов – на 70…72% (см. рис. 3), стоимость радиаторов охлаждения – в 1,5–3 раза. Таким образом, при стоимости SiC-приборов больше, чем соответствующих по мощности Si-приборов, себестоимость конечного модуля может быть такой же и даже ниже, а в перспективе – в 2 раза меньше при условии уменьшения стоимости SiC-диодов Шоттки в 2,5–3 раза (см. рис. 4) [2].
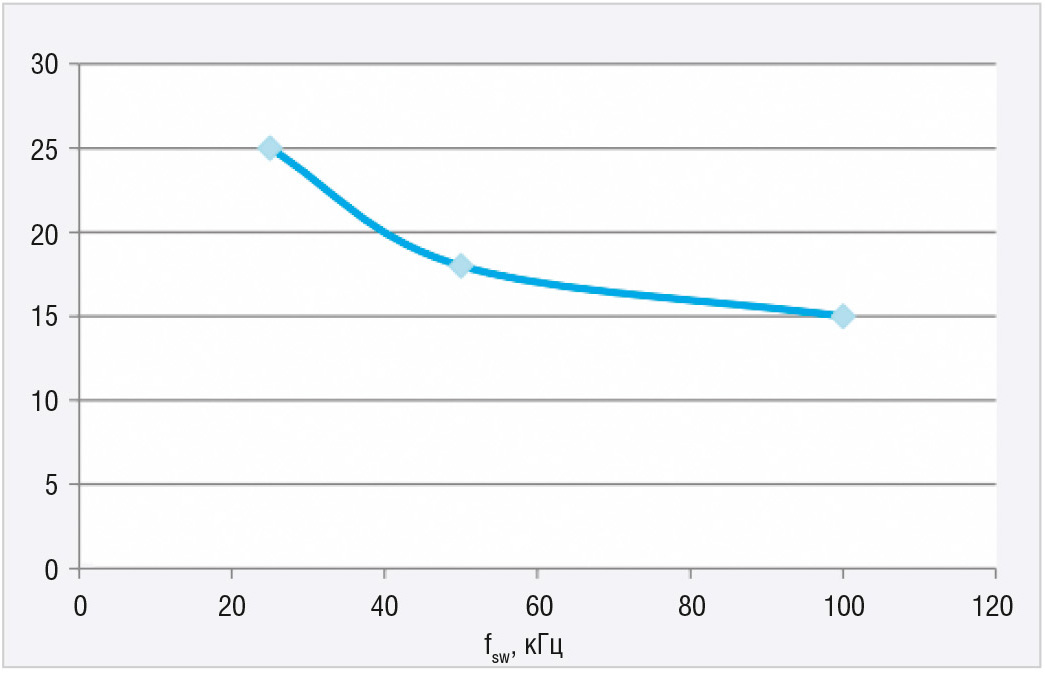
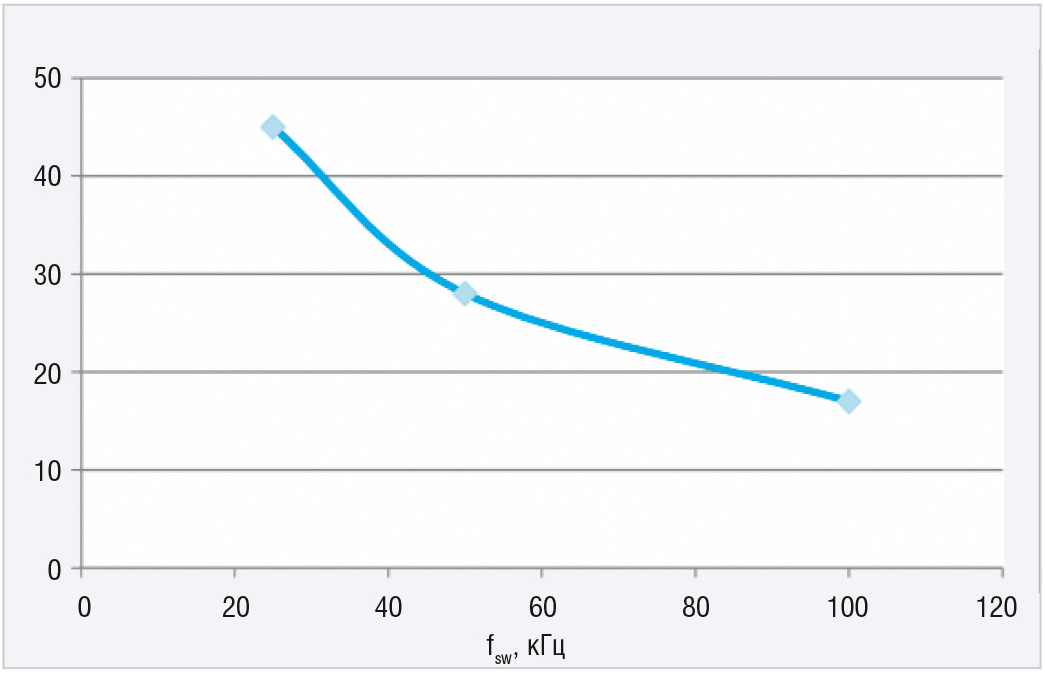

В настоящее время специалисты ведущих мировых компаний и университетских лабораторий работают над использованием для силовых приборов 3C-SiC эпитаксиальных структур, выращенных на кремниевых подложках [5]. Кубический политип 3С-SiC является единственным, который может быть выращен на кремниевой подложке с толщиной, необходимой для мощных силовых приборов. Помимо значительного снижения цены эпитаксиальной структуры технология 3C-SiC/Si также предлагает возможность увеличения размера пластины гораздо быстрее, чем это возможно для широко используемых в коммерческом применении гексагональных политипов 4H-SiC и 6H-SiC. Сегодня 4H-SiC является основным материалом для SiC силовых приборов, но его основным недостатком является низкая подвижность носителей зарядов в канале FET-транзисторов, работающих в ключевом режиме, что не позволяет в полной мере использовать преимущества SiC-материала для рабочих напряжений 200…800 В. В связи с этим ожидается, что силовые приборы (FET-транзисторы и диоды Шоттки), изготовленные с применением 3C-SiC/Si технологии, будут использоваться в применениях с рабочим напряжением 200…800 В (см. рис. 5), а именно: в приводах моторов электротранспорта, включая EV/HEV, системах кондиционирования воздуха, холодильниках и светодиодных системах освещения [5]. Кроме того, при использовании подложки p+Si может быть разработан IGBT-транзистор с характеристиками лучшими, чем у FET-транзистора.
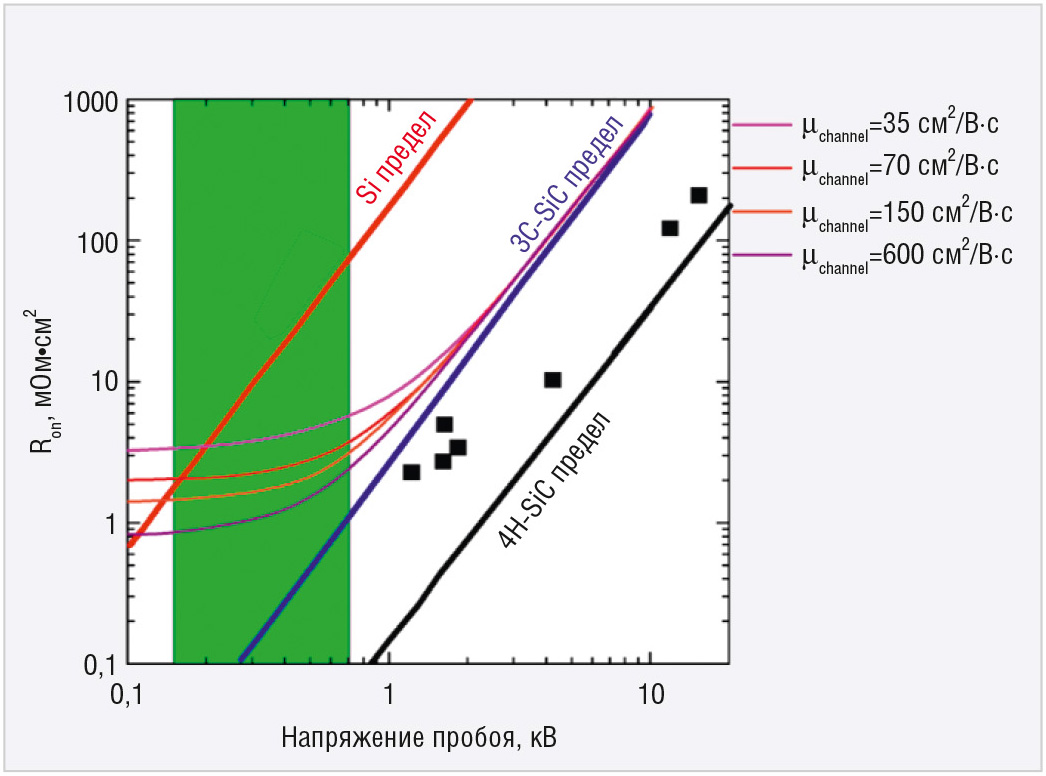
Однако массовому использованию 3C-SiC/Si технологии препятствует большая дефектность кристаллической структуры. Для улучшения качества эпитаксиальных структур специалистами ведущих мировых компаний и университетских лабораторий, включая компании по разработке технологического оборудования, решаются задачи по созданию как специальных подложек кремния, позволяющих уменьшить плотность кристаллографических дефектов и стресс в 3C-SiC эпитаксиальной плёнке, так и новых CVD и PVT процессов для выращивания толстых слоёв 3C-SiC.
GaN-диоды Шоттки и FET-транзисторы для силовой электроники
GaN-диоды Шоттки для силовой электроники характеризуются лучшими, чем у SiC-диодов, динамическими характеристики: более чем на 30% меньше заряд обратного восстановления, более чем в 2 раза меньше потери мощности (см. рис. 6 и 7) [6]. Также у них более высокая удельная плотность мощности, чем у SiC-диодов. Но несмотря на эти явные преимущества изготовление GaN-диодов Шоттки ограничивается только исследованиями в лабораториях и исследовательских центрах при университетах.

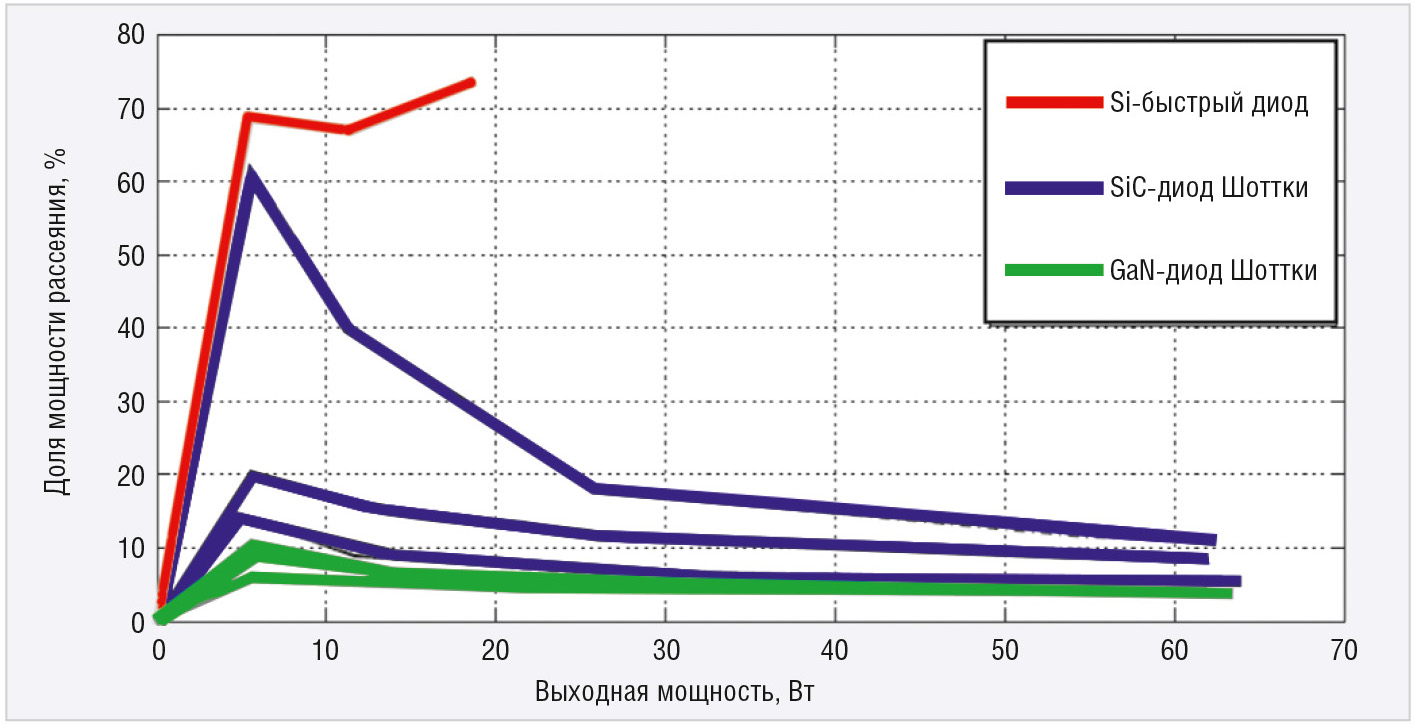
Из основных преимуществ GaN-транзисторов в сравнении с SiC-транзисторами следует отметить более высокую удельную плотность мощности, более высокую частоту переключения, низкое сопротивление в открытом состоянии (см. рис. 8) [7]. По сравнению с мощными транзисторами на других материалах GaN FET-транзисторы обладают рекордной удельной плотностью мощности и высокой эффективностью.
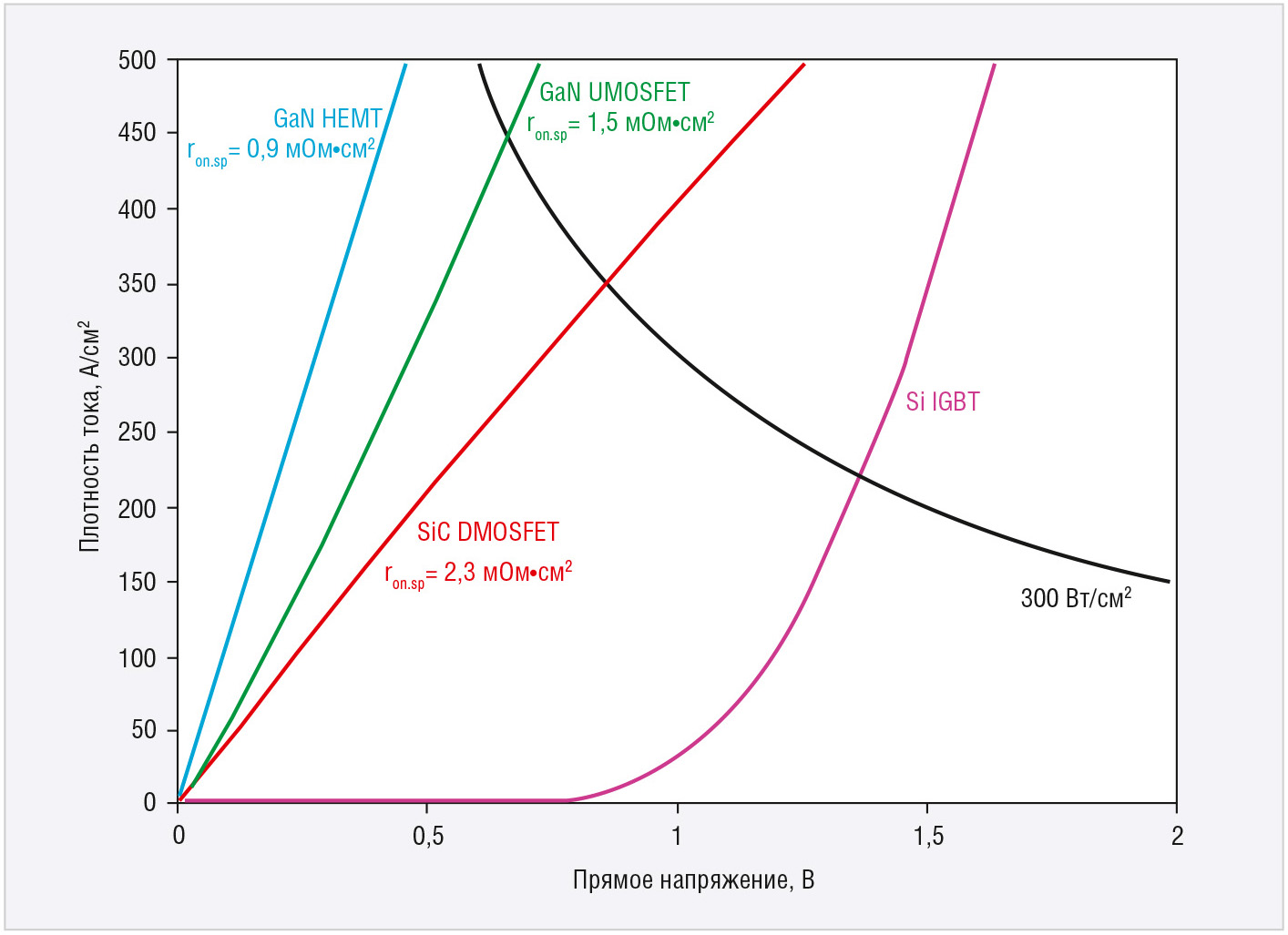
Пионерами и лидерами в производстве GaN FET-транзисторов являются компании EPC и Infineon (IR). Основные электрические параметры GaN FET этих компаний представлены в таблице 3.

Этими компаниями используется GaN-on-Si техпроцесс, позволяющий существенно снизить себестоимость силовых приборов по сравнению с GaN на сапфире, GaN-on-SiC или монолитной GaN-подложке. Однако высокие механические напряжения, возникающие при выращивании GaN эпитаксии на кремниевой подложке из-за очень большого изгиба последней, ограничивают как активную площадь разрабатываемых приборов, так и диаметр пластин. Исследовательский центр компании IBM на конференции APEC 2019 представил новую технологию, которая позволяет в обычном КМОП-процессе с диаметром пластин 200 мм и выше изготавливать высоковольтные (от 48 до 600 В) GaN-приборы размером до 500×500 мкм2 [8, 9]. Метод заключается в селективном выращивании 1,5-мкм AlGaN/GaN эпитаксиальной плёнки в областях размером от 1×1 до 500×500 мкм2 (см. рис. 9), что позволяет значительно уменьшить плотность кристаллографических дефектов в AlGaN/GaN-материале, при этом площадь заполнения GaN-областями может достигать 50%.
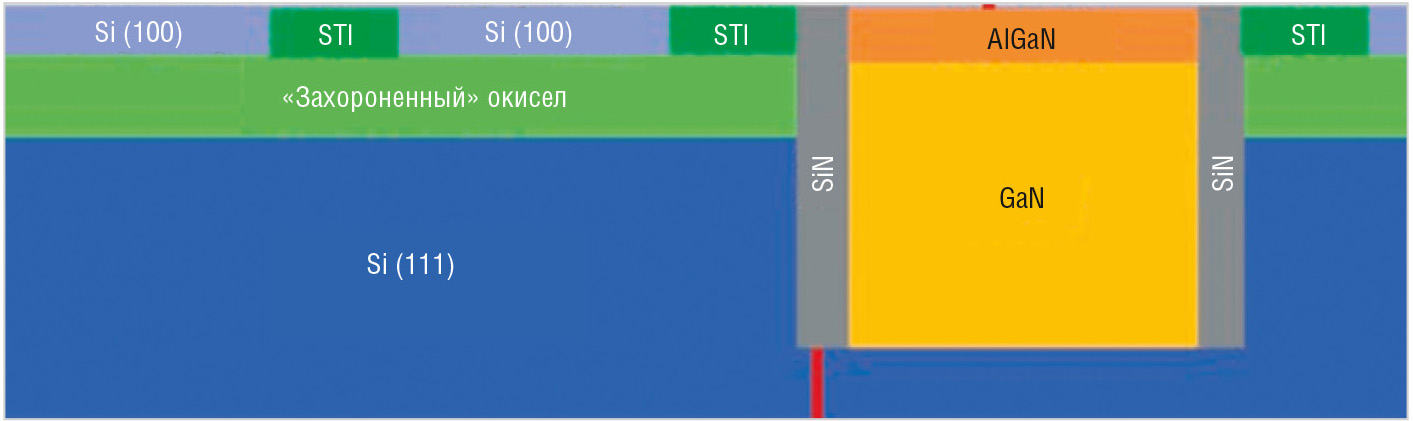
Данный метод позволяет изготавливать полноценные КМОП-управляющие ИМС с интегрированными высоковольтными GaN- транзисторами и диодами.
Заключение
Значительный прогресс в развитии SiC- и GaN-технологий, достигнутый за последние 15 лет, привёл к появлению коммерческих SiC-диодов Шоттки, SiC- и GaN FET-транзисторов для силовой электроники. Несмотря на большую стоимость этих приборов, в сравнении с соответствующими по мощности кремниевыми приборами, себестоимость конечного модуля может быть такой же и даже ниже за счёт снижения стоимости пассивных компонентов модуля: индуктивностей, конденсаторов, радиаторов охлаждения.
Литература
- Neudeck P.G., Spry D.J., Norman L.C., Prokop F. and Krasowski M.J. Demonstration of 4H-SiC Digital Integrated Circuits Above 800°C. IEEE Electron Device Letters, Vol. 38, № 8, August 2017, p.1082–1085.
- Ranbir Singh. High Performance SiC Devices. Презентация компании GeneSiC Semiconductor. https://www.genesicsemi.com.
- Christian Felgemacher. SiC Solution for Industrial Auxilliary Power Supply. Презентация компании ROHM Semiconductor: https://hobbydocbox.com/81974949-Radio/SiС-solution-for-industrial-auxilliary-power-supply.html.
- Интернет-ресурс компании STMicro-electronis. Ссылка на статью: https://www.st.com/content/ccc/resource/technical/document/conference_paper/d9/1a/36/d4/80/75/48/de/....
- Francesco La Via, at al. 3C-SiC Hetero-Epitaxially Grown on Silicon Compliance Substrates and New 3C-SiC Substrates for Sustainable Wide-Band-Gap Power Devices. Materials Science Forum, 2018 Trans Tech Publications, Switzerland, ISSN: 1662-9752, Vol. 924, p. 913–918.
- Susumu Yoshimoto, at al. Fast Recovery Performance of Vertical Schottky Barrier Diodes on Low Dislocation Density Freestanding GaN Substrates. SEI Technical Review, Num. 80, April, 2015, p. 35–39.
- Sauvik Chowdhury, Zhibo Guo, Xueqing Liu and T. Paul Chow. Comparison of Silicon, SiC and GaN Power Transistor Technologies with Breakdown Voltage Rating from 1.2 kV to 15 kV. Phys. Status Solidi, 2016, C. 13, No. 5–6, p. 354–359.
- Lee, K.-T., Bayram, C., Piedra, D., Sprogis, E., Deligianni, H., Krishnan, B., Sadana, D. GaN Devices on a 200 mm Si Platform Targeting Heterogeneous Integration. IEEE Electron Device Letters, 2017, 38 (8), p. 1094–1096.
- IBM Thomas J. Watson Research Center. Silicon/GaN Integration Targeting On-Chip 48 V Input Power Conversion. Power Electronics Europe, Issue 2, 2019.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!