Причинами написания настоящей статьи послужили многочисленные экспериментально зафиксированные случаи изменения физикохимических характеристик диэлектрических плёнок под воздействием электронного облучения, как при их обработке в газоразрядной плазме, так и в процессе их электронномикроскопических исследований [1, 2].
В качестве объекта исследований в настоящей работе была выбрана плёнка нитрида кремния (Si3N4) толщиной 0,12 мкм, осаждённая на слой термического оксида кремния (SiO2) толщиной 0,6 мкм, сформированного на тестовой пластине монокремния КДБ12 (100) диаметром 150 мм.
Плёнка нитрида кремния осаждалась в плазмоактивируемом силановоаммиачном процессе при пониженном давлении [3, 4]:

Этот процесс проводился на установке ConceptOne компании Novellus Systems Inc. (США) при следующих значениях операционных параметров:
- рабочее давление – 372 Па (2,8 мм рт. ст.);
- газноситель – азот (N2);
- температура – 350°C;
- расходы компонентов газовой смеси: Q(N2) = 1 л/мин; Q(SiH4) = 0,28 л/мин; Q(NH3) = 1,8 л/мин;
- мощность высокочастотного (HF, High Frequency) с частотой 13,56 МГц плазменного генератора – W(HF) = 320 Вт;
- мощность низкочастотного (LF, Low Frequency) перестраиваемого с частотами (100–400) кГц плазменного генератора – W(LF) = 480 Вт.
В химической реакции (1) указана общая формула SixNyHz плёнки нитрида кремния, которая может содержать от 10 до 20 атомных процентов (at %) водорода в виде связей Si–H и N–H [3]. Но для простоты и наглядности плёнка нитрида кремния в настоящей статье будет обозначаться формулой Si3N4. Однако при анализе изменения состава плёнки нитрида кремния под воздействием электронного облучения будет учитываться содержание водорода в её составе.
В указанном режиме на пластине была осаждена плёнка нитрида кремния, которая имела следующие характеристики:
- неравномерность по толщине ≤4,5% (3σ) по диаметру 150 мм;
- показатель преломления n(Si3N4) =1,964 ± 0,002;
- плотность ρ(Si3N4) = 2,65 ± 0,15 г/см3.
Следует отметить, что плотность слоя термического оксида кремния ρ(SiO2), на который осаждалась плёнка Si3N4, составляла 2,2 ± 0,1 г/см3, а его показатель преломления n(SiO2) = 1,45 ± 0,01.
На установке прецизионной лазерной маркировки МЛП2002А с помощью процесса лазерной абляции в центре тестовой кремниевой пластины была сформирована метка, показанная на рисунке 1. Метка состоит из четырёх квадратов 1, 2, 3 и 4 размером 345 × 345 мкм, расположенных внутри большого квадрата размером 790 × 790 мкм. Кроме того, на рисунке 1 показаны области 5 и 6, расположенные в 10 мм соответственно справа и слева от боковых границ большого квадрата.

Облучение электронами плёнки Si3N4 проводилось в центральных областях квадратов 2 и 4 размером (120 × 240) мкм, на растровом электронном микроскопе JSM6490LV компании JEOL Co (Япония) при давлении 10–3 Па (7,5·10–6 мм рт. ст.). Центральная область квадрата 2 облучалась электронным пучком с энергией E2e = 5 кэВ, током I2e = 5 нА в течение периода времени t2 = 1,5 часа. Следовательно, доза облучения области D2e = 27,1 мкКл. Центральная область квадрата 4 облучалось электронным пучком с энергией E4e = 10 кэВ, током I4e = 5 нА в течение периода времени t4 = 1,5 часа. При этом доза облучения области D4e = 27,1 мкКл.
Согласно [5], проекция пробега электронов в поликристаллических и аморфных материалах на нормаль к их поверхности Rer (глубина проникновения электронов в материал с плотностью r до их остановки) определяется по экспериментальной формуле:

Для квадрата 2 пробег электронов с энергией E2e = 5 кэВ в слое нитрида кремния с плотностью ρ(Si3N4) = 2,65 г/см3 составит R2er = 0,36 мкм, т.е. электроны пролетят через весь слой Si3N4 толщиной 0,12 мкм и ещё пройдут в слой оксида кремния толщиной 0,6 мкм и плотностью 2,2 г/см3 на глубину около 0,3 мкм.
Для квадрата 4 электронов с энергией E4e = 10 кэВ в слое нитрида кремния с плотностью ρ(Si3N4) = 2,65 г/см3 составит R2er = 1,16 мкм, т.е. электроны пролетят через весь слой Si3N4 толщиной 0,12 мкм, через весь слой SiO2 толщиной 0,6 мкм и плотностью 2,2 г/см3 и войдут в слой монокремния с плотностью 2,42 г/см3 на глубину около 0,5 мкм.
Аналогичные результаты по расчёту глубины проникновения электронов с энергией в диапазоне 0,5…3000 кэВ в материалы с плотностью r даёт эмпирическая формула [6]:

В связи с тем, что энергия облучающих центральную область квадрата 4 электронов в два раза больше, чем энергия электронов, облучающих аналогичную область квадрата 2, то скорость их движения в слое Si3N4 квадрата 4, исходя из уравнения [7]:

больше в (2)1/2 = 1,4, т.е. v4e = 1,4·v2e.
Поэтому эффективное время воздействия электронов, а, следовательно, и доза воздействия, на слой нитрида кремния (время пролёта электронов через слой) в квадрате 2 будет больше, чем в квадрате 4, т.е. t2ef = 1,4 × t4ef и D2eef = 1,4 × D4eef. Но следует помнить, что электроны с большей энергией имеют меньшую длину волны, и обладают большей способностью к разрыву химических связей при взаимодействии с различными материалами.
Для электронов в качестве длины волны используется длина волны де Бройля, которая определяется по формуле [8, 9]:

где h = 6,626 × 10–34 Дж × с – постоянная Планка; me = 9,109 × 10–31 кг и e = 1,602 × 10–19 Кл – масса покоя и заряд электрона; Ee – энергия электронов в эВ.
Подставляя и сокращая значения постоянных, и преобразовав формулу (5) для практически удобных единиц измерения, можно получить выражение для длины волны электронов в нанометрах[7]:

где Ee – энергия электронов в эВ. Например, λe = 0,017 нм при Ee = 5 кэВ, а λe = 0,012 нм при Ee = 10 кэВ.
В отличие от оптического, экстремального ультрафиолетового (ЭУФ) и рентгеновского излучений поток электронов не является электромагнитным излучением. Электрон несёт заряд, что позволяет формировать (фокусировать) и отклонять пучок электронов с помощью электрических и магнитных полей, генерируемых электроннооптическими системами.
При попадании быстродвижущихся электронов в слой любого твёрдого молекулярного материала они теряют часть своей кинетической энергии за счёт электростатического взаимодействия с электронами, входящими в состав молекул материала. При этом происходит: либо выбивание молекулярных электронов, т.е. ионизация молекул, либо переход молекулярных электронов на более высокую орбиту, т.е. возбуждение молекул. Ионизированные и возбуждённые молекулы облучаемого электронами материала диссоциируют и образуют свободные радикалы.
Таким образом, первичное воздействие электронов на твёрдый материал, например слой нитрида кремния, проявляется в образовании в его объёме ионов, а также свободных атомов и радикалов. Эти активные группы в дальнейшем вступают в реакции между собой или диффундируют и десорбируются из облучённого слоя. В зависимости от структуры и химического состава материала, они могут образовывать новые молекулы, как с бóльшим, так и с меньшим стехиометрическим соотношением компонент по сравнению с молекулами необлучённого материала.
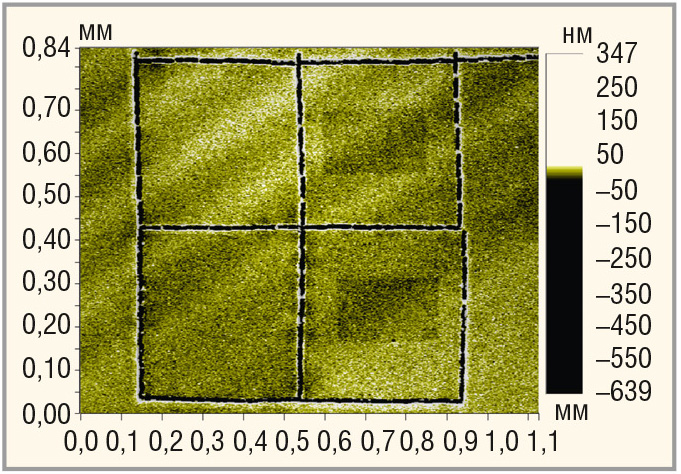
На рисунке 2 указанные области облучения электронами были визуализированы с помощью оптического профилометра Wyko NT 9300 компании Veeco (США) в режиме вертикальной сканирующей интерферометрии (Vertical Scanning Interferometry, VSI). При этом, как показано на рисунке 3, сдвига интерференционных полос при переходе с необлучённых электронами областей на облучённые области не наблюдается, т.е. они имеют одинаковую толщину и не формируют между собой ступеньку.
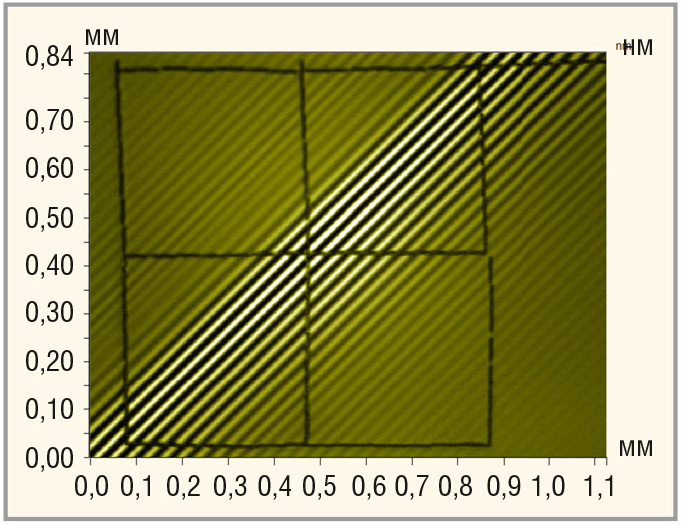
Дальнейшая проверка наличия или отсутствия рельефа между облучёнными и необлучёнными электронами областями в квадратах 2 и 4 проводилась с помощью контактного профилометра Alpha Step 200 компании KLATencor Corporation (США). На рисунке 4 показаны направления, участки и результаты сканирования в квадратах 2 и 4 между облучёнными и необлучёнными электронами областями.

Рисунки наглядно показывают отсутствие ступеньки рельефа между облучёнными и необлучёнными электронами областями в квадратах 2 и 4, а это означает, что оптический контраст между этими областями должен быть связан с изменениями оптических свойств слоя нитрида кремния при электронном облучении. Наличие больших случайных пиков на сканах связано с дефектами, привносимыми на поверхность плёнки в процессе формирования метки на тестовой пластине.
Определение толщин слоёв двуокиси и нитрида кремния, а также показателя преломления слоя нитрида кремния n(Si3N4) на облучённых и необлучённых электронами исследуемых областях кремниевой пластины, проводилось на сканирующем спектральном эллипсометре Auto SE компании HORIBA Scientific (Япония). Полученные результаты сведены в таблице 1.

Из данных таблицы 1 видно, что значения коэффициента преломления облучённой плёнки Si3N4 в квадратах 2 и 4 на две сотые величины меньше значений n(Si3N4) необлучённой плёнки Si3N4 в квадратах 1 и 3 и в областях 5 и 6 (см. рис. 1), при точности метода ± 0,001. Уменьшение показателя преломления облучённых электронами областей плёнки нитрида кремния однозначно свидетельствует о снижении в нём относительной концентрации атомов кремния и повышении относительной концентрации атомов азота [4].
Определение химического состава на облучённых и необлучённых электронами областях плёнки нитрида кремния на тестовой кремниевой пластине проводилось методом энергодисперсионного рентгеновского микроанализа на растровом электронном микроскопе JSM6490LV компании JEOL Co (Япония). Полученные результаты сведены в таблице 2.

Данные таблицы 2 показывают, что в облучённой электронами области 4 атомная концентрация кремния в среднем на 10% меньше, а атомная концентрация азота в среднем на 10% больше по сравнению с необлучённой областью 5. Этот факт наиболее логично может быть объяснён с привлечением атомов водорода, содержащихся в плёнке нитрида кремния, но не фиксируемых энергодисперсионным рентгеновским микроанализом.
Действительно, под воздействием электронного облучения происходит разрыв связей Si–H и N–H, содержащихся в плёнке нитрида кремния. Энергия разрыва связи Si–H составляет 3,09 эВ, а связи N–H – 3,42 эВ [4]. В результате маленькие и подвижные освобождённые атомы водорода быстро покидают плёнку нитрида кремния, а более крупные и медленные атомы азота захватываются свободными связями кремния. Таким образом, за счёт ухода атомов водорода снижается относительная концентрация атомов кремния и повышается относительная концентрации атомов азота в плёнке нитрида кремния.
Так как энергия электронов, облучивших область 2, в два раза ниже, чем энергия электронов, облучивших область 4, то в области 2 произойдёт меньшее количество разрывов водородных связей. Следовательно, меньше атомов водорода уйдёт из плёнки нитрида кремния, и поэтому относительная концентрация атомов кремния снизится меньше, а относительная концентрация атомов азота возрастёт меньше в области 2, чем в области 4. И этот экспериментальный факт наблюдается в таблице 2.
Изменения химического состава в облучённых электронами областях плёнки нитрида кремния практически не распространяются за пределы облучённых областей. Как показано в таблице 2, несмотря на эффекты:
- электростатического расталкивания электронов при заряде диэлектрической плёнки нитрида кремния,
- рассеяния пучка электронов в толщине этой плёнки,
- отражения электронов от границ раздела слоёв,
- уже на расстояниях 5 мкм от облучаемых областей химический состав плёнки нитрида кремния практически стабилизируется и незначительно отличается от химического состава не облучаемой плёнки.
В заключение следует отметить следующий факт, что в отличие от водородосодержащих плёнок нитрида и оксида кремния, осаждённых в низкотемпературных плазмохимических процессах, плёнки нитрида и оксида кремния, сформированные в высокотемпературных процессах, практически не содержат в своём составе атомов водорода [3, 4]. Для таких высокотемпературных плёнок Si3N4 и SiO2 электронное облучение приводит к росту в них концентрации кремния и снижению концентрации соответственно азота и кислорода, а, следовательно, к увеличению скорости травления облучённых электронами участков этих плёнок в жидкостных химических травителях, например, на основе плавиковой кислоты [1].
Авторы выражают свою благодарность начальнику участка диффузии и осаждения слоёв А.П. Онуфриенко за помощь в осаждении плазмохимических плёнок нитрида кремния.
Работа выполнена при поддержке Министерства образования и науки Российской Федерации (соглашение №14.578.21.0001, уникальный идентификатор RFMEFI57814X0001) с использованием оборудования Центра коллективного пользования «Микросистемная техника и электронная компонентная база».
Литература
- Simon J.F., Johnson J.E., O’Keeffe T.W. Method and Apparatus for Selective Etching of Insulating Layers. Patent USA. Class 148–187. №3580749. The priority date 13.10.1968.
- Вопросы плёночной электроники. Сборник статей. М. «Светское радио». 1966. 472 с.
- Киреев В.Ю., Столяров А.А. Технологии микроэлектроники. Химическое осаждение из газовой фазы. М. «Техносфера». 2006. 192 с.
- Плазменная технология в производстве СБИС. Пер. с англ. Под редакцией Айнспрука Н. и Брауна Д. М. «Мир». 1987. 469 с.
- Фелдман Л., Майер Д. Основы анализа поверхности и тонких плёнок. Пер. с англ. М. «Мир». 1989. 344 с.
- Коваленко В.Ф. Теплофизические процессы и электровакуумные приборы. М. «Советское радио». 1975. 215 с.
- Киреев В.Ю. Нанотехнологии в микроэлектронике. Нанолитография – процессы и оборудование. Долгопрудный. Издательский Дом «Интеллект». 2016. 320 с.
- Handbook of Semiconductor Manufacturing Technology. Edited by Y. Nishi and R. Doering. Marcell Dekker Inc. N.Y. USA. Second Edition. 2008. 1722 pp.
- Handbook of Photomask Manufacturing Technology. Edited by S. Rizvi. CRC Press. Taylor & Francis Group. Roca Raton. 2005. 632 pp.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!