Полупроводниковые гетероструктуры на основе массивов квантовых точек
Как отмечалось выше, в 1981 году Алексей Екимов с коллегами в «ГОИ им. С.И. Вавилова» впервые в мире получили локализованные в стекле микрокристаллы CuCl (10–100 Å), показавшие устойчивый квантово-размерный эффект с нулевым показателем (0-DOF). Позже эти нанокристаллы получили название «квантовые точки» (Quantum Dots – QD) [1].
Через год Луис Брюс (Louis Brus), используя синтез и осаждение из коллоидных растворов, получил в своей лаборатории (AT&T Bell Laboratories) обособленные твёрдые химически стабильные микрокристаллы сульфида кадмия размером около 3–4 нм. Эти нанокристаллы проявляли устойчивый повторяющийся квантово-размерный эффект (0-DOF) [2].
Основная заслуга группы Луиса Брюса заключалась в том, что им удалось найти способ, с помощью которого можно было получать в виде чистого сухого порошка полупроводниковые обособленные квантовые точки, покрытые химически связанными органическими лигандами. Эти нанокристаллы позже получили название «коллоидные квантовые точки» [3–5].
В начале 1990-х Мунги Бавенди (Moungi Gabriel Bawendi) со своими коллегами из MIT (Massachusetts Institute of Technology) разработали технологию массового синтеза квантовых точек, которая была названа «высокотемпературный металлоорганический синтез с использованием горячего впрыска» (Organometallic Chemical Hot Injection) [6].
Алексей Екимов, Луис Брюс и Мунги Бавенди получили в 2023 году Нобелевскую премию за открытие и разработку квантовых точек.
Более подробно эти вопросы рассмотрены в предыдущих номерах журнала (СОЭЛ № 2, 4, 5, 2024) [7].
Необходимо чётко различать три термина «квантовые точки» (Quantum Dots), используемые в литературе. Идеальные квантовые точки (ИКТ) – это теоретическая абстракция, которая используется для моделирования и рассматривается как абсолютно однородная наноструктура с квантовым ограничением по всем трём направлениям. Именно «идеальная квантовая точка» подразумевается, когда говорят об «искусственном атоме». Поэтому ИКТ имеют строго линейчатый дискретный энергетический спектр, аналогичный спектру одиночного атома.
Квантовые точки, открытые Луисом Брюсом и представляющие собой отдельные полупроводниковые нанокристаллы с размерами 5–10 нм, покрытые защитной оболочкой, правильнее было бы называть «коллоидные ККТ» (Colloidal Quantum Dots – CQD). Следует подчеркнуть, что в одной обособленной коллоидной квантовой точке могут содержаться сотни тысяч атомов вещества полупроводника.
Одним из уникальных свойств CQD является квантово-размерная фотолюминесценция (КРФЛ). Благодаря этому свойству CQD в ответ на ультрафиолетовое излучение испускает свет, длина волны которого зависит от размера самой квантовой точки. Это свойство широко используется в таких компонентах современной электроники, как, например, светодиоды, матрицы и экраны на основе ККТ.
В настоящее время существуют технологии нанесения коллоидных квантовых точек (CQD) на слои подложек толщиной до 1 мкм. Подобные методы позволяют интегрировать коллоидные квантовые точечные фотодиоды непосредственно в полупроводниковые металл-оксидные интегральные схемы. На рис. 1 показана структурная схема сверхчувствительного тепловизора, способного обрабатывать инфракрасный образ объектов, излучающих в диапазоне 400–1300 нм с разрешением 640×512 пикселей (40 пар линий на миллиметр) при передаточной функции модуляции 50%.
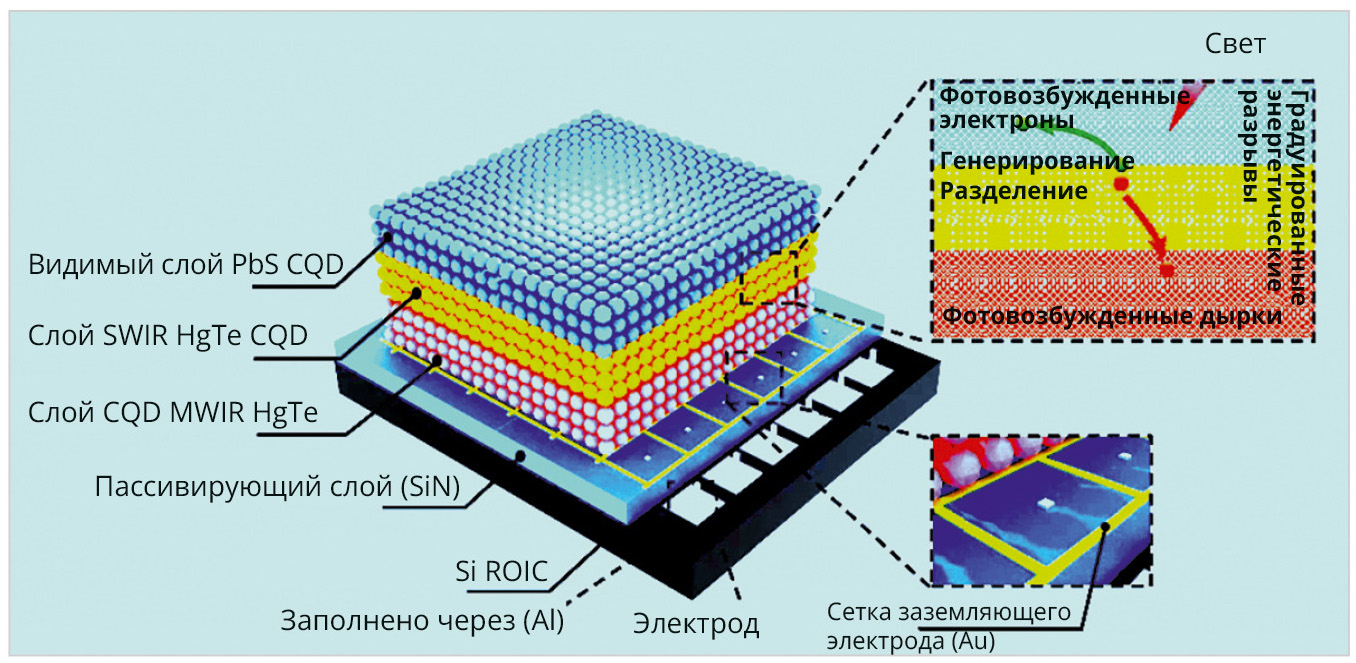
Такие фантастические характеристики получены благодаря конструкции фотодетектора, включающей слои CQD, вмонтированные непосредственно в специально разработанную интегральную схему [8].
К другому классу устройств на основе КТ можно отнести массивы полупроводниковых КРЭ-нанокристаллов, включённых в монокристаллическую объёмную матрицу другого полупроводника. Такие гетероструктуры содержат квантовые точки с узкой запрещённой зоной, выращенные на подложке из полупроводника с широкой запрещённой зоной.
Обычно такие гетероструктуры содержат чередующиеся слои квантовых точек, разделённые слоями буферного полупроводника.
В качестве примера на рис. 2 показана микрофотография, полученная на 3D атомно-силовом микроскопе (АСМ) для структурированного массива самоорганизующихся квантовых точек InAs, выращенных на подложке GaAs.
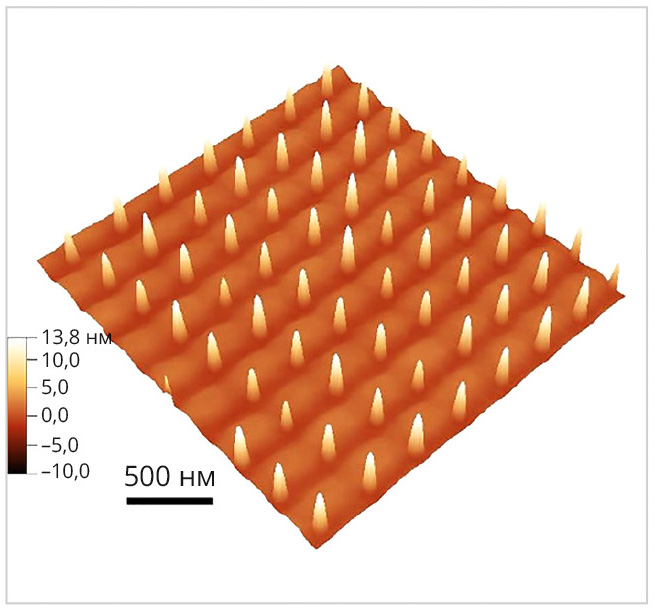
Эта гетероструктура на основе КТ была создана с помощью современного метода «молекулярно-лучевой эпитаксии с использованием прямого лазерного интерференционного формирования структуры» (Molecular Beam Epitaxy Assisted by Direct Laser Interference Patterning MBE-DLIP). Подобные матричные КРЭ-гетероструктуры содержат миллионы одиночных пирамидообразных квантовых точек [9].
Именно эти гетероструктуры на основе квантовых точек используются в полупроводниковых инжекционных лазерах, разработкам которых посвятил свою жизнь Жорес Алфёров.
Необходимо подчеркнуть, что для использования в полупроводниковых лазерах необходимы гетероструктуры, содержащие огромное количество однородных квантовых точек с размерами меньше длины волны де Бройля, плотно упакованных в кристаллическую полупроводниковую матрицу. Достаточно успешно, однако далеко не полностью на 100%, эту проблему удалось решить только в наши дни (рис. 2). На это потребовалось около тридцати лет напряжённых поисков и неудачных попыток.
Попытки изготовления таких структур регулярно предпринимались с начала 1990-х годов, однако ни одна из известных в то время технологий не позволяла изготовить CQD с параметрами, близкими к идеальной квантовой точке. Массивы квантовых точек получались неоднородными, а энергетические спектры были размыты [10].
Ситуация резко изменилась после «реинкарнации» процесса роста мономолекулярных плёнок на подложках.
В очередной раз подтвердилась истинность формулы научного поиска: «новое – это хорошо забытое старое».
В 1938 году болгарские физики из «Университета Софии» Иван Странский (Иван Николов Странски) и Любомир Краштанов (Любомир Кръстанов) предложили технологию двухэтапного процесса эпитаксиального выращивания тонких плёнок на поверхности кристаллов. Технология получила название по именам авторов «Stranski–Krastanov Growth – SK growth» (Странски–Краштанов, СК) [11].
Эта технология включает два основных этапа (рис. 3).
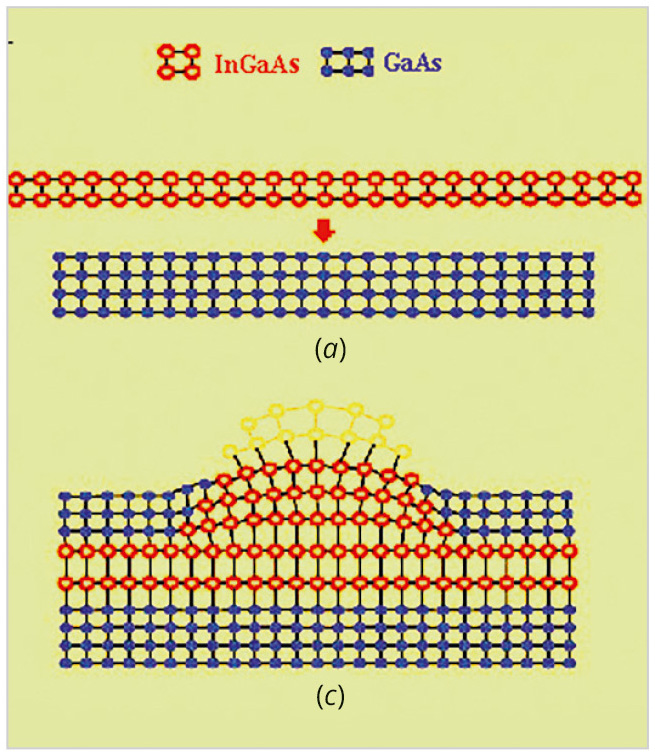
Сначала на подложку тем или иным способом наносится первый слой целевого вещества (InGaAs). При этом образуется тонкая плёнка на поверхности подложки, получившая название «смачивающий слой» (Wetting Layer). Из-за несоответствия постоянных решёток арсенида галлия и индий-галлий арсенида на поверхности смачивающего слоя образуются дефекты кристаллической структуры.
Далее плёнка наносимого вещества может нарастать, формируя последовательно мономолекулярные слои. Вместе с количеством слоёв накапливаются и напряжения, связанные с дефектами, заложенными в «смачивающем слое». При достижении некоторой «критической толщины слоя», которая зависит от деформации и химического потенциала осаждённой пленки, напряжённые участки плёнки разрушаются, и в этих местах образуются «островки» осаждаемого материала.
Эти островки позднее стали называть «самоорганизующиеся квантовые точки» (Self-Organized Quantum Dots).
Непрерывное продолжение этого процесса приводит к тому, что островки просто поглощаются следующим нарастающим мономолекулярным слоем. Однако было обнаружено, что если процесс прерывался при формировании «зародышей КТ», то островки сохранялись в виде обособленных кристаллических структур с размерами единиц до нескольких десятков нанометров.
Эта схема описывает саму идею метода СК. На практике технология тех времен давала возможность получать только толстые плёнки, содержащие хаотически разбросанные по неравномерной поверхности островки самых разных форм и размеров.
Только с развитием методов «молекулярно-пучковой эпитаксии МПЭ» и «молекулярно-лучевой эпитаксии» стало возможным использование технологии «Странски–Краштанова» для выращивания эффективных КРЭ-гетероструктур. Идея метода МПЭ заключается в том, что в специальном источнике целевое вещество полупроводника испаряется до уровня молекул, которые затем осаждаются на кристаллическую решетку подложки. В процессе МПЭ молекулы или атомы материалов, необходимые для роста, подаются на подложку в виде молекулярных пучков. Это позволяет контролировать состав и толщину слоёв с высокой точностью и выращивать гетероструктуры с моноатомно гладкими границами, заданными профилем легирования.
Необходимо отметить, что реализация данной технологии требует чрезвычайно сложных технических решений, таких, например, как:
- сверхвысокий вакуум в рабочей камере (около 10−8 Па);
- процентное содержание целевого полупроводника в напыляемом молекулярном потоке не менее 99,999999%;
- способность молекулярного источника испарять тугоплавкие вещества с возможностью регулировки плотности потока вещества;
- прецизионный контроль скорости роста молекулярной плёнки (±0,2 нм/с).
Современный вариант установки для синтеза полупроводниковых соединений типа A3B5 методом МПЭ показан на рис. 4.
![Рис. 4. Современный вариант установки для синтеза полупроводниковых соединений типа A3B5 методом молекулярно-пучковой эпитаксии [12]](/images_soel/publications/2025/2025-2/SE2025-2_06-04.jpg)
В тех случаях, когда речь идёт о послойном напылении молекулярного слоя полупроводника на подложку, достаточно часто используются в качестве взаимозаменяемых два термина: «молекулярно-пучковая эпитаксия МПЭ» и «молекулярно-лучевая эпитаксия МЛЭ». Однако эти технологические варианты могут иметь некоторые нюансы в определённых приложениях.
В некоторых источниках МЛЭ рассматривается как более широкий термин, включающий различные техники и подходы к эпитаксии, тогда как МПЭ может быть более специфичным методом внутри этого диапазона.
Технология молекулярно-лучевой эпитаксии, так же как и МПЭ, относится к процессу, использующему взаимодействие молекулярных пучков наносимого вещества с подложкой. Однако в технологии МЛЭ подразумевается использование различных источников для испарения материалов, включая твёрдые и газовые источники.
Появление доступных методов МЛЭ и МПЭ в совокупности с модернизированными методиками «SK growth» стимулировало разработки КРЭ-гетероструктур во всём мире.
Первые попытки роста микрокристаллов группы A3B5 с использованием этих технологий были начаты в середине 1980-х. Так, в 1985 году в работе [13] были описаны мономолекулярные слои InAs, которые выращивались на подложках GaAs. Французские физики из группы CNET показали, что сначала рост происходит в плоском режиме с образованием «смачивающего» слоя. При некоторой критической толщине этот планарный рост прерывается, и на поверхности образуются трёхмерные наноразмерные островки InAs.
Прямое экспериментальное подтверждение возможности формирования квантово-размерных микрокристаллов из однородных когерентных островков InGaAs на поверхностях GaAs было получено в 1993 году группой Леонарда Девина [14].
Исследование процесса роста InGaAs на подложке GaAs показало, что, когда рост InGaAs прерывался точно при достижении критической толщины, образовывались квантовые точки InGaAs со средними размерами в районе 30 нм. Плотность точек на поверхности варьировалась примерно от 109 до 1011 единиц на квадратный сантиметр.
В следующей работе (1994 г.) эти же авторы установили, что в результате осаждения InAs методом молекулярно-лучевой эпитаксии на грани {100} кристалла GaAs самоорганизующиеся когерентные квантовые точки арсенида индия практически одного размера наблюдались только на начальном этапе перехода через критическую толщину, равную 1,50 ML [15].
Напомним, что «monolayer – ML» является наиболее распространённой единицей измерения в этой области и означает один атомный слой материала. Согласно современным уточнённым данным для GaAs 1 ML соответствует приблизительно 3,03 Å (ангстрем).
В настоящей статье невозможно дать даже беглый обзор истории развития гетерогенных структур и инжекционных лазеров на основе массивов квантовых точек. Эти вопросы можно посмотреть, например, в подробной публикации, посвящённой 85-летию Арта Госсарда (Art Gossard), одного из создателей и разработчиков технологий на базе молекулярно-лучевой эпитаксии [16].
В этот период под руководством Жореса Алфёрова и Николая Леденцова были проведены основные экспериментальные и теоретические исследования массивов КТ, использованные в дальнейшем для создания отечественных лазеров на квантовых точках.
За годы своей научной деятельности Жорес Алфёров вместе со своими учениками написали более тысячи научных работ. Рассмотреть все эти публикации не представляется возможным. Ниже кратко отмечены только те статьи группы Алфёрова, которые легли в основу конструкции инжекционного лазера на квантовых точках и являются необходимыми для понимания того вклада, который внёс Жорес Алфёров в развитие и становление этой отдельной бурно развивающейся отрасли.
Использование модернизированной методики МПЭ, разработанной в ФТИ им. Иоффе, позволило сотрудникам группы Алфёрова получить квантово-размерные AlGaAs/GaAs – гетероструктуры со 100% квантовым выходом излучательной рекомбинации. Результаты измерений фотолюминесценции показали, что внутренний квантовый выход (ВКВ) этих КРЭ-гетероструктур сильно зависит от толщины активной области. Так, в структурах с толщиной более 100 Å при комнатной температуре ВКВ приближается к 100%, а при уменьшении толщины активной области до 50 Å ВКВ падает до 40%. Такую зависимость ВКВ от толщины активного слоя можно было объяснить термическим выбросом носителей и последующей рекомбинацией в волноводных слоях. Верхний предел пороговой плотности излучения в исследованных образцах соответствовал плотности тока 250 А/см2 [17].
В ходе выполнения исследований массивов КТ, проведённых в ФТИ им. Иоффе в 1990-е годы, например, было доказано, что, контролируя толщину смачивающего слоя и регулируя параметры прерывания процесса роста массивов КТ, можно получать узкое распределение островков «зародышей» КТ по размерам [18].
Квантовые точки InAs в матрице GaAs, полученные методом молекулярно-лучевой эпитаксии с использованием самоорганизующегося механизма, продемонстрировали узкое распределение размеров отдельных точек пирамидальной формы с основанием 12 ±1 нм и высотой 4–6 нм [19].
В работе [20] массивы квантовых точек InAs/GaAs исследовались с помощью метода катодной люминесценции. Изображения катодолюминесценции позволили напрямую визуализировать отдельные положения точек и рекомбинацию из одной точки. Плотный массив точек (около 1011 точек/см2) показал наличие отчётливого пика поглощения, который практически совпадал с максимумом люминесценции. Полученные результаты показали, что распределение линий катодолюминесценции отдельных квантовых точек InAs в матрице GaAs при температурах около 50К позволяет аппроксимировать плотность электронных состояний с помощью функции, характерной для идеальных квантовых точек [21].
Температурная зависимость морфологических изменений слоёв InAs и In0,5Ga0,5As, выращенных методом МЛЭ, рассмотрена в работе [22].
Осаждение при температуре 450–480°C слоёв InAs толщиной от 3 до 7 ML и InxGa1−xAs толщиной от 5 до 10 ML продемонстрировало самообразование хорошо развитых пирамидальных КТ с основанием около 12 нм, которые выстраивались в двумерной квадратной решётке вдоль направления {100}. При температуре осаждения около 320°C самообразующиеся КТ выстраивались преимущественно в направлении {110}.
В работе [23] приведены результаты исследований зависимости пороговой плотности тока от температуры в лазерах на основе КТ (InGa)As/(AlGa)As. Обнаруженный диапазон так называемых «отрицательных характеристических температур» являлся следствием термического выброса носителей из состояний КТ в матрицу и смачивающий слой.
Влияние высокотемпературного отжига (High Temperature Annealing – HTA) на структурные и оптические свойства квантовых точек InAs–GaAs было рассмотрено в [24].
В системе островков, которые являются «зародышами» квантовых точек, имеются два источника упругих напряжений, зависящих от температурных режимов синтеза: напряжение на поверхности, обусловленное рассогласованием параметров решеток, и сильный градиент поверхностного натяжения на рёбрах островков.
Отжиг при более высокой температуре (700°C) структур с двумерными и трёхмерными массивами в квантовых точках (КТ) InAs–GaAs приводит к увеличению размера и соответствующему уменьшению содержания индия в КТ. Соответствующее уменьшение энергии локализации КТ приводит к эффективному испарению носителей из КТ при комнатной температуре.
В публикации [25] был предложен новый метод, позволяющий создавать напряжённые гетероструктуры на основе InAs/GaAs. Идея этого метода, названного авторами «субмонослойной эпитаксией», заключалась в оптимальном выборе соответствующей грани кристалла подложки таким образом, чтобы получить конечные массивы квантовых точек с заданными параметрами. Было выяснено, что при последовательном нанесении с помощью МПЭ монослоёв InAs и GaAs на подложку GaAs с индексами Миллера {100} и {311} на начальной стадии роста (толщина слоя 1–3 ML) формировались псевдопериодические массивы «квантовых проводов» арсенида индия. Увеличение времени прерывания после каждого цикла роста (2 ML) приводит к образованию квантовых точек, расположенных в двумерной квадратной решётке [26].
Следует подчеркнуть, что правильный выбор грани кристалла во многом определяет качество конечной гетероструктуры массива квантовых точек. В качестве иллюстрации зависимости структуры КТ от ориентации граней подложки на рис. 5 показаны формы самоорганизованных КТ InAs, полученные на разных кристаллографических гранях [27].
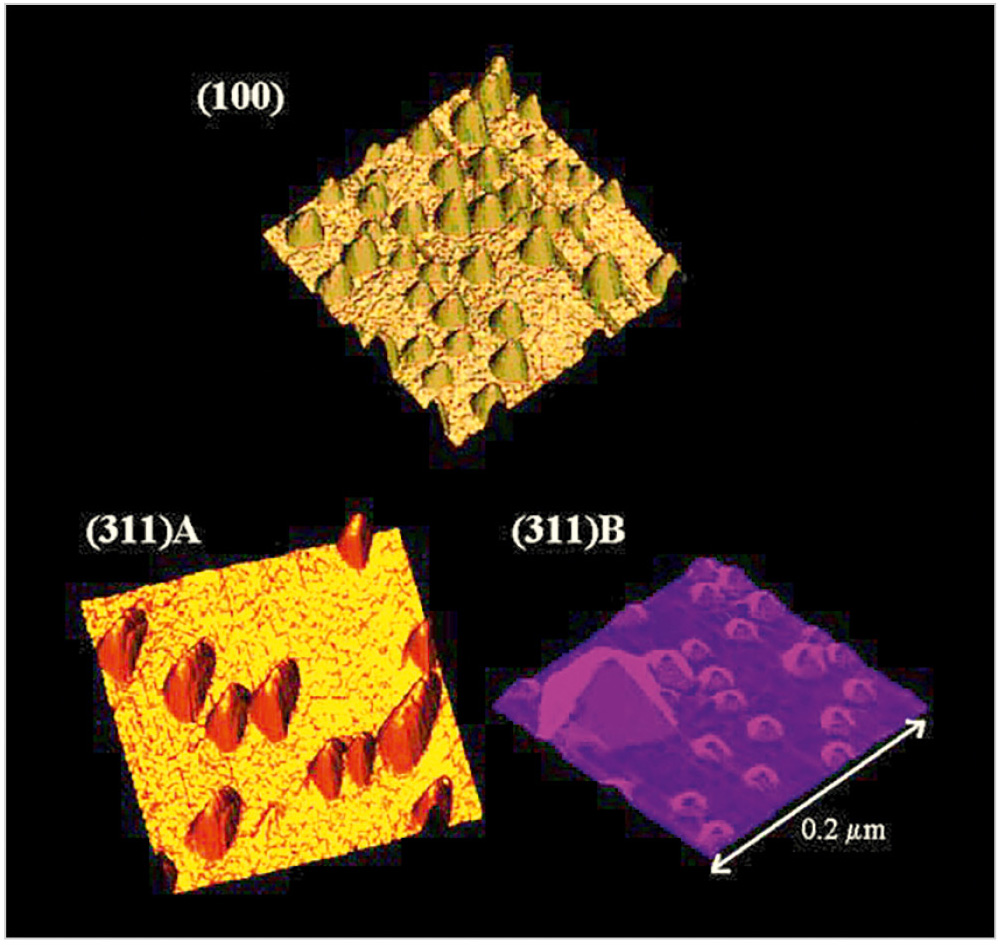
Квантовые точки, выращенные на гранях GaAs {100}, имели куполообразную форму. При этом КТ, выращенные на гранях {311A} и {311B}, выглядели в форме наконечника стрелы и пирамиды соответственно.
В статье [28] проанализирована энергетика массива трёхмерных когерентных напряжённых островов на подложке с несоответствующей кристаллической решеткой. Авторы показали, что на поверхности {001} кубического кристалла полная энергия минимальна для 2D периодической квадратной решётки с примитивными векторами решётки вдоль «мягких» направлений {100} и {010}. Подчёркивается тот факт, что эти свойства характерны для устойчивых массивов островков.
В работе [29] показано, что энергия 3D массива когерентных напряжённых островков, образовавшихся на несогласованной решётке кристалла подложки, обусловлена суммой следующих энергетических фрагментов: объёмная упругая энергия релаксации; изменение энергии системы, вызванное образованием островков; дополнительная энергия, инициированная деформацией поверхности кристалла; влияние граней островков на изменение упругой энергии релаксации; энергия упругого взаимодействия между соседними островками. Такой подход позволяет установить зависимость размеров островков от вклада каждой из составляющих, которые, в свою очередь, определяются условиями синтеза массива квантовых точек. При этом характерный размер островков является функцией, определяемой минимумом полной энергии массива 3D островков.

На рис. 6 показана зависимость энергии хаотического массива 3D напряжённых островков от их размера. На этом рисунке параметр α определяет отношение поверхностной энергии к энергии, обусловленной краевыми эффектами на границе КТ. Если поверхностная составляющая энергии больше энергии краевых эффектов, формирующих КТ (параметр α > 1), то вся система, следуя законам термодинамики, стремится к сращиванию островков. Когда α < 1, формируются островки оптимальной с энергетической точки зрения формы и размеров. При этом отмеченная выше энергетическая компонента, определяющая взаимодействие островков с кристаллической структурой подложки, стимулирует образование квадратной решётки массива КТ.
Следует отметить, что большинство упрощённых теоретических моделей рассматривают массивы КТ как однородную среду, в которой операция усиления определяется обобщённой «материальной КТ», а также такими факторами, как заполнение и захват носителей. При этом не учитываются электромагнитные взаимодействия между отдельными КТ. Более общий подход описывает массивы КТ как композит квантовых точек. В таких моделях взаимодействие электромагнитных полей с анизотропными КТ или анизотропными решётками КТ вызывает такие процессы, как, например, расщепление мод для одного и того же экситонного перехода КТ. Наряду с этим максимальное усиление в основном зависит от относительного расположения квантовых точек в массиве в сравнении с параметрами световой волны в кристалле [30].
Детальный разбор этих моделей с погружением в сложнейшую интерпретационную математику, используемую в квантовой механике, выходит за рамки этой статьи. Выделим только один из наиболее важных выводов, вытекающих из этих работ. Было доказано, что с теоретической точки зрения нет никаких препятствий для создания полупроводникового инжекционного лазера на квантовых точках (Quantum Dot’s Laser – QDL). Поскольку волновая функция основного состояния полностью локализована внутри самой квантовой точки, то теоретически возможной становится реализация на практике инжекционного лазера QDL со сверхвысокими значениями «удельного усиления».
Инжекционные лазеры с вертикально связанными квантовыми точками – VCQD
Предварительные лабораторные исследования группы Алфёрова показали, что лазерам на квантовых точках (QDL) свойственна низкая, но при этом крайне стабильная пороговая плотность тока – около 40 А/см2 при криогенных температурах и примерно 62 А/см2 при комнатной температуре. Для QDL характерны большие значения внутренней квантовой эффективности (80%), а также параметры удельного и дифференциального усиления, значительно превышающие аналогичные цифры для лазеров на квантовых ямах [31, 32].
В работе [33] было показано, что для лазеров на основе квантовых точек InAs/GaAs коэффициент усиления может достигать исключительно больших значений, вплоть до 6,8×104 см−1 при плотности тока 80 А/см2 (77К). Наряду с этим максимальное значение дифференциального усиления составило 2×10−12 см2 при 20 А/см2 (77К). Таким образом, дифференциальное усиление лазеров на квантовых точках может быть на 3 порядка выше по сравнению с лазерами на квантовых ямах.
Однако эксперименты показали, что в реальных образцах массивов гетероструктур на квантовых точках существовала сильная температурная зависимость пороговой плотности тока при комнатных температурах. В дополнение к этому выяснилось, что при температурах выше 150K наблюдалось заметное снижение усиления.
Решить эти проблемы удалось за счёт использования объёмных гетероструктур с вертикально связанными квантовыми точками (Vertically Coupled Quantum Dots – VCQD) [34, 35].
К концу 1990-х сложилась общепризнанная схема изготовления массивов вертикально связанных квантовых точек, которая представляла собой примерно одинаковые технологические последовательности операций, отличающиеся специфическими особенностями, обусловленными назначением конечных изделий. Обобщённая схема гетероструктуры на основе вертикального массива квантовых точек InGaAs показана на рис. 7 [36].
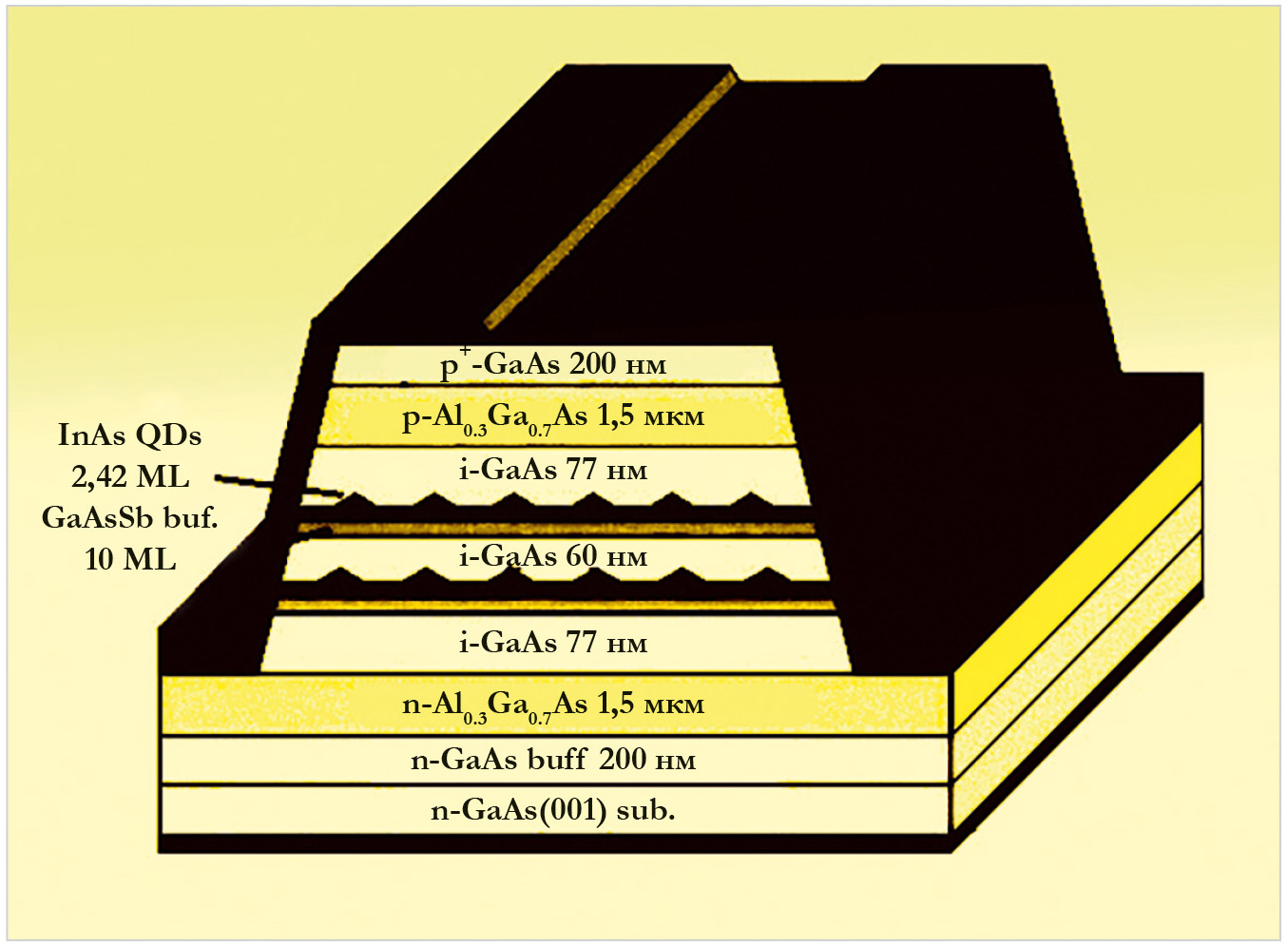
Ниже описана стандартная процедура получения массива квантовых точек InGaAs с помощью модифицированного метода «MBE – Stranski – Krastanow». Кроме того, используется метод «химического осаждения из паровой фазы металлоорганических соединений MOCVD», в котором рост кристаллов осуществляется не в высоком вакууме, как в MBE, а из парогазовой смеси пониженного или атмосферного давления (от 2 до 101 кПа).
На первом этапе на подложке GaAs формируется тонкий (1–2 ML) смачивающий слой InGaAs (Wetting Layer – WL). Процесс MBE проводится при больших температурах (400–600°C) в условиях сверхвысокого вакуума (вплоть до 10–8 Па).
По мере образования на подложке дополнительных слоёв мономолекулярных плёнок InGaAs благодаря несогласованным параметрам решёток нарастает деформация, что приводит к образованию островков нестабильности на поверхности смачивающего слоя (WL).
Обычно при толщине WL от 1,5 до 1,7 ML из-за релаксации деформации запускается механизм формирования 3D островков. В это же самое время атомы InAs стараются занять место на подложке, которое соответствует минимальным значениям поверхностной энергии в новой кристаллической решётке, образованной на границе контакта InGaAs/GaAs. При этом образовавшийся WL-слой остаётся под квантовыми точками после их формирования и может действовать в дальнейшем в качестве канала для доставки носителей заряда непосредственно в квантовые точки. Поскольку слишком большое значение может привести к плохому формированию точек, а слишком малое не обеспечивает адекватный транспорт носителей, на этом этапе необходим тщательный контроль за толщиной WL-слоя.
Дальнейший рост кристаллических структур может реализовываться за счёт следующих основных механизмов: поверхностная диффузия адсорбированных на поверхности кристалла атомов (адатомов); прямое осаждение и оствальдовское созревание. В то же время происходит формирование формы микрокристаллов. В итоге в случае InGaAs обычно образуются пирамидообразные квантовые точки с размерами основания около 10–15 нм и высотой примерно 4–8 нм. Параметры роста КТ можно контролировать с помощью температуры. Более высокие температуры увеличивают подвижность поверхности, что влияет на конечную форму, размер КТ и их расположение в кристаллической структуре. Помимо того, часто применяется контроль скорости осаждения. Более низкие скорости дают крупные и однородные квантовые точки. В то же время высокие скорости вызывают рост преимущественно мелких и многочисленных КТ. Также используются специальные дополнительные методы контроля роста КТ, такие как, например: изменение скорости напыляемого потока; соотношение ингредиентов (As/In); искусственные островки деформации; поверхностно-активные вещества; прерывание роста.
Прерывание процесса роста при достижении критической толщины формирует массив однородных квантовых точек InGaAs на подложке GaAs. Завершается процесс формирования КТ нанесением на них буферного барьерного слоя (Barrier Layers – BL). В качестве барьерного слоя, как правило, использовались либо GaAs, либо AlGaAs.
Так образуется первый слой квантовых точек InGaAs в виде усечённых пирамидообразных структур, окружённых общим барьерным слоем AlGaAs. Этот барьерный слой (Barrier Layers – BL) предназначен для нескольких целей. Во-первых, пара InGaAs-AlGaAs образует гетероструктуру двух полупроводников с разными запрещёнными зонами, которые для GaAs и AlAs составляют соответственно 1,42 эВ и 2,16 эВ.
Во-вторых, барьерный слой AlGaAs выполняет ряд важных служебных действий, таких, например, как:
- компенсирует несоответствие кристаллических решеток КТ и подложки;
- снимает и перераспределяет деформацию вокруг КТ;
- согласует рост нескольких слоёв квантовых точек и реализует вертикальную связь между ними;
- контролирует размер и форму точек, а также влияет на плотность и расположение КТ;
- создаёт тепловые барьеры и управляет теплопроводностью;
- поддерживает различные профили легирования.
Наиболее критичными для барьерного слоя параметрами, обеспечивающими перечисленные выше его функциональные качества, являются толщина слоя и состав полупроводника. Выбор материала полупроводника для барьерного слоя определяется конкретной задачей гетероструктуры. Толщина барьерного слоя должна быть достаточно большой для обеспечения функции ограничения и одновременно достаточно тонкой для эффективного туннелирования (10–50 нм).
Описанная схема может повторяться многократно. Следующий слой КТ напыляется на барьерный слой, закрывающий первый ряд матрицы. Таким образом, формируются вертикально связанные 3D массивы квантовых точек (Vertically Coupled Quantum Dots – VCQD).
Технологическим и теоретическим аспектам, связанным c VCQD, в лаборатории Алфёрова уделялось особое внимание. На эту тему есть множество публикаций. Ниже приведены только ссылки на те статьи, которые сам Жорес Алфёров считал важными и выделил их в своей Нобелевской речи [37].
Например, в статье [38] показано, как именно попеременное осаждение GaAs-InAs приводит к созданию вертикально разделённых пирамид. Это разделение обусловлено тем, что энергия деформации уменьшается из-за последовательного переноса InAs из заглублённой части пирамиды в её открытую часть. Полученная структура состоит из нескольких вертикально сливающихся частей InAs, представляющих собой упорядоченный массив КТ, вмонтированных в матрицу GaAs. Такие гетероструктуры демонстрируют инжекционную лазерную генерацию при очень низких плотностях тока.
В другой работе [39] исследовались спектры фотолюминесценции массивов вертикально связанных напряжённых квантовых точек InAs в матрице GaAs. Было продемонстрировано, что при повторном осаждении квантовых точек InAs в матрицах GaAs островки второго ряда формировались в точности над островками предыдущего ряда. Этот эффект можно было объяснить влиянием неоднородных полей напряжения, возникающих в результате формирования первого ряда точек, на темпы поверхностной миграции атомов Ga и In. Также было обнаружено, что повторное осаждение рядов КТ приводит к заметному сдвигу максимума линии фотолюминесценции в сторону меньших энергий по сравнению со случаем одиночного массива КТ (N = 1). За счёт замены несвязанных точек вертикально связанными массивами однородных КТ (Vertically Coupled Quantum Dots – VCQD) удалось заметно снизить потери, обусловленные оптическим ограничением, а также увеличить эффективность усиления.
Рассмотренная выше общая схема получения массива квантовых точек использовалась Алфёровым не только для создания массивов КТ на основе арсенида галлия, но также применялась и для разработок гетероструктур с другими соединениями группы A3B5.
Так, в статье [40] описаны результаты исследований массивов напряжённых наноразмерных кластеров двух типов: InP в матрице In0,49Ga0,51P на подложке GaAs {100} и InAs в матрице In0,53Ga0,47As на подложке InP {100}, полученных методом газофазной эпитаксии из металлорганических соединений. Было показано, что образующиеся наноразмерные кластеры имеют размеры 80 нм (InP/InGaP) и 25–60 нм (InAs/InGaAs). В спектрах фотолюминесценции полученных наноразмерных кластеров наблюдались полосы в диапазонах длин волн 0,66–0,72 и 1,66–1,91 мкм при 77K. При этом положение максимумов не изменялось с увеличением эффективной толщины InP и InAs. Полученные в экспериментах значения эффективности излучения наноразмерных кластеров InP значительно превосходили интенсивность излучения кластеров на основе InAs [41].
Аналогичные эксперименты были проведены с гетероструктурами GaAs, выращенными на поверхности GaN.
Исследованы особенности получения гетероструктур AlGaN/GaN методом ГФЭ, выращенных на подложках сапфира с ориентацией {0001}. Полученные гетероструктуры AlGaN/GaN обладали высокой подвижностью носителей в канале 1290 см2/(В·с) и концентрацией 1,2×1013 см−2 (при комнатной температуре). Проанализированы экспериментальные результаты зависимости влияния чистоты исходных компонентов на параметры синтезированных гетероструктур [42].
Накопленный опыт, разработанные теоретические основы и созданная экспериментальная база позволили Алфёрову с сотрудниками создать полупроводниковый инжекционный лазер на основе вертикально связанного массива квантовых точек InGa/GaAs (Vertically Coupled Quantum Dots – VCQDs), работавший в непрерывном режиме при комнатной температуре [43].
Для того чтобы понять основные принципы работы этого типа лазеров, рассмотрим сначала упрощённую схему лазера с вертикальным резонатором и поверхностным излучением (Vertical Cavity Surface Emitting Laser VCSEL), показанную на рис. 8 [44].
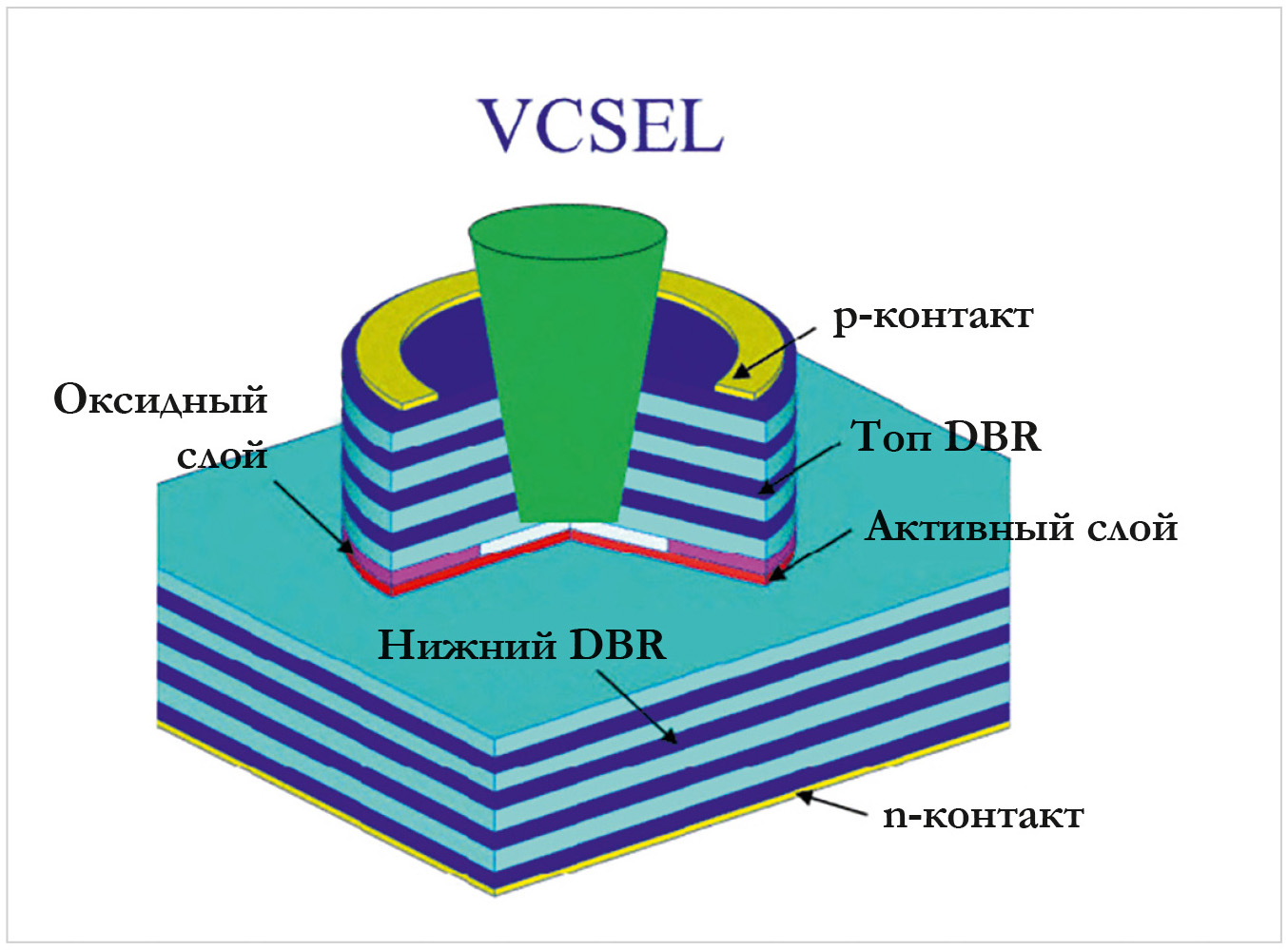
Фактически лазер VCSEL состоит из двух основных частей: активной зоны и резонатора. В активной зоне, состоящей из массива вертикально связанных квантовых точек VCQD, генерируется лазерное излучение. Резонатор, отражающий свет, выходящий из активной области обратно внутрь, выполнен по схеме распределённого брэгговского отражателя (Distributed Bragg Reflector – DBR).
В лазерах VCSEL свет излучается в направлении, перпендикулярном поверхности кристалла, в отличие от обычных конструкций лазеров, излучающих в плоскости, параллельной поверхности. При этом ось резонатора VCSEL перпендикулярна плоскости гетероструктуры, а размеры активной области обычно не превышают нескольких микрометров (ширина – высота – длина).
Отражатель DBR представляет собой слоистую структуру, состоящую из последовательности осаждённых друг на друга материалов с разными показателями преломления. Как правило, DBR изготовляются при помощи молекулярно-лучевой эпитаксии или химического осаждения из газовой фазы в том же самом технологическом процессе, в котором синтезируется активная гетероструктура на основе массива КТ.
Такие рефлекторы позволяют отражать свет с более узкой полосой отражения, чем обычные отполированные грани кристалла.
Слои DBR резонатора, выполняющие одновременно роль проводников тока, нанесены сверху и снизу непосредственно на излучающие поверхности.
Как правило, они сконструированы в виде чередующихся четвертьволновых (λ/4) слоёв с разными показателями преломления. Например, один слой DBR может быть изготовлен из GaAs, а другой из Al0,5Ga0,5As. Уместно отметить, что при использовании в конструкции DBR пятидесяти таких пар становится возможным получение коэффициента отражения больше, чем 0,999.
Конструкция DBR напоминает электролитический конденсатор. Оба DBR (верхний и нижний) состоят из слоёв одного типа проводимости. При этом они одновременно являются p- или n-эмиттерами.
Функцию волновода и корректора профиля показателя преломления может выполнять специально сконструированный барьерный слой.
Необходимо особо подчеркнуть, что в такой конструкции изолированная квантовая точка не может функционировать как микролазер типа ДГС. Понятно, что для достижения инверсии населённости нужен ток. Однако невозможно напрямую прикрепить электрические контакты к каждой из миллионов КТ, составляющих массив VCQD, и заставить их синхронно работать. Поэтому в лазерах VCSEL квантовая точка должна быть интегрирована в тщательно спроектированную структуру полупроводникового устройства, которая обеспечивает общие пути инжекции носителей во всём массиве. На рис. 8 квантовые точки активной зоны (Active Layer) встроены в общую структуру p-n-перехода. Прямое смещение, прикладываемое ко всей структуре устройства (контакты p, n), вызывает ток, который протекает через окружающий полупроводниковый материал. Барьерный слой, кроме разграничивающих функций, также формирует потенциальные ямы для электронов и дырок и определяет смещение зон для КТ. При этом носители захватываются квантовой точкой как непосредственно из барьерного слоя, показанного выше на рис. 7 (AlGaAs), так и с помощью туннелирования из соседних областей. Внутри КТ происходит релаксация носителей и их переход в основное состояние. Благодаря эффекту КРЭ фотоны, испускаемые при рекомбинации электронов и дырок, имеют дискретные энергии. Вместе с тем рефлекторы DBR, возвращающие свет обратно в активную зону, позволяют выделить очень узкую спектральную линию.
На этом этапе становится очень важной вертикальная связь между слоями квантовых точек. Носители, которые не захватываются одним слоем КТ, могут быть захвачены последующими слоями. Причём кроме прямого захвата из барьерного слоя носители могут туннелировать между соседними точками, а также захватываться с помощью фононов.
Поскольку квантовые точки встроены в оптическую полость (ОП), образованную зеркалами DBR, то все они взаимодействуют с одной и той же оптической модой. При этом в ОП формируется стоячая волна, которая обеспечивает общее резонансное поле, связанное со всеми КТ.
При достижении порогового напряжения лазера только КТ с энергиями перехода, соответствующими основной моде ОП, начинают излучать когерентно. В то же время в оптической полости создаются условия, необходимые для существования инверсии населённости, вызывающей вынужденное излучение с синхронизированными фазами испускаемых фотонов. Таким образом, реализуется «естественный отбор» КТ, участвующих в генерации когерентного лазерного излучения. Те квантовые точки, энергия которых не соответствует основной моде, практически не вносят вклад в когерентное излучение.
Ключевое отличие принципа работы лазера VCSEL от лазера с традиционной двойной гетероструктурой (ДГС) заключается в том, что вместо единой непрерывной среды усиления мы имеем массивы, состоящие из многочисленных дискретных центров усиления (КТ). Отмеченные выше свойства резонатора DBR и процесс стимулированного излучения заставляют эти дискретные излучатели (КТ) работать синхронно, вырабатывая коллективное когерентное излучение.
В таких VCSEL-лазерах максимальный коэффициент усиления (Квус) реализуется в направлении, перпендикулярном гетеропереходу. В то же время КГус в плоскости перехода сведён к минимуму. Этот эффект максимально реализуется при использовании гетероструктур на базе 3D массивов с вертикально связанными КТ (VCQD).
Важный элемент в вертикально-излучающих лазерах (ВИЛ), связанный с ограничением по току, получил название «токовая апертура» (Current Aperture – CU). На рис. 8 этот защитный элемент обозначен как «Oxide Layer». В современных ВИЛ, в которых используется субмиллиметровая модуляция, существует проблема ограничения порогового тока на частотах выше 10 ГГц. Наиболее распространённым решением этой технологической задачи является вариант токовой апертуры, изготовленной методом селективного окисления слоёв AlGaAs с высоким содержанием Al [45].
Следует отметить, что существует также другая проблема в современных ВИЛ, связанная с дифракцией света на высоких частотах. Для этого используется другой вариант коррекции: оптическая апертура (Optical Aperture).
Первая модель вертикально-излучающего лазера, разработанная группой Алфёрова, была предназначена для генерации когерентного излучения в инфракрасном (ИК) диапазоне (λ = 1–3 мкм) [43].
Гетероструктура VCQD этого лазера, выращенная методом МЛЭ, состояла из вертикально связанных слоёв квазипирамидальных КТ, образованных осаждениями InGаAs на подложках GaAs по описанной выше схеме (рис. 7). Эта структура содержала три слоя квантовых точек InGаAs со средней толщиной 1,2 нм, разделённых барьерным слоем GaAs (1,75 λ). Кроме того, в состав гетероструктуры были включены два распределённых брэгговских отражателя – РБО (DBR) на основе чередующихся слоёв AlGaAs толщиной λ/4 и разными показателями преломления. Плотность КТ в активном слое составляла 5×1011 см-2. Матрица из VCQD была размещена в центре DBR микрорезонатора. Граничные области активной зоны были легированы до 1017 см3 и 1018 см3 (p, n).
Этот лазер имел модовое расстояние Δλ в диапазоне примерно от 100 до 300 нм. Такое расстояние между модами позволяло лазеру излучать одиночную продольную моду при различных входных токах.
Благодаря тому, что в активной области используются тройные гетероструктуры, содержащие массивы квантовых точек, а направление излучения лазера перпендикулярно плоскости перехода, на небольшой площади оптической апертуры (100 мкм2) может быть получена высокая плотность излучателей. При этом эффективный показатель усиления этой среды превышал 104 см–1.
Эксперименты с различным количеством слоёв квантовых точек (N) показали, что увеличение их числа приводит к значительному снижению пороговой плотности тока (примерно 100 А/см2 при 300К для N = 10). Использование гетероструктур InGaAs/AlGaAs VCQD в сочетании с высокотемпературным ростом слоёв эмиттера и волновода приводит к дальнейшему снижению пороговой плотности тока (60–80 А/см2, 300К) и повышению внутренней квантовой эффективности (70%) [34].
В статье [46] исследовались различные варианты гетероструктуры с вертикальными оптическими резонаторами (ОР), имеющие активные области на базе массивов квантовых точек InAs, выращенные методом МПЭ на подложках GaAs. В качестве ОР использовались DBR на основе AlAs/GaAs (нижний) и SiO2/ZnS (верхний). Массивы InAs квантовых точек были помещены во внешнюю квантовую яму In0,3Ga0,7 шириной 4 нм.
Для получения гетероструктур была разработана поэтапная технология синтеза. Сначала методом МПЭ выращивалось нижнее зеркало на основе нелегированной структуры AlAs/GaAs с толщинами слоёв λ/4. При этом контролировалось формирование скрытых контактных слоёв (p, n) внутри активного слоя ОР. После выращивания зеркала структура вынималась из камеры и проводились измерения спектров отражения и других параметров. Затем нижний ОР разделялся на отдельные образцы, на которых выращивались различные варианты активных слоёв. Для предотвращения окисления AlAs все структурные слои покрывались слоем GaAs толщиной (λ/4).
Полученные результаты зависимости спектров отражения и фотолюминесценции от различных комбинаций компонентов структуры активной области и оптических резонаторов позволили утверждать, что разработанная технология потенциально пригодна для создания вертикальных излучателей и резонансных фотоприёмников диапазона длин волн в районе 1,3 мкм на подложках арсенида галлия.
Было показано, что конструкция гетероструктур, в которых массивы квантовых точек InAs размещены во внешней напряжённой квантовой яме InGaAs, позволяет значительно расширить длинноволновый предел излучения в структурах, выращенных методом МПЭ на подложках арсенида галлия.
В следующей модели вертикального резонансного поверхностно-излучающего лазера, излучающего на длине волны 1,3 мм, разработанной группой Алфёрова [47], в качестве материала матрицы использовались несколько иные составы активного и буферного слоёв, позволившие значительно снизить пороговое значение плотности тока в исследуемых образах.
Структурная схема этого VCSEL-лазера, разработанная группой Алфёрова, показана на рис. 9.
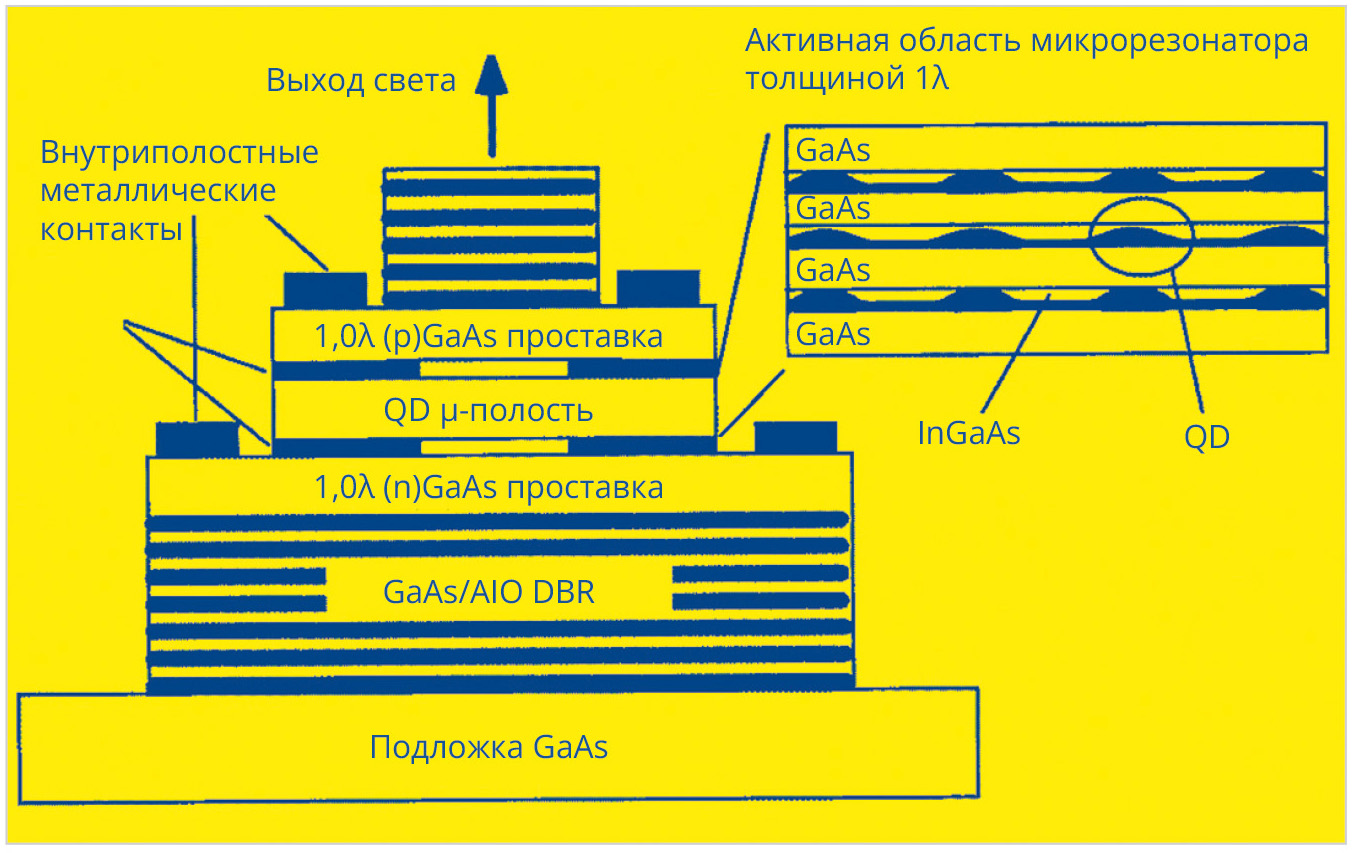
Гетероструктура лазера была выращена на подложке GaAs (substrate) методом МЛЭ. Верхний и нижний резонаторы Брэгга (DBR) состоят из чередующихся слоёв GaAs, AlO толщиной λ\4. В центре структуры размещена активная область, содержащая три слоя массивов пирамидообразных квантовых точек In0,15Ga0,85As. Толщина каждого слоя составляла 5 нм. Слои квантовых точек разделены между собой барьерным слоем GaAs толщиной 25 нм.
Границы активной области лигированы до величин 1017 см–3 и 1018 см–3 соответственно для (n) и (p) областей. Плотность КТ внутри слоёв составляла приблизительно 5×1010 на квадратный сантиметр. При этом волновые функции носителей заряда не перекрываются ни в поперечном, ни в вертикальном направлениях. Напряжение смещения подаётся через распределённые контакты 1,0 λ (n) GaAs и 1,0 λ (p) GaAs.
Во время синтеза всей гетероструктуры были окислены соответствующие слои AlAs, образующие токовую апертуру.
Лабораторный образец VCSEL-лазера тестировался с использованием источника тока, работавшего в импульсном режиме с пакетами 100 наносекундных импульсов с периодом от 1 до 10 мкс.
Исследовалось излучение в районе 1,3 мкм. Разброс от пиковой длины волны излучения составил около 10%. Авторы объяснили это некоторыми недостатками технологии синтеза, такими, например, как отсутствие вращения подложки во время роста структуры. Эти и другие технические ошибки могли привести к неоднородности параметров квантовых точек в структуре массива.
Сравнение экспериментальных данных с теоретическими оценками позволило утверждать, что в процессе генерации когерентного излучения важную роль играет переход основного состояния экситона КТ.
Эта работа группы Алфёрова имела очень большое значение для дальнейшего развития миниатюрных транзисторных лазеров. Во-первых, была подтверждена корректность направления развития миниатюрных транзисторных лазеров, связанная с самой идей VCSEL. Во-вторых, были выявлены недостатки этих первых моделей и намечены пути их устранения. Было отмечено, что значительное улучшение производительности такого типа лазеров может быть достигнуто за счёт увеличения количества слоёв КТ, выращенных с уменьшенной толщиной разделительного слоя и уменьшенным размером микрорезонатора. Кроме того, необходимо было модернизировать токовую апертуру и внутрирезонаторные распределённые контакты [48].
Рассмотренные в этой статье (части 1, 2, 3, 4) научные работы Жореса Алфёрова явились основанием для присуждения ему в 2000 году Нобелевской премии за выдающийся вклад в разработку полупроводниковых гетероструктур и создание на их основе микроэлектронных компонентов.
Необходимо отметить, что ещё в течение двадцати лет после получения Нобелевской премии Жорес Алфёров продолжал активно работать в этой области и написал ещё много статей, рассмотрение которых, возможно, будет продолжено в следующих номерах журнала.
Достаточно сказать, что гетерогенные структуры и изготовленные на их основе лазеры, разработанные Алфёровым, используются сегодня повсеместно в смартфонах, телевизорах, медицинском оборудовании, CD-проигрывателях, прожекторах, автомобильных фарах, детских игрушках и другом оборудовании.
Наибольшее распространение получили лазеры VCSEL, которые применяются как для оптической накачки волоконно-оптических лазеров (ВОЛ), так и в других приложениях, таких, например, как лазерная абсорбционная спектроскопия, рубидиевая спектроскопия, оптические часы и т.д. Общие схемы этих устройств фактически не отличаются от структуры, предложенной Алфёровым в 2000 году (рис. 9). В то же время современные технологии позволили наладить массовое производство миниатюрных и сравнительно недорогих VCSEL-лазеров.
Модель PL-0850-1-A81 (TO-46), показанная на рис. 10, представляет собой вертикально излучающий лазер на основе GaAsP/AlGaAs, выращенный с помощью технологии MOVPE [49].

Лазер предназначен для одномодового излучения на длине волны 850 нм. Он имеет термоэлектрический охладитель, термистор и защиту от электростатики. Лазер размещён в стандартном корпусе (T-O5) с габаритными размерами D = 4,7 мм, h = 3,75 мм.
Благодаря внедрению VCSEL в системы сетей передачи данных Gigabit и 10 Gigabit Ethernet в последние годы значительно увеличился спрос на высокоскоростные модули на основе поверхностно излучающих лазеров с вертикальным резонатором.
Ожидается, что мировой рынок волоконно-оптических лазеров вырастет с 4,22 млрд долларов США в 2023 году до 8,41 млрд долларов США к 2030 году [50].
Литература
- Ekimov A.I. et al. Quantum size effect in semiconductor microcrystals. Solid State Communications, Volume 56, Issue 11, Pages 921–924, 1985. URL: https://www.sciencedirect.com/science/article/pii/S0038109885800259?via%3Dihub.
- Brus L.E. Chemical Quantum Dots in Bell Laboratories, Accounts of Chemical Research, 2024. URL: http://www.columbia.edu/cu/chemistry/fac-bios/brus/group/pdf-files/brus-2024-chemical-quantum-dots-i....
- Brus L.E. A simple model for the ionization potential, electron affinity, and aqueous redox potentials of small semiconductor crystallites. The Journal of Chemical Physics, Volume 79, Issue 11, 5566–5571, 1983. URL: https://doi.org/10.1063/1.445676.
- Brus L.E. et al. Size effects in the excited electronic states of small colloidal CdS crystallites. The Journal of Chemical Physics, Volume 80, Issue 9, 1984. URL: https://doi.org/10.1063/1.447228.
- Brus L.E. Electron–electron and electron-hole interactions in small semiconductor crystallites: The size dependence of the lowest excited electronic state. J. Chem. Phys. 80, 4403, 1984. URL: http://dx.doi.org/10.1063/1.447218.
- Bawendi M.G. (CdSe)ZnS Core−Shell Quantum Dots: Synthesis and Characterization of a Size Series of Highly Luminescent Nanocrystallites. The Journal of Physical Chemistry, B, Vol 101/Issue 46, 1997. URL: https://pubs.acs.org/doi/10.1021/jp971091y.
- Алексеев В. Открытие квантовых точек и разработка технологии их массового производства // СОЭЛ. 2024. № 2. URL: https://www.cta.ru/articles/soel/2024/2024-2/178209/.
- Jing Liu, Peilin Liu, Dengyang Chen, et al. A near-infrared colloidal quantum dot imager with monolithically integrated readout circuitry. Nature Electronics volume 5, pages 443–451 (2022). URL: https://www.nature.com/articles/s41928-022-00779-x.
- Yun-Ran Wang, Im Sik Han and Mark Hopkinson. Fabrication of quantum dot and ring arrays by direct laser interference patterning for nanophotonics. Nanophotonics 2023; 12(8): 1469–1479. URL: https://doi.org/10.1515/nanoph-2022-0584.
- Nötzel R. et al. Self-Organized Quantum Dots. Semiconductor Science and Technology, Europhysics News, 1996. URL: https://www.researchgate.net/publication/256349094_Self-organized_growth_of_quantum-dot_structures.
- Stranski N. & Krastanow L. Zur Theorie der orientierten Ausscheidung von Ionenkristallen aufeinander. Monatshefte für Chemie und verwandte Teile anderer Wissenschaftenю. Volume 71, pages 351–364, (1937). URL: https://link.springer.com/article/10.1007/BF01798103.
- Алфёровский Университет. Лаборатория молекулярно-пучковой эпитаксии (МПЭ). URL: https://bit.ly/3OYmKQ2.
- Goldstein L. et al. Growth by molecular beam epitaxy and characterization of InAs/GaAs strained-layer superlattices. Appl. Phys. Lett. 47, 1099–1101 (1985). URL: https://doi.org/10.1063/1.96342.
- Leonard D. et al. Direct formation of quantum-sized dots from uniform coherent islands of InGaAs on GaAs surfaces. Appl. Phys. Lett. 63, 3203–3205 (1993). URL: https://doi.org/10.1063/1.110199.
- Leonard D. et al. Critical layer thickness for self-assembled InAs islands on GaAs. Phys. Rev. B 50, 11687. 1994. URL: https://doi.org/10.1103/PhysRevB.50.11687.
- Justin C. Norman, Richard P. Mirin, John E. Bowers. Quantum dot lasers—History and future prospects. J. Vac. Sci. Technol. A 39, 020802 (2021). URL: https://doi.org/10.1116/6.0000768.
- Алфёров Ж.И., Гарбузов Д.З., Денисов А.Г. и др. Квантово-размерные AlGaAs/GaAs – гетероструктуры со 100% квантовым выходом излучательной рекомбинации, полученные методом молекулярно-пучковой эпитаксии // Физика и техника полупроводников. 1988, т. 22, вып. 12. С. 2105–2110. URL: https://m.mathnet.ru/links/c938130182e16c44687e7c9c4ce22272/phts3145.pdf.
- Alferov Zh.I., Ledentsov N.N. et al. Proc. 22nd Inter. Conf. Phys. Semicond., Vancouver, Canada, August 1994, edited by D.J. Lockwood, Vol. 3, p. 1855. URL: https://www.nlb.gov.sg/main/book-detail?cmsuuid=f8348db5-1df1-491a-a26a-6096b1b103ac.
- Alferov Zh.I., Bimberg D., Ledentsov N.N. et. аl. Self-organization processes in MBE-grown quantum dot structures. Thin Solid Films 267, 32 (1995). URL: https://doi.org/10.1016/0040-6090(95)06597-0.
- Alferov Zh.I., Grundmann M., Ledentsov N.N. et al. Ultranarrow Luminescence Lines from Single Quantum Dots. Phys. Rev. Lett. 74, 4043 (1995). URL: https://journals.aps.org/prl/abstract/10.1103/PhysRevLett.74.4043.
- Alferov Zh.I., Grundmann M., Ledentsov N.N. et al. InAs/GaAs quantum dots radiative recombination from zero-dimensional states. Phys. Status Solidi B 188, 249 (1995). URL: https://doi.org/10.1002/pssb.2221880122.
- Alferov Zh.I., Ruvimov S.S. et al. Structural characterization of (In,Ga)As quantum dots in a GaAs matrix. Phys. Rev. B 51, 14766 (1995). URL: https://doi.org/10.1103/PhysRevB.51.14766.
- Alferov Zh.I., Zhukov A.E., Ustinov M. et al. Negative Characteristic Temperature of InGaAs Quantum Dot Injection Laser. Japanese Journal of Applied Physics. Volume 36, Number 6S, 4216. 1997. URL: https://iopscience.iop.org/article/10.1143/JJAP.36.4216.
- Alferov Zh.I., Ledentsov N.N. et al. Structural and optical properties of InAs–GaAs quantum dots subjected to high temperature annealing. Applied Physics Letters, volume 69, issue 20, pages 3072–3074. 1996. URL: https://colab.ws/articles/10.1063%2F1.116843.
- Алфёров Ж.И., Бимберг Д. и др. Напряжённые субмонослойные гетероструктуры и гетероструктуры с квантовыми точками. УФН, 165, 224 (1995). URL: https://ufn.ru/ru/articles/1995/2/h/.
- Ledentsov N.N., Cirlin G. et al. Ordering phenomena in InAs strained layer morphological transformation on GaAs (100) surface Appl. Phys. Lett. 67, 97 (1995). URL: https://doi.org/10.1063/1.115520.
- Henini M. Properties and applications of quantum dot heterostructures grown by molecular beam epitaxy. Nanoscale Res. Lett. 2006, 1, 32–45. URL: https://pmc.ncbi.nlm.nih.gov/articles/PMC3246631/.
- Ledentsov N.N., Shchukin V.A. et al. Spontaneous Ordering of Arrays of Coherent Strained. Phys. Rev. Lett. 75, 2968 (1995). URL: https://doi.org/10.1103/PhysRevLett.75.2968.
- Ledentsov N.N., Shchukin V.A., Grundmann M. et al. Strain-induced formation and tuning of ordered nanostructures on crystal surfaces. Surf. Sci. 352–354, 117 (1996). URL: https://doi.org/10.1016/0039-6028(95)01112-9.
- Alferov Zh.I., Slepyan G.Ya., Maksimenko S.A. et al. Polarization splitting of the gain band in quantum wire and quantum dot arrays. Phys. Rev. B, vol. 59, pp. 12275–12278, 1999. URL: https://journals.aps.org/prb/abstract/10.1103/PhysRevB.59.12275.
- Alferov Zh.I., Kirstaedter N., Ledentsov N.N. et al. Low threshold, large to injection laser emission from (InGa)As quantum dots. Electronics Letters, Volume 30, Issue 17. URL: https://doi.org/10.1049/el:19940939.
- Alferov Zh.I., Bimberg D., Kirstaedter N., Ledentsov N.N. et al. InGaAs-GaAs quantum-dot lasers. IEEE Journal of Selected Topics in Quant. Electron., Volume: 3 Issue: 2. 1997. URL: https://ieeexplore.ieee.org/document/605656.
- Alferov Zh.I., Kirstaedter N., Schmidt O.G. et al. Gain and differential gain of single layer InAs/GaAs quantum dot injection lasers. Appl. Phys. Lett. 69, 1226–1228 (1996). URL: https://doi.org/10.1063/1.117419.
- Alferov Zh.I., Ustinov V.M. et al. Low-threshold injection lasers based on vertically coupled quantum dots. Journal of Crystal Growth. Volumes 175–176, Part 2, Pages 689–695, 1997. URL: https://www.sciencedirect.com/science/article/abs/pii/S0022024896010214.
- Alferov Zh.I., Lott J.A., Ledentsov N.N. et al. Vertical cavity lasers based on vertically coupled quantum dot. Electronics Letters, 19th June 1997 Vol. 33 No. 73. URL: https://bit.ly/4goFF2y.
- Refining the quantum dot laser. Compound Semiconductor. URL: https://compoundsemiconductor.net/article/114186/Refining_the_quantum_dot_laser.
- Alferov Zh.I. Nobel Lecture: The double heterostructure concept and its applications in physics, electronics, and technology. Rev. Mod. Phys. 73 767 (2001) URL: https://journals.aps.org/rmp/pdf/10.1103/RevModPhys.73.767.
- Alferov Zh.I., Ledentsov N.N., Shchukin V.A. et al. Direct formation of vertically coupled quantum dots in Stranski-Krastanow growth. Phys. Rev. B, 1996, 54, (12), pp. 8743–8750. URL: https://journals.aps.org/prb/abstract/10.1103/PhysRevB.54.8743.
- Алфёров Ж.И., Цацульников А.Ф., Леденцов Н.Н. и др. Фотолюминесценция массивов вертикально связанных напряжённых квантовых точек InAs в матрице GaAs (100) // Физика и техника полупроводников. 1996. Вып. 10. С. 18–22. URL: http://journals.ioffe.ru/articles/18550.
- Алфёров Ж.И., Винокуров Д.А., Капитонов В.А. и др. Самоорганизующиеся наноразмерные кластеры InP в матрице InGaP/GaAs и InAs в матрице InGaAs/InP // Физика и техника полупроводников. 1999. Т. 33, вып. 7. URL: https://j.ioffe.ru/articles/viewPDF/35807.
- Алфёров Ж.И., Цацульников А.Ф., Бер Б.Я. и др. Исследование слоёв GaN, легированных атомами As, полученных методом газофазной эпитаксии из металлорганических соединений. Год 1999, вып. 7. С. 791. URL: http://journals.ioffe.ru/articles/35795.
- Алфёров Ж.И., Лундин В.В., Заварин Е.Е. и др. Гетероструктуры AlGaN/GaN с высокой подвижностью электронов, выращенные методом газофазной эпитаксии из металлорганических соединений // Физика и техника полупроводников. 2004. Т. 38, вып. 11. URL: https://journals.ioffe.ru/articles/viewPDF/5664.
- Alferov Zh.I., Lott J.A., Ledentsov N.N. et al. Vertical cavity lasers based on vertically coupled quantum dots. IET Electronics Letters, Volume 33, Issue 13, 1997. URL: https://www.academia.edu/101399945/Vertical_cavity_lasers_based_on_vertically_coupled_quantum_dots.
- Yixin Cao. Development of Vertical Cavity Surface Emitting Laser Modulation for Data Communication. Journal of Physics: Conference Series, 1653 012001, 2020. URL: https://iopscience.iop.org/article/10.1088/1742-6596/1653/1/012001.
- Леденцов Н.Н., Надточий А.М., Блохин С.А. и др. Способ уменьшения паразитной ёмкости ВИЛ с селективно окисленной апертурой // Письма в ЖТФ. 2012. Т. 38, вып 3.
- Алфёров Ж.И., Малеев Н.А. и др. Структуры InGaAs/GaAs с квантовыми точками в вертикальных оптических резонаторах для диапазона длин волн вблизи 1,3 мкм // Физика и техника полупроводников. 1999. Т. 33, вып. 5. URL: https://j.ioffe.ru/articles/35758.
- Alferov Zh.I., Lott J.A., Ledentsov N.N. et al. InAs-InGaAs quantum dot VCSELs on GaAs substrates emitting at 1.3 micro meter. Electronics Letters, 2000, Vol. 36 No. 16. URL: https://www.researchgate.net/publication/3382639_InAs-InGaAs_quantum_dot_VCSELs_on_GaAs_substrates_e....
- Alferov Zh.I., Ledentsov N., Grundmann M. et al. Quantum-Dot Heterostructure Lasers. IEEE Journal of Selected Topics in Quantum Electronics. 6(3): 439–451, 2000. URL: https://www.researchgate.net/publication/3409132_Quantum-dot_heterostructure_lasers.
- 850 nm Single Mode VCSEL Laser diode. LD-PD-INC. URL: https://lenlasers.ru/upload/iblock/667/5hkdxy6r07lbc4rv81juefy1s6x1arpu/850nm_Single_Mode_VCSEL.pdf.
- Exactitude Consultancy. URL: https://www.exactitudeconsultancy.com/ru/reports/32978/fiber-optic-lasers-market/.
© СТА-ПРЕСС, 2025
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!