Полупроводники с гомопереходами
В первой части статьи, опубликованной в журнале «Современная электроника» № 8, 2024, были рассмотрены основные принципы и этапы развития лазеров до начала 1960-х годов. Завершался первый этап разработок полупроводниковых инжекторных лазеров с одним прямым p-n-переходом (гомопереходом). Эти лазеры могли испускать стимулированное когерентное излучение в инфракрасной области спектра только при охлаждении жидким азотом (77К). При комнатной температуре они работали как обычные светодиоды, излучающие некогерентные, размытые пучки фотонов с длинами волн, близкими к красной области спектра.
Многочисленные попытки усовершенствования этих первых твердотельных лазеров выявили ряд непреодолимых на тот момент времени конструкторских и технологических барьеров, связанных, прежде всего, с неустойчивой инверсией населённости, а также с необходимостью охлаждения рабочего тела до криогенных температур, высокими порогами возбуждения, высокой расходимостью светового луча и низким КПД. Большинство теоретиков склонялось к мысли, что создание надёжного полупроводникового лазера в принципе невозможно.
Существовавшая в то время технология изготовления полупроводников была основана на том, что зоны акцепторного и донорного типов (p-зона и n-зона) изготавливались методом сильного легирования полупроводников, чаще всего на основе арсенида галлия. При этом собственные электрические свойства «материнского» полупроводника практически вытеснялись свойствами примеси. Арсенид-галлиевый p-n-переход получали стандартным методом с помощью диффузии цинка, легированного теллуром. Более подробно такие лазеры описаны в первой части статьи.
Такой тип перехода, образованного между двумя областями одного и того же полупроводникового материала, но с разными типами легирования (p-типа и n-типа), получил название «Homojunction» – гомопереход.
Упрощённая схема энергетических зон p-n-перехода GaAs, сильно легированного
с обеих сторон и смещённого в прямом направлении, показана на рис. 1
[1].
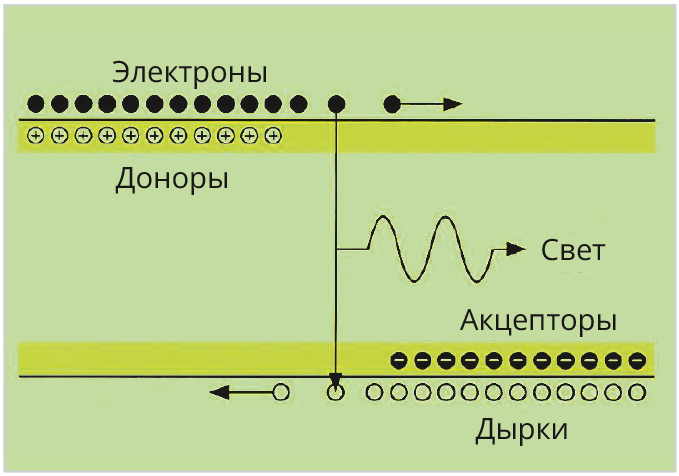
При этом их рекомбинация вызывает некогерентное (спонтанное) излучение.
В случае недостаточного смещения электроны диффундируют со стороны n-типа на сторону p-типа, а дырки – в противоположном направлении.
Для того чтобы получить инициированное когерентное излучение, характерное для лазера, необходимо достичь инверсии населённости, которая возможна только в том случае, когда прямое смещение больше, чем ширина запрещённой зоны. Однако с помощью схемы, показанной на рис. 1, инверсию населённости трудно достичь в обычном p-n гомопереходе. Даже при вырожденном легировании как электроны, так и дырки будут быстро диффундировать из активной области в соседнюю противоположно легированную область, предотвращая условие возникновения инверсии населённости (более подробно этот вопрос рассмотрен в первой части статьи).
Полупроводниковые широкозонные транзисторы
В 1956 году будущий нобелевский лауреат Уильям Брэдфорд Шокли (William Bradford Shockley) впервые предложил использовать в транзисторах переход на базе широкозонного эмиттера (Wide-Gap Emitter), что позволяло обеспечить однонаправленную инжекцию носителей заряда и управлять потоком электронов или дырок в одном направлении [2].
Термин «широкозонный эмиттер» относится к полупроводникам с большей запрещённой зоной, определяющей разницу энергий между валентной зоной и зоной проводимости.
Уильям Шокли показал, что в случае транзисторов большая запрещённая зона создаёт энергетический барьер, который позволяет носителям заряда легко течь от эмиттера к базе, но затрудняет их перемещение в обратном направлении. Такой подход позволил создавать условия для однонаправленной инжекции и снижать нежелательную рекомбинацию.
Значительный вклад в развитие полупроводниковых широкозонных структур внёс немецкий физик-теоретик Герберт Крёмер (Herbert Kroemer), разделивший в 2000 году Нобелевскую премию с Жоресом Алфёровым. В то время как Шокли предложил только общую концепцию широкозонного эмиттера, Крёмер разработал обобщённую теоретическую модель, описывающую подобные вопросы. В настоящее время трудно сказать, кто первый ввёл термин «полупроводниковая гетероструктура». Однако этот термин стали широко использовать, именно ссылаясь на работы Крёмера [3, 4].
На сегодняшний день наиболее общими являются следующие понятия. Полупроводниковая гетероструктура – это выращенная на подложке структура, состоящая из слоёв различных полупроводников, которые различаются шириной запрещённой зоны или сродством к электрону. Гетеропереход – это тонкая граничная область между двумя полупроводниками в гетероструктуре. Важно понимать, что гетеропереход не является простым, чисто механическим контактом двух разных полупроводников.
Герберт Крёмер ввёл понятие градиентного гетероперехода, обусловливавшего постепенное изменение энергии и ширины запрещённой зоны. Крёмер также предложил концепцию встроенных квазиэлектрических полей в градиентной области гетероперехода, которые усиливают движение носителей в одном направлении. Благодаря этим полям на краях гетероперехода существуют области (Graded Heterojunction) с размерами порядка десятков нанометров, в которых переход от свойств одного полупроводника к свойствам другого меняются постепенно, а не резким скачком.
При этом постепенное изменение полупроводниковых свойств приводит к изменению также и зонной структуры, что обеспечивает плавный переход на краях зоны проводимости и валентной зоны. Кроме того, плавный переход может уменьшить количество состояний интерфейса, действующих как центры безызлучательной рекомбинации, а также постепенное изменение структуры зоны может способствовать плавному транспорту носителей заряда через переход.
Как было отмечено в первой части статьи, разработки твердотельных полупроводниковых инжекционных лазеров к началу 1960-х практически натолкнулись на своеобразный барьер, непреодолимый с точки зрения существующих на тот момент времени технологий. Прежде всего, известные схемы лазеров и доступные полупроводники не позволяли создать зону инверсной заселённости, необходимую для возникновения стимулированного когерентного излучения.
Выход из сложившейся ситуации предложили в 1963 году практически одновременно и независимо друг от друга российские и американские физики.
В СССР сотрудники Ленинградского Физико-Технического Института Жорес Алфёров и Рудольф Казаринов сформулировали и запатентовали концепцию полупроводниковых лазеров на основе двойной гетероструктуры. В описании идеи патента они особо указали на то, что лазеры на гомопереходах не обеспечивают непрерывного режима генерации при высоких температурах. Вместо схемы с гомопереходом на основе вырожденных полупроводников (рис. 1) Алфёров и Казаринов предложили лазер с комбинированной полупроводниковой структурой, в которой активный полупроводник с узкой запрещённой зоной был размещён между двумя проводниками с более широкой запрещённой зоной. Забегая вперед, отметим, что толщина этого активного слоя составляет десятки-сотни нанометров.
Эта конструкция, напоминающая вафлю, предотвращала «утекание» из инверсной зоны как электронов, так и дырок с помощью внешних обкладок.
Напомним, что классическое определение гетероперехода (Heterojunction) означает интерфейс между двумя различными полупроводниковыми материалами с разной шириной запрещённой зоны.
Таким образом, в патенте Алфёрова и Казаринова два гетероперехода, ограничивающие тонкий полупроводниковый слой с меньшей запрещённой зоной, позволяют за счёт электрической накачки создать между ними уровень инверсной населённости, обусловливающий стимулированное когерентное излучение.
Позже такая схема получила название «лазеры с двойной гетероструктурой» – Double Heterostructure, или Double Heterojunction DH.
Важно то, что схема с двумя гетероструктурами (ДГС) предполагает инжекцию носителей с обоих ограничивающих боковых слоёв, значительно увеличивая плотность носителей и инверсную заселённость. Необходимым условием реализации схемы с ДГС является то, что эта транзисторная структура должна представлять собой единое целое, в котором полупроводники выращены один на другом, а не просто механически склеены [5].
Удивительно то, что, не имея никакой возможности узнать об этой работе, американский физик-теоретик Герберт Крёмер (Herbert Kroemer) пришёл к точно такому же выводу, что и Жорес Алфёров. Весной 1963 года на семинаре в корпорации «Varian Associates» (Пало-Альто, Калифорния, США) доктор Сол Миллер сообщил, что, согласно мнению авторитетных экспертов, принципиально невозможно добиться устойчивой инверсии населённости при комнатной температуре, поскольку инжектированные носители слишком быстро диффундируют на противоположную сторону перехода. На это категорическое заявление Герберт Крёмер возразил, что теоретически это вполне возможно, если увеличить энергетический разрыв между инверсным слоем и внешними донорными зонами. Эту идею Крёмер изложил в статье, которую направил в журнал Applied Physics Letters. Однако доказательства Крёмера настолько отличались от общепризнанной точки зрения, что эта статья была отклонена редакцией на основании того, что «не представляет интереса с точки зрения прикладной физики». Поэтому Крёмер отправил свою статью в журнал Proceedings of the IEEE, где она была принята для публикации 12 декабря 1963 года [6].
Используя свои отмеченные выше разработки в области широкозонных транзисторов, Крёмер предложил свою собственную конструкцию инжекционных лазеров с гетерогенными переходами [7].
В августе 1963 года Герберт Крёмер подал заявку на патент для своей конструкции инжекционного гетеролазера [8].
На рис. 2 показана упрощённая структурная схема энергетических
уровней лазера с двойной гетероструктурой [6], наглядно объясняющая принцип работы
ДГС-лазера.
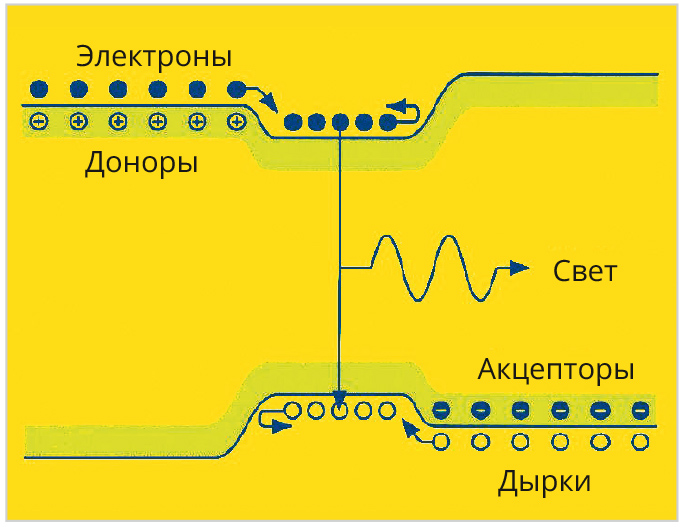
В гетеропереходе возникает повышенная концентрация носителей заряда, формирующая состояние, при котором электроны могут двигаться свободно только в двух направлениях. При этом движение носителей заряда в третьем направлении может регулироваться либо с помощью внешнего поля, либо за счёт уменьшения размеров полупроводника (квантово-размерный эффект – КРЭ).
При увеличении прямого смещения образуются потенциальные ямы как для электронов, так и для дырок. Ограничение носителей в двойной гетероструктуре связано с тем, что потенциальные барьеры препятствуют оттоку инжектированных электронов и дырок из инверсной области, не мешая при этом потоку основных носителей из областей инжектора.
При этом происходит накопление инжектированных носителей заряда до концентраций, сравнимых с вырожденными значениями.
Таким образом, создаются необходимые условия для возникновения состояния инверсной населённости, возбуждающего стимулированное лазерное излучение.
Нужно чётко понимать, что как патент Алфёрова, так и патент Крёмера представляли собой чисто теоретические разработки, не подкреплённые никакими собственными экспериментальными результатами.
Сравнивая вклады этих двух выдающихся учёных в теорию и практику развития направления полупроводниковых лазеров, следует подчеркнуть, что Герберт Крёмер, будучи блестящим физиком-теоретиком с огромным стажем работы в области полупроводниковых транзисторов, более подробно объяснил в своём патенте принципы работы инжекционного лазера с ДГС.
Однако Жорес Алфёров, обладавший реальным талантом экспериментатора и организатора науки, сумел много позже не только реализовать на практике эти идеи, но также и разработать технологии для массового производства ДГС-лазеров различных конструкций.
На рис. 3, взятом из первооткрывательской статьи Крёмера,
1963 [7], показана зонная диаграмма лазера с двойной гетероструктурой.
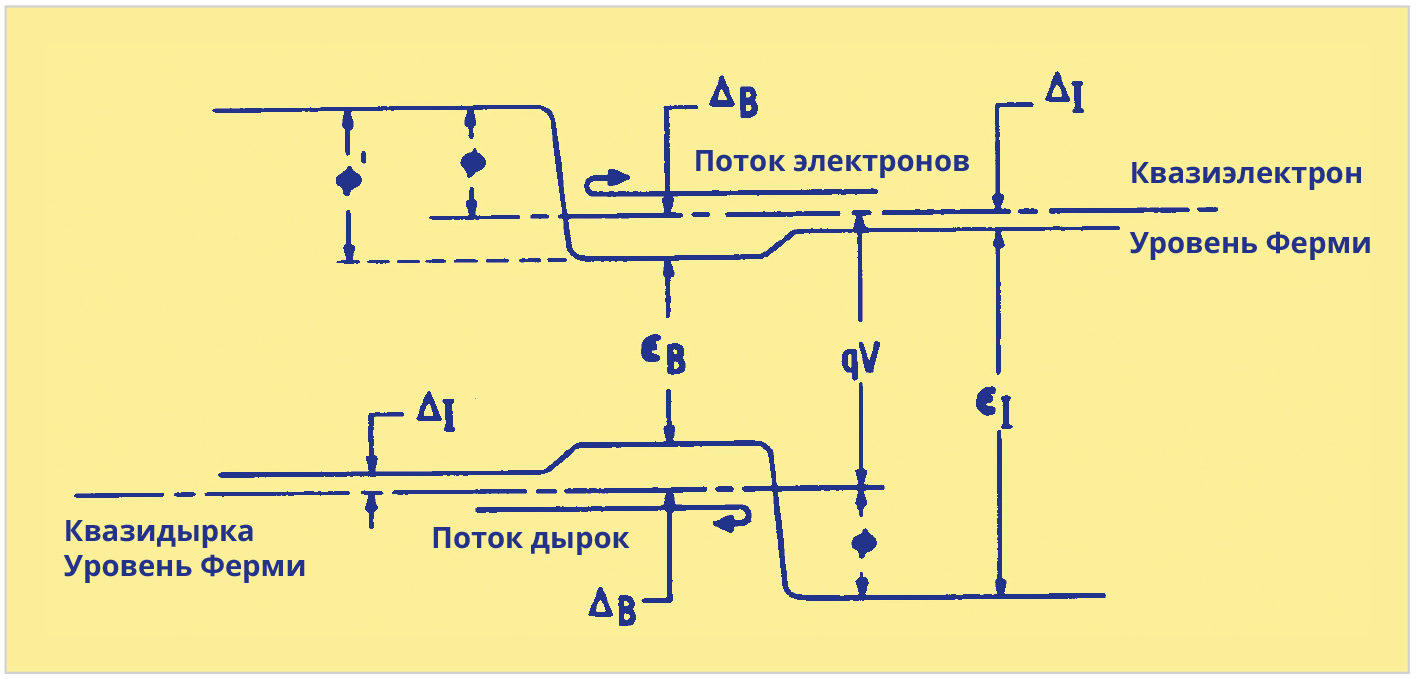
Электроны диффундируют из n-легированной области, а дырки, соответственно, из p-легированной. В активном слое они рекомбинируют и стараются вернуться в донорные зоны.
Характерной особенностью гетероперехода является наличие потенциальных ям, удерживающих электроны и дырки. В квантовой яме электроны, находящиеся в состоянии двумерного электронного газа (Two-Fimensional Electron Gas), ограничены в движении по одной из декартовых координат. Структура ямы определяется профилем зоны проводимости полупроводниковой структуры.
Вероятность того, что электрон может перейти на другой уровень с определённой энергией E, зависит от функции Ферми. Уровень Ферми (Fermi Level) расщепляется в активном слое благодаря инверсии. Для зоны проводимости и валентной зоны вводятся понятия квазиуровней Ферми, соответственно Fv и Fc. Электроны, находящиеся на уровне выше энергии Ферми, могут ускоряться электрическим полем, и длина их пробега позволяет покинуть активную область в том случае, когда прямое смещение меньше, чем ширина запрещённой зоны. Обкладки из полупроводника с более широкой запрещённой зоной возвращают эти электроны обратно в активную зону. Такое изменение приводит к появлению на стороне p-проводимости квазиэлектрического поля, отталкивающего электроны, а на стороне n-проводимости аналогичного квазиэлектрического барьера, отталкивающего дырки. Квазиэлектрические силы с обеих сторон начинают выдавливать как электроны, так и дырки в активную область. В результате концентрации электронов и дырок могут значительно превышать значения, соответствующие уровням легирования в контактных областях. В активной зоне, непосредственно примыкающей к p-n-переходу, реализуется инверсная заселённость, характеризующаяся тем, что энергетическое расстояние между квазиуровнями Ферми больше, чем ширина запрещённой зоны (Fv – Fc > Ɛg).
Приоритетная дата патента Жореса Алфёрова была зафиксирована как «30 марта 1963 года». Статья в журнале Proceedings of the IEEE, которая официально представила идеи Герберта Крёмера, была опубликована 12 декабря 1963 года, то есть на восемь месяцев позже патента Алфёрова. Поэтому формально изобретателями первой конструкции инжекционного полупроводникового лазера с двумя гетеропереходами типа ДГС считаются Жорес Алфёров и Рудольф Казаринов.
Хотя статья Герберта Крёмера была опубликована значительно позже даты официальной регистрации заявки на патент Жореса Алфёрова, о работах советских физиков Крёмер не знал, поскольку в начале 1960-х, во времена «железного занавеса», на Западе были практически недоступны любые публикации на русском. В основном западные учёные узнавали о работах советских физиков с задержкой в несколько лет из англоязычных обзоров. С другой стороны, учёные в СССР, печатавшиеся в основном в отечественных изданиях внутри страны, практически не имели реальной возможности публиковать свои статьи в иностранных журналах.
Несмотря на разницу в приоритетных датах, в 2000 году Нобелевская премия по физике в разделе «Фундаментальные работы в области информационных и коммуникационных технологий» была присуждена в соотношении 25% Жоресу Алфёрову и 25% Герберту Крёмеру за разработки в области гетерогенных лазеров (оставшиеся 50% получил Джек Килби за изобретение интегральной схемы).
Примечательно, что идея Жореса Алфёрова не была по достоинству оценена его коллегами. Они считали идею Алфёрова практически нереализуемой и называли «бумажным патентом». Такое отношение было отчасти вызвано тем, что в качестве примера реализации, который формально необходимо было указывать в заявке на изобретение, Алфёров указал фосфид галлия и сульфида кадмия в качестве эмиттеров, а селенид кадмия в качестве активного вещества. Достаточно быстро выяснилось, что эти соединения неустойчивы при комнатных температурах. Жоресу Алфёрову потребовалось максимально использовать свою целеустремленность, мужество и талант организатора, чтобы убедить администрацию Физтеха и своих молодых сотрудников продолжить работы в этом направлении [8].
Ещё более неприятная история произошла и с Гербертом Крёмером, которому было отказано в финансировании работ над новым типом лазеров с ДГС. В качестве основания для отказа американские научные чиновники использовали заключение «экспертов», заявивших о «бесперспективности реализации и невозможности практического использования данного изобретения». Поэтому Герберт Крёмер, фактически заложивший теоретические основы ДГС, в последующие десять лет был вынужден заниматься другими проблемами [6].
Устойчивые, согласованные полупроводниковые гетероструктуры для ДГС-лазеров
В целом изобретения Алфёрова и Крёмера указали путь для дальнейшего развития полупроводниковых лазеров. Однако для того, чтобы перейти от теоретической схемы к действующему макету гетерогенных лазеров, работающих при нормальных условиях окружающей среды, потребовались многие дальнейшие годы поисков эффективных комбинаций устойчивых полупроводниковых гетероструктур.
Вопрос соответствия кристаллических решеток в гетероструктурах является важнейшей концепцией в проектировании полупроводниковых приборов, особенно для лазеров и других оптоэлектронных приборов.
Напомним, что гетероструктура – это единое образование, а не просто механическое соединение разных полупроводников. Гетеропереходы образуются только тогда, когда слои полупроводников с разными запрещёнными зонами последовательно наращиваются один на другом.
При этом инверсный слой образуется в том случае, если два разных полупроводниковых материала имеют очень похожие параметры (постоянные) кристаллической решётки, определяемые размерами элементарной кристаллической ячейки кристалла. В литературе обычно приводят только среднюю длину рёбер ячейки и тип решётки.
Кроме того, не должно быть дефектов и деформаций на границе раздела между материалами. Крайне важное свойство, которым должны обладать структуры с гетеропереходами, – это сохранение всех своих параметров на протяжении по крайней мере десятков лет.
Таким образом, в начале 1960-х годов перед разработчиками стояла крайне сложная технологическая задача, решение которой многие считали вообще невозможным.
Кроме того, что многие из синтезированных образцов были просто нестабильны и разлагались на воздухе при комнатной температуре, не удавалось избавиться и от структурных дефектов. Например, дислокации несоответствия образовывались при снятии деформации в случаях, когда разница в значениях постоянных кристаллических решёток была слишком большой для конкретной пары полупроводников.
В ряде случаев структурные дефекты приводили к образованию центров безызлучательной рекомбинации, в которых электроны и дырки рекомбинировали без испускания света, что сильно снижало эффективность устройства.
Экспериментально было установлено, что для успешной работы гетероструктуры необходимо, чтобы процентная разница в параметрах решетки не превышала 0,1%. Это значительно продвинуло поиски нужного состава.
Выбор первого из компонентов гетероструктуры не вызывал сомнений. Ещё в 1962 году Андерсон описал гетеропереход в структуре Ge-GaAs [9].
За период с 1960 по 1963 гг. сразу несколько лабораторий показали примеры успешного использования арсенида галлия в лазерных диодах с p-n гомопереходом [10–12].
Этот химически стабильный прямозонный полупроводник (GaAs) имеет ширину запрещённой зоны 1,424 эВ и постоянную кристаллической решетки 0,56537 нм.
Оставалось найти второй полупроводник с близким параметром решётки и более широкой запрещённой зоной.
Идеальной гетеропарой, судя по параметрам, был непрямозонный полупроводник AlAs (арсенид алюминия) с шириной запрещённой зоны 2,15 эВ и постоянной решётки 0,56608 нм. Однако в свободном состоянии он реагирует с водой и с водяным паром с образованием гидроксида алюминия и арсина. Это обстоятельство насторожило Алфёрова, и его группа начала работать с гетероструктурой на основе GaAs/GaAsP.
Отметим, что среди прочих достижений в этот период группа Алфёрова разработала многокамерную установку ГФЭ, которая позволяла осаждать из газовой фазы сверхтонкие слои одного полупроводника на кристаллической подложке другого полупроводника. Данный метод давал возможность получать эпитаксиальные слои толщиной около десятков нанометров, которые упруго компенсировали возникающие деформации.
Идею, заложенную в патенте Алфёрова–Казаринова, удалось реализовать с помощью структуры ДГС, в которых внутренний слой «вафли» был изготовлен на основе GaAs, а внешние обкладки были сделаны на базе GaAsP. Изготовленный таким образом гетеролазер работал при криогенных температурах [13].
Вскоре выяснилось, что пара GaAs/GaAsP из-за несоответствия параметров решёток между двумя материалами делала эти лазеры поликристаллическими, что вызывало необходимость использования высоких пороговых плотностей тока.
Дальнейшие эксперименты с различными комбинациями состава Ga-As-Ga-As-P окончательно доказали, что структура GaAs/GaAsP не может быть использована для создания инверсной заселённости и стимулированного лазерного излучения при комнатных температурах и атмосферном давлении.
Так или иначе у группы Алфёрова обозначилась новая проблема – поиск второго компонента согласованной гетероструктуры.
Нужно сказать, что сам Жорес Алфёров не считал эти годы потерянными впустую. В обзорной статье, посвящённой периоду 1970-х, он, в частности, отметил, что исследования, проведённые с помощью модернизированного метода ГФЭ, позволили выявить крайне важный «эффект расщепления зоны проводимости за счёт одномерного периодического потенциала сверхрешётки».
Эти первые сверхрешётки (superlattices) являлись в то же время и первыми исследованными структурами с напряжёнными слоями [14].
В таких сверхрешётках напряжение решётки является дополнительной степенью свободы, позволяющей в процессе эпитаксиального роста изменять непрерывно и независимо друг от друга толщину слоя, параметры решётки и ширину запрещённой зоны [15].
Одной из первых, посвящённых эффекту «сверхрешёток», была работа Л. Эсаки (L Esaki) и Р. Цу (R Tsu) [16].
Упрощённо сверхрешётку можно представить как последовательность чередующихся слоёв более узкозонного и более широкозонного полупроводников, то есть последовательность квантовых ям. В сверхрешётке энергетические уровни в отдельных квантовых ямах образуют энергетические «минизоны», которыми можно управлять, меняя толщины барьеров. Фактически, следуя теминологии Л. Эсаки, сверхрешётка представляет собой одномерный кристалл, созданный человеком.
На рис. 4 показана упрощённая схема полупроводниковой сверхрешётки
[17].
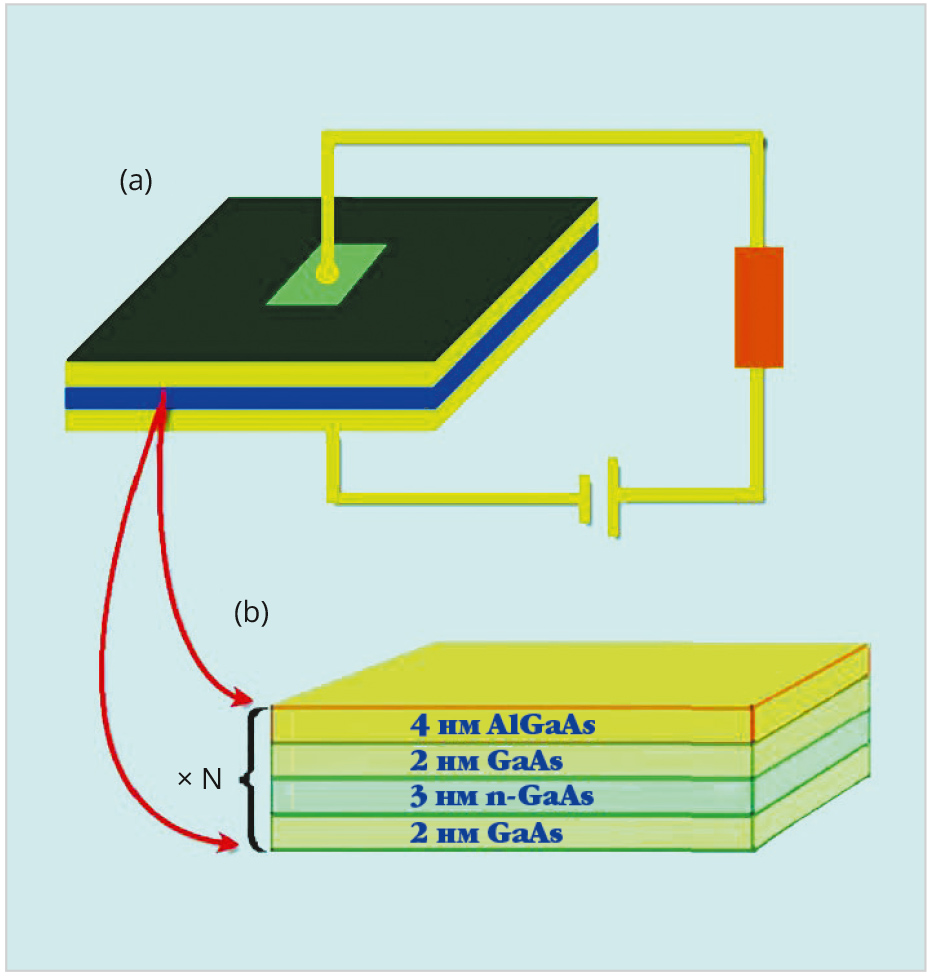
Внешнее напряжение приложено между контактами в верхней и нижней части устройства, состоящего из периодических структурных слоев GaAs/AlxGa1–xAs. Квантовые ямы GaAs (7 нм) разделены на три зоны для предотвращения диффузии легирования.
Теоретики из ФТИ имени А.Ф. Иоффе показали, что протекание тока в сверхрешётках определяется туннелированием под действием электрического поля через потенциальные барьеры, разделяющие квантовые ямы.
В случае, когда основное состояние одной ямы совпадает с возбуждённым состоянием следующей ямы, возможно возникновение стимулированного излучения при туннелировании оптически возбуждённых носителей из основного состояния одной ямы в возбуждённое состояние следующей, расположенной на более низком энергетическом уровне [18].
Более развёрнутые теоретические описания свойств полупроводниковых сверхрешёток можно найти, например, в работе [19].
Сегодня сверхрешётки с напряжёнными слоями образуют новый широко используемый класс полупроводниковых гетероструктур с настраиваемыми электронными свойствами.
Возвращаясь к вопросам оптимальной пары согласованных ДГС, нужно сказать, что их поиском занимались практически все ведущие лаборатории мира. Не вдаваясь в подробности приоритета, можно считать, что первой из наиболее известных стала статья Джерри Вудолла, Ганса Руппрехта и Джорджа Петита, опубликованная в 1967 году в журнале Applied Physics Letters, в которой были описаны разработанные в исследовательской лаборатории IBM эффективные светодиоды видимого света на основе Ga1–xAlxAs. При комнатной температуре измеренное значение внешней квантовой эффективности (External Quantum Efficiencies) составило 3,3%. Пик излучения диодов соответствовал 1,70 эВ. Измеренное время переключения для светового излучения при 300К составило 60 нс [20].
Нужно отметить, что Вудол и Руппрехт работали в IBM над проблемами создания эффективных солнечных батарей. В то время они не интересовались ДГС-лазерами, и тема их исследований не пересекалась с работами Алфёрова. Полученный ими сплав AlGaAs был предназначен для передачи максимального количества света из полупроводника с большой запрещённой зоной в p-n-переход полупроводника с запрещённой зоной меньшей ширины [21].
Считается, что именно счастливая случайность позволила независимо от американских физиков выбрать структуру Ga1–xAlxAs в качестве оптимального варианта согласованной пары ДГС на другом краю света, в Ленинградском Физтехе. Сотрудники ФТИ имени Иоффе Д. Третьяков и А. Борщевский обнаружили, что оставленные на хранение поликристаллические образцы твёрдого раствора AlGaAs, изготовленные два года назад, не изменили за это время своих свойств [22].
Дмитрий Третьяков и его коллеги из лаборатории Алфёрова установили, что критичный по отношению к парам воды в свободном виде арсенид алюминия абсолютно устойчив в форме твёрдого раствора: арсенид галлия – арсенид алюминия. Иначе говоря, AlAs становится стабильным при добавлении небольшого количества галлия. Оказалось, что в гетероструктурах можно также работать и с чистым AlAs, поскольку его тонкий слой, зажатый между двумя другими материалами, контактирует с воздухом только по очень тонкому краю и поэтому практически не разрушается в процессе эпитаксии [23].
На рис. 5 показаны структурные схемы и параметры кристаллических
решеток: a) GaAs; b) AlxGax–1As; c) AlAs соответственно
[24].

По существу, «согласованная гетероструктура» представляет собой кристалл, в котором меняется химический состав и, соответственно, физические свойства. В итоге получается новая кристаллическая моноструктура, обладающая совершенно иными качествами по сравнению с исходными компонентами.
Как видно из рис. 5, параметры кристаллической решетки всех трёх соединений практически совпадают: GaAs – 0,56537 нм; AlxGax–1As – 0,56604 нм и AlAs – 0,56608 нм.
Таким образом, благодаря соответствию структурных параметров кристаллической решетки можно было утверждать, что GaAs является идеальной подложкой для выращивания AlxGax–1As. Это позволило создавать гетероструктуры с хорошей кристаллической решёткой без дефектов и микронапряжений, которые обычно присутствуют на границе раздела полупроводников.
Спустя непродолжительное время после публикации этих результатов практически сразу в основных научных изданиях разработки новых ДГС-лазеров стали стремительно развиваться во всём мире.
Импульсные низкопороговые инжекционные лазеры на основе структур AlAs-GaAs
Основной целью разработчиков инжекционных полупроводниковых лазеров во всём мире, в том числе и в ФТИ имени Иоффе, в 1960–1970-е годы была борьба за снижение плотности порогового тока.
Накануне Нового года команда Алфёрова получила заслуженный приз: 30 декабря 1968 года редакция журнала «Физика и техника полупроводников – ФТП» зафиксировала поступление статьи Ж. Алфёрова и его коллег «Инжекционные лазеры на основе гетеропереходов в системе AlAs-GaAs с низким порогом генерации при комнатной температуре» [25].
В этой статье авторы сообщали о создании первого в мире полупроводникового лазера, работающего при комнатной температуре и имеющего плотность порогового тока Jпор = 4,3 кА/см2. Однако первые варианты лазеров этого типа, разработанные группой Алфёрова, могли работать только в импульсном режиме.
На рис. 6 приведены графики зависимостей интенсивности излучения
гетеролазера на основе AlAs-GaAs от длины волны при разных напряжениях смещения,
которые Ж. Алфёров привёл в своей Нобелевской
лекции [26].
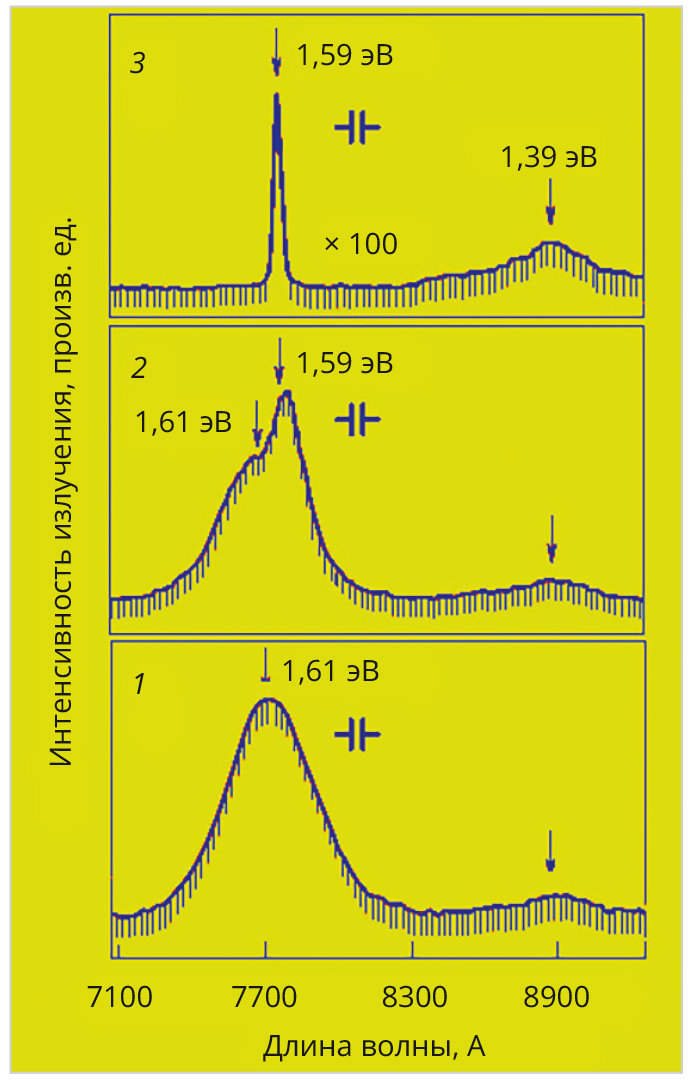
При температуре 300K пороговое значение тока составило 4,3 кА/см2, что было рекордным на момент подачи статьи в редакцию.
Диапазоны изменений значений тока составляли: 0,7…8,3 А (а); 8,3…13,6 А (б); 13,6…18 А (в).
После того как стали понятны основные пути дальнейшего развития ДГС-лазеров, группа Алфёрова стала быстро и успешно продвигаться в этом направлении. Во-первых, были получены экспериментальные данные, подтверждающие уникальные свойства широкозонных эмиттеров, эффект суперинжекции, принцип стимулированного излучения, а также зонную диаграмму гетероперехода в структуре AlxGa1–xAs-GaAsx [27].
Кроме того, были получены данные, позволившие объяснить природу диффузии носителей заряда и особенности протекания тока в плавном гетеропереходе. Так, например, была предложена конструкция ДГС-лазера, отличающаяся тем, что пассивные области, выполненные на основе твёрдых растворов структуры AlGalAs-GaAs, имеют плавно увеличивающееся содержание алюминия от активного слоя к эмиттерам [28].
Как и в любой физической лаборатории, ежедневная работа группы Алфёрова состояла в основном из кропотливых измерений различных параметров, обработки результатов и их интерпретации. Эти действия лишь иногда приводили к неординарным открытиям. Тем не менее в результате таких рутинных исследований порой обнаруживались крайне важные научные результаты. Так, например, было установлено, что такие параметры гетероструктуры, как толщина слоёв, уровень легирования и структура перехода могут оказывать заметное влияние на пороговый ток лазеров, что, в свою очередь, облегчает переход к режиму непрерывной работы.
Пороговый ток, определяющий минимальное значение, необходимое для начала генерации лазерного излучения, может быть снижен за счёт уменьшения толщины инверсного слоя, оптимизации уровня легирования во внешних обкладках GaAs и AlAs и увеличения количества квантовых ям.
С другой стороны, повышение температуры перехода может увеличить пороговый ток из-за увеличения термической рекомбинации носителей [29].
Опыт и возможности группы Алфёрова в исследованиях гетероструктур на основе элементов групп AIIIBV реализовались также в работах, связанных с поиском альтернативных кремнию материалов, предназначенных для импульсной силовой электроники.
По сравнению с кремнием GaAs обладает большей шириной запрещённой зоны и значительно большей подвижностью электронов.
По отношению к другим традиционным материалам компонентов силовой электроники, таких, например, как SiC и GaN, арсенид галлия имеет относительно высокую электрическую прочность и достаточно малые времена жизни носителей заряда. Немаловажным было то, что GaAs обладает также большей радиационной стойкостью.
Поэтому нужно также отметить успехи группы Алфёрова в этих направлениях. В 1968 году была принята заявка на изобретение способа изготовления полупроводниковых диодов на основе соединений AIIIBV [30].
В журнале «Физика и техника полупроводников» в 1969 году была опубликована статья с результатами разработки высокоэффективных светодиодов на одиночных и двойных гетероструктурах [31].
Тиристорные p-n-p-n-переключатели на гетеропереходах были описаны в статье [32].
На метод использования тройных твёрдых растворов на основе арсенида галлия для изготовления омических контактов полупроводниковых приборов была принята заявка на изобретение в 1970 году [33].
В этом же году был запатентован полупроводниковый фотоэлемент на основе гетероперехода GaAs-Al [34].
Тем временем конкуренты Алфёрова тоже уверенно шли вперед. В 1969 году Хаяши, Паниш и Сумски из Bell Telephone Laboratories опубликовали в апреле 1970 в журнале Applied Physics Letters статью о создании ДГС-лазеров на основе AlGaAs/GaAs с порогом всего 2300 А/см2 [35].
Новые ДГС-структуры, полученные методом ЖФЭ для инжекционных лазеров, работающих в непрерывном режимеепрерывном режиме
Поскольку газофазная эпитаксия имела ряд недостатков, основным из которых было соблюдение крайне строгого контроля температуры, давления и состава газовой смеси, многие лаборатории мира стали отказываться от ГФЭ. Поэтому начиная с конца 1960-х учёные, экспериментировавшие с новыми ДГС-структурами, стали постепенно переходить на метод жидкофазной эпитаксии (ЖФЭ), предложенный Х. Нельсоном (H. Nelson) в 1963 году [36].
Одним из реальных достижений группы Алфёрова была разработка модифицированного метода жидкостной эпитаксии, который был использован также в других лабораториях Физтеха. Разработанная в ФТИ методика была внедрена в нескольких научно-технических организациях СССР. Эта технология была проста в реализации, экономически эффективна и является до сих пор одной из основных для получения GaAs p-n-переходов [37].
Упрощённая схема метода жидкофазной эпитаксии (ЖФЭ) показана на рис.
7 [38].
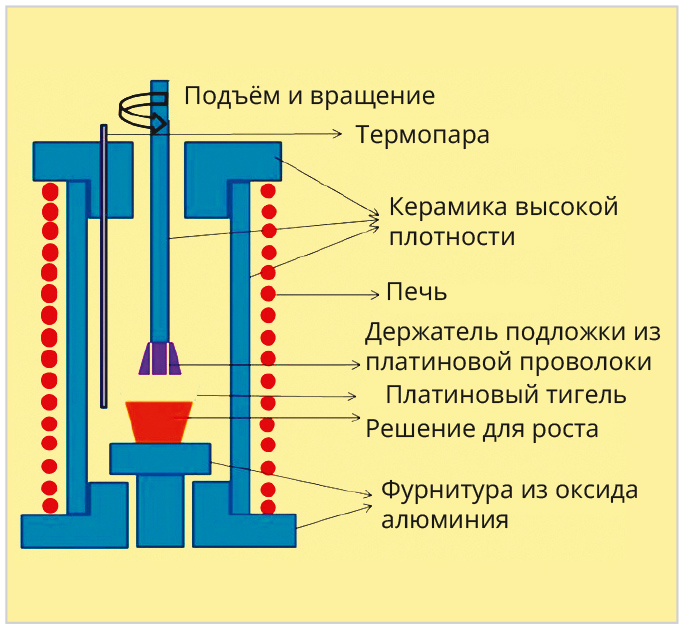
Метод жидкофазной эпитаксии (ЖФЭ) заключается в наращивании тонкого монокристаллического слоя из металлического расплава, насыщенного полупроводниковым материалом, на поверхности подложки.
Идея ЖФЭ заключается в том, что при контакте подложки с пересыщенным раствором полупроводника в легкоплавком растворителе (расплаве) при наступлении температурного равновесия подложки с твёрдым раствором из-за рекристаллизации целевого полупроводника происходит наращивание тонкой плёнки.
С помощью ЖФЭ можно изготавливать эпитаксиальные слои толщиной от долей до сотен микрометров, легировать эпитаксиальные слои, изготавливать многослойные эпитаксиальные гетероструктуры.
Процесс выращивания гетероструктур GaAs-AlGaAs ведётся в кварцевом реакторе в токе водорода. Продувка газом необходима для восстановления оксидных плёнок на поверхности подложек и расплава.
В графитовую лодочку помещают раздельно монокристаллическую пластину из GaAs и нарезку Ga с добавкой Al.
Затем включают нагрев, и расплав наносят на пластину. Рост слоёв структуры начинается при температуре кристаллизации 970 ±5°C. После чего осуществляют охлаждение расплава, в течение которого происходит кристаллизация твёрдых растворов. Оставшаяся часть галлия удаляется путём травления в соляной кислоте.
В методике, использованной группой Алфёрова, охлаждение и кристаллизация проводилась со скоростью 180°C/ч от 970°C до 870°C с последующим быстрым охлаждением со скоростью 2000°C/ч до комнатной температуры.
Эта описанная выше упрощённая схема описывает только основную лабораторную схему процесса. Современное оборудование ЖФЭ работает под управлением специального компьютера и не требует вмешательства оператора.
Использование модернизированного метода жидкофазной эпитаксии (МЖФЭ) позволило получить более качественные образцы с меньшим количеством дефектов, что способствовало улучшению оптических свойств и снижению порогового тока.
Использование контроля концентрации легирующих элементов и компонентов раствора в течение всего процесса МЖФЭ дало возможность изменять свойства получаемых слоев, таких как ширина запрещённой зоны и проводимость. Кроме того, контроль условий кристаллизации в жидкой фазе позволил избежать образования макрорельефа на поверхности и обеспечил более высокое качество эпитаксиальных слоев.
С помощью МЖФЭ была получена согласованная по кристаллическим решеткам структура ДГС для новой конструкции лазера, разработанная группой Алфёрова. Широкозонные эмиттеры n- и p-типа (твёрдые растворы AlxGa1–xAs) были легированы теллуром и германием.
С новой конструкцией ДГС-лазера группа Алфёрова добилась непрерывного режима работы. Статья с описанием результатов этой работы была отправлена в журнал «Физика и техника полупроводников – ФТП» в мае 1970 года.
На рис. 8, взятом из Нобелевской лекции Алфёрова, приведено
схематическое изображение структуры первого инжекционного ДГС-лазера, работающего
в непрерывном режиме при комнатной температуре [39].
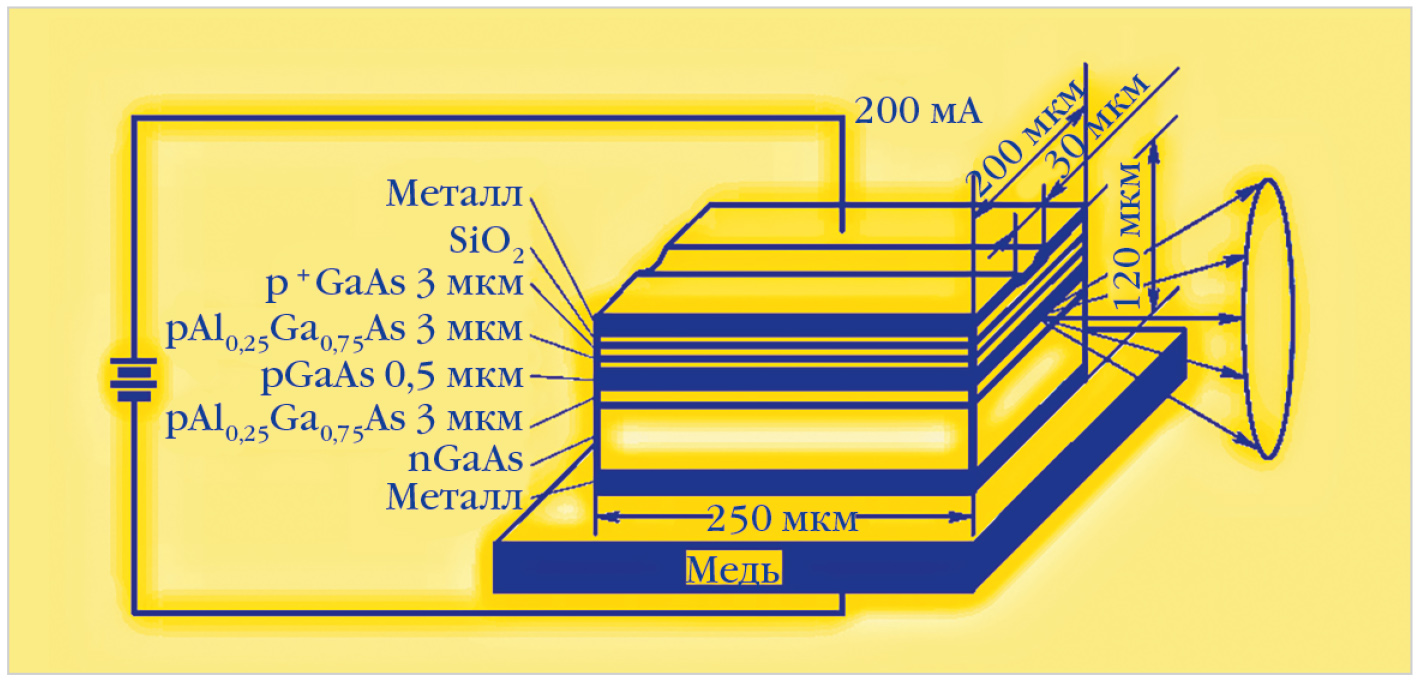
В конструкции ДГС-лазера на рис. 8 использована геометрия, в которой активная область размещена на медных теплоотводах, покрытых серебром. Такая геометрия позволяла эффективно отводить тепло из активной области. Эта идея использовалась в дальнейшем практически во всех ДГС-лазерах. В одном случае для отвода тепла использовались алмазные основания. В других вариантах активная область изготавливалась в виде узких полосок («полосковая геометрия»).
В этой конструкции усовершенствованный вариант гетеролазера на основе AlAs-GaAs работал в непрерывном режиме при 300К. Пороговая плотность тока при комнатных температурах находилась в диапазоне от 900 до 1000 А/см2 [40].
Следует отметить, что примерно в то же время группа Хаяши и Паниша смогла уменьшить пороговый ток до 1600 А/см2 и реализовать работу своего лазера в непрерывном режиме [41].
Летом 1971 года Жорес Алфёров с коллегами подали заявку на изобретение, в которой был обобщён опыт лаборатории в исследованиях ДГС-лазеров на основе AlAs-GaAs [42].
Крайне важно то, что в этой заявке авторы сформулировали идею, которая в будущем была воплощена в «лазерах с распределённой обратной связью – РОС» (Distributed Feedback Laser).
В этом патенте описана модель ДГС-лазера, конструкция которого аналогична показанной на риc. 6. За счёт двухсторонней инжекции создаётся инверсная заселённость носителей тока, которая с помощью оптического резонатора специальной конструкции позволяет получить когерентное световое излучение.
Простыми словами принцип действия оптического резонатора РОС лазера
можно объяснить с помощью схемы, показанной на рис. 9 [43].
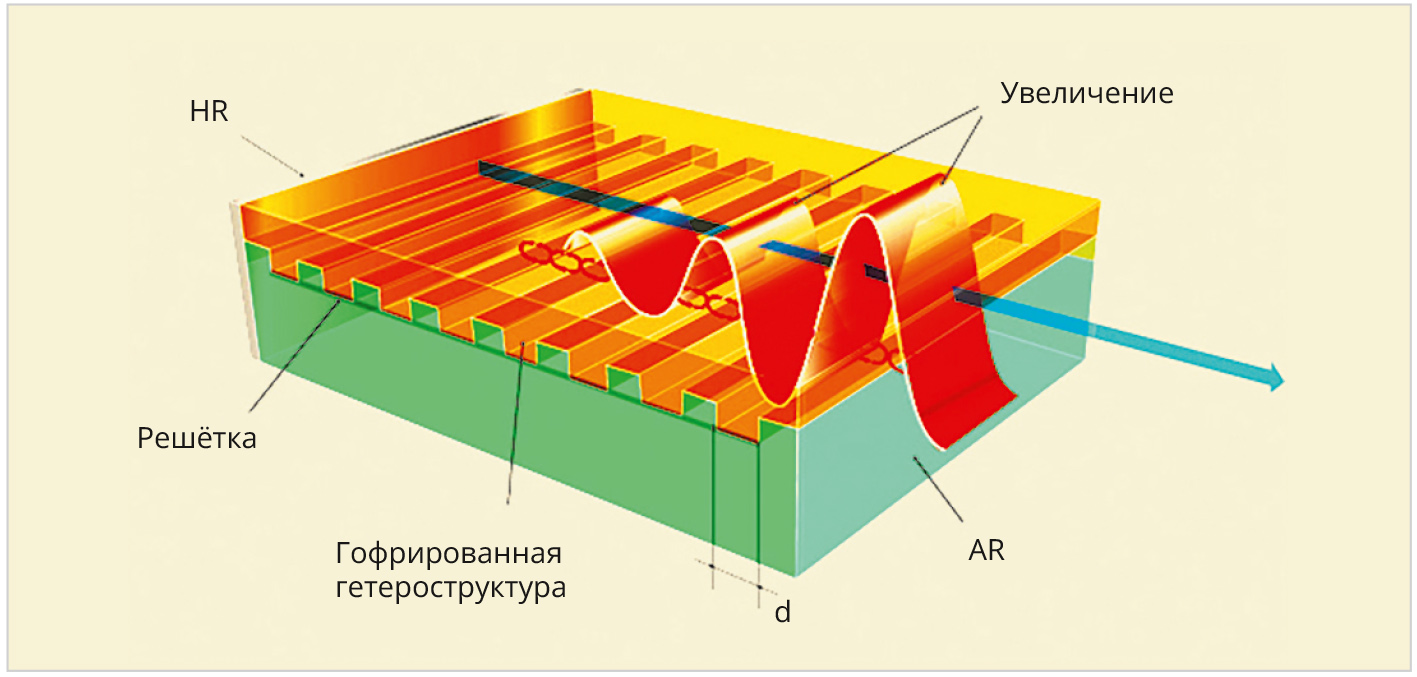
В РОС-лазерах гофрированная гетерограница создаёт периодическое изменение показателя преломления и приводит к интерференционному отражению стимулированного излучения. Период решётки выбирается таким образом, чтобы обеспечить выполнение условия Брэгга для отражений в обратном направлении d = λ/2ne, где λ – длина волны света в вакууме, ne – эффективный показатель преломления активной области, d – период решётки. Период решётки, например, в лазере на арсениде галлия равен 130 нм.
Поскольку отражение от периодической структуры существует для лучей, распространяющихся в обоих направлениях, то обратная связь в обоих направлениях распределяется по всей длине лазера. Кроме того, благодаря селективности обратной связи РОС-лазер работает в режиме одномодовой генерации.
Первыми сообщили о практической реализации РОС-лазера американские физики из California Institute of Technology, Pasadena.
Свою статью в журнале Applied Physics Letters они зарегистрировали 13 февраля 1973 года. В этой статье описан лазер с распределённой обратной связью на основе GaAs с оптической накачкой. В экспериментах был получен узкий стимулированный спектр с длиной волны около 0,83 мкм при пороговой мощности накачки примерно 2×105 Вт/см2 [44].
В следующем, 1974 году были опубликованы две работы. Группа Жореса Алфёрова сообщила об успешных испытаниях своего полупроводникового квантового генератора с поверхностной решёткой, распределённой обратной связью и сверхмалой расходимостью излучения [45].
Группа из Калифорнийского исследовательского центра Xerox Palo Alto Research Center представила результаты экспериментов с лабораторной моделью GaAs/GaAlAs лазерного диода с распределённой обратной связью (DFB) и одиночным гетеропереходом (SH). В зависимости от периода решётки различные образцы этого лазерного диода излучали в диапазоне от 8430 до 8560 Å [46].
Наряду с ДГС-лазерами с середины 1970-х начало развиваться направление создания гетероструктур на основе соединений AIIIBV.
Использование четверных твёрдых растворов, таких, например, как различные составы InGaAsP, открыло принципиально новые методы, существенно расширяющие возможности подбора решёточно-согласованных гетеропар. Ещё в 1970 году Жорес Алфёров и его коллеги на конференции в Будапеште предложили вариант получения согласованных гетеропереходов с использованием четверных твёрдых растворов группы AIIIBV [47].
На рис. 10 приведены значения ширины запрещённой зоны и постоянной
решетки для наиболее популярных гетероструктур на основе соединений AIIIBV [48].
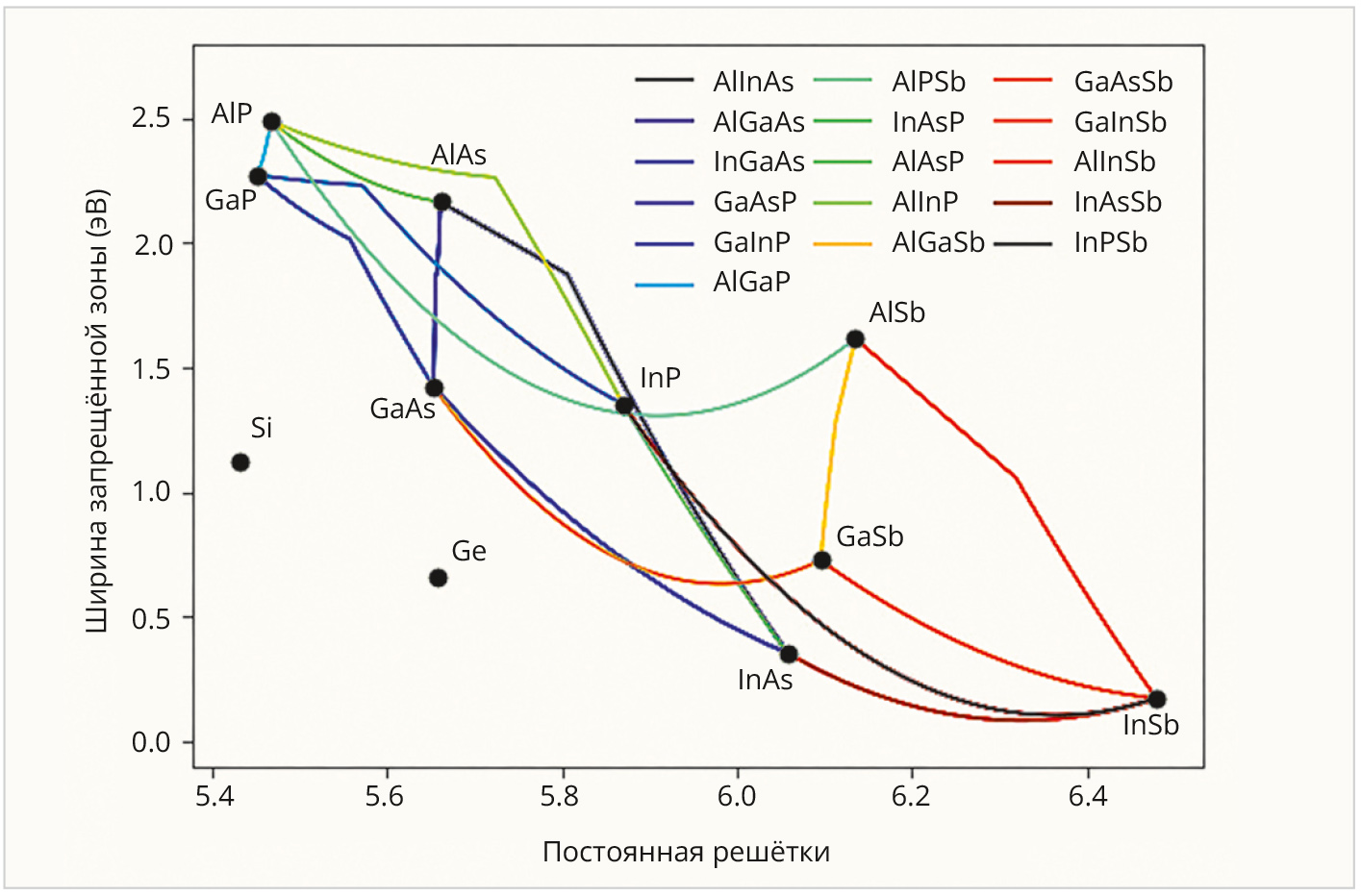
Энергия запрещённой зоны (левая ось y) и постоянной решётки (ось x) даны для значений при комнатной температуре. Линии, соединяющие точки для часто используемых сплавов, соответствуют хорошо изученным гетероструктурам, согласованным по параметрам решётки.
Твёрдые растворы типа AlGaInAs на подложках InP и GaAs имеют ширину запрещённой зоны в районе 1,2 эВ. Однако для получения структур с такой шириной запрещённой зоны на подложках GaAs необходимо использовать переходные слои, компенсирующие разницу в параметрах решеток.
Меняя состав четырёхкомпонентного твёрдого раствора InxGa1–xAsyP1–y, можно получать новые гетероструктуры с различными значениями постоянной решётки и ширины запрещённой зоны.
На подложках InP возможно выращивание четверных твёрдых растворов InGaAsP c шириной запрещённой зоны в промежутке 0,68…1,2 эВ.
Следует отметить, что результаты работ группы Алфёрова, связанные с четырёхкомпонентными твёрдыми растворами полупроводниковых соединений III–V, II–VI групп, находят применение и в наши дни, например, при производстве фотоэлектрических преобразователей лазерного излучения [49].
В области физики полупроводников годы научной деятельности Жореса Ивановича Алфёрова с 1960 по 1980 г. можно назвать этапом разработки классических ДРГ-лазеров.
Подводя итог этому периоду, можно сказать, что Алфёров за это время вместе с коллегами сделал свои самые значимые открытия и изобретения, которые стали основой его будущей Нобелевской премии.
Самым главным в исследованиях Алфёрова было то, что разработанные его группой устройства и технологии смогли повторить не только в других научных лабораториях, но они также нашли применение в массовом производстве различных бытовых, специальных приборов и оборудования.
Дальнейшие исследования Жореса Ивановича Алфёрова были связаны с разработкой лазеров на основе квантово-размерных эффектов. Эти его работы будут рассмотрены в следующей части статьи.
Литература
- Kroemer H. Nobel Lecture, 2001. URL: https://web.ece.ucsb.edu/Faculty/Kroemer/pubs/10_NobelLecture.pdf.
- Shockley W. Circuit element utilizing semiconductor material. U.S. Patent 2269347, September 25. 1951. URL: https://patentimages.storage.googleapis.com/2b/c2/a4/677433baba5fe9/US2681993.pdf.
- Kroemer H. RCA Review, vol. 18, pp. 332–342, 1957. URL: https://web.ece.ucsb.edu/Faculty/Kroemer/pubs/1a_57Quasi_Electric.pdf.
- Kroemer H., 1957. Theory of a wide-gap emitter for transistors. Proc. IRE 45, 1535. URL: https://web.ece.ucsb.edu/Faculty/Kroemer/pubs/1b_wide_gap.pdf.
- Алфёров Ж.И., Казаринов Р.Ф. Двойной гетероструктурный лазер. Авторское свидетельство № 27448. Заявка № 950840 с приоритетом от 30 марта 1963 г. PatentDB. URL: https://patentdb.ru/patent/181737.
- Kroemer H. A proposed class of hetero-junction injection lasers. In Proceedings of the IEEE, vol. 51, no. 12, pp. 1782–1783, Dec. 1963. URL: https://ieeexplore.ieee.org/document/1444636.
- Алфёров Ж.И. История и будущее полупроводниковых гетероструктур. URL: https://journals.ioffe.ru/articles/34218.
- Anderson R.L. Experiments on Ge-GaAs heterojunctions. URL: https://www.sciencedirect.com/science/article/abs/pii/0038110162901156.
- Early Work at Lincoln Laboratory on GaAs Semiconductor Devices. URL: https://archive.ll.mit.edu/publications/journal/pdf/vol02_no1/2.1.1.earlywork.pdf.
- Hall R.N., Fenner G.E., Kingsley J.D., Soltys T.J. and R.O. Light Emission From GaAs Junctions, Phys. Rev. Lett. 9, 366. – Published 1 November 1962. URL: https://journals.aps.org/prl/pdf/10.1103/PhysRevLett.9.366.
- Stimulated emission of radiation from GaAs p-n junctions. Marshall I. Nathan et al. Appl. Phys. Lett. 1, 62 (1962). URL: https://bit.ly/4d69e6r.
- Алфёров Ж.И. История и будущее полупроводниковых гетероструктур // ФТП. 1998. Т. 32. № 1. URL: https://journals.ioffe.ru/articles/viewPDF/34218.
- Алфёров Ж.И., Винокуров Д.А., Капитонов В.А. и др. Самоорганизующиеся наноразмерные кластеры InP в матрице InGaP/GaAs и InAs в матрице InGaAs/InP. URL: https://j.ioffe.ru/articles/viewPDF/35807.
- Алфёров Ж.И., Жиляев Ю.В., Шмарцев Ю.В. ФТП, 5, 196 (1971)*. URL: https://journals.ioffe.ru/articles/34218.
- Esaki L., Tsu R. Superlattice and negative differential conductivity in semiconductors. IBM Journal of Research and Development, ieeexplore.ieee.org, 1970. URL: https://ieeemilestones.ethw.org/w/images/6/62/IBM_JRD_14%2C_61_%281970%29.pdf.
- Enhancing Chaotic Behavior at room temperature in GaAs/(Al,Ga)As Superlattices. Physical review. B, Condensed matter. March 2017. URL: https://www.researchgate.net/publication/313724166_Enhancing_Chaotic_Behavior_at_room_temperature_in....
- Казаринов Р.Ф., Сурис Р.А. О возможности усиления электромагнитных волн в полупроводниках со сверхрешёткой // ФТП. 1971*. Т. 5, вып. 4. С. 797. URL: http://journals.ioffe.ru/articles/catalog.
- Osbourn G.C. A GaAsxP1−x/GaP strained-layer superlattice. Appl. Phys. Lett. 41, 172–174 (1982). URL: https://doi.org/10.1063/1.93450.
- Rupprecht H., Woodall J.M., Pettit G.D. Efficient Visible Electroluminescence at 300°K from Ga1–xAlxAs p-n Junctions Grown by Liquid-Phase Epitaxy. Applied Physics Letters, Volume 11, Issue 3, p. 81–83, 1967. URL: https://ui.adsabs.harvard.edu/abs/1967ApPhL..11...81R/abstract.
- Rupprecht H.S., Woodall I.М., Pettit G.D. Appl. Phys. Lett., 11, 81 (1967) (Subмitted June 19, 1967). URL: https://woodall.ece.ucdavis.edu/wp-content/uploads/sites/84/2016/02/rupprecht1967.pdf.
- Третьяков Д.Н. Материал из Википедии. URL: https://bit.ly/3YbfzIs.
- Алфёров Ж.И. Двойные гетероструктуры: концепция и применения в физике, электронике и технологии // УФН. 2002. Т. 172, № 9. С. 1068–1086. URL: https://www.mathnet.ru/links/987e195e847f2779db9179e60274eefe/ufn2057.pdf.
- Lattice Constant of AlAs. URL: https://doi.org/10.1002/crat.2170270118; AlxGa1–xAs/GaAs/AlxGa1–xAs.
- Double Quantum Well with a Thin AlAs Interwell Barrier. URL: https://link.springer.com/article/10.1023/A:1023913804235.
- Алфёров Ж.И., Андреев В.М., Портной Е.Л., Трукан М.К. Инжекционные лазеры на основе гетеропереходов в системе AlAs-GaAs с низким порогом генерации при комнатной температуре // ФТП. 1970, т. 3*. URL: https://journals.ioffe.ru/articles/34218.
- Alferov Zh.I. Nobel lectures. Reviews of modern physics v. 72, July 2001. URL: https://journals.aps.org/rmp/abstract/10.1103/RevModPhys.73.767.
- Алфёров Ж.И., Андреев В.М., Портной Е.Л. и др. Патент № 300126, МПК H01S 5/32, Опубликован 05.01.1977. URL: https://patents.su/3-300126-inzhekcionnyjj-lazer.html.
- Алфёров Ж.И., Андреев В.М., Клепикова Н.В. и др. Полупроводниковый лазер с гетеропереходами. Патент СССР № SU 521806; МПК: H01S 5/30. URL: https://patents.su/patents/shelovanova.
- Алфёров Ж.И., Андреев В.М., Гарбузов Д.З. и др. Исследование влияния параметров гетероструктуры в системе AlAs-GaAs на пороговый ток лазеров и получение непрерывного режима генерации при комнатной температуре // ФТП. 1970. Т. 4. С. 1826. URL: https://search.rsl.ru/ru/record/01001470767?ysclid=m24si2ska3854365508.
- Алфёров Ж.И., Андреев В.М., Корольков В.И. и др. Патент № 251096, МПК: H01H 21/203. Способ изготовления полупроводниковых диодов на основе соединений А3В5. Заявка 1210943, 15.01.1968. Опубликовано: 05.01.1977. URL: https://patents.su/3-251096-sposob-izgotovleniya-poluprovodnikovykh-diodov-na-osnove-soedinenijj-a-v....
- Алфёров Ж.И., Андреев В.М., Корольков В.М. и др. ФТП, 3, 930, 1969*. URL: http://journals.ioffe.ru/articles/catalog.
- Алфёров Ж.И., Андреев В.М., Корольков В.М. и др. ФТП, 4, 578, 1970*. URL: http://journals.ioffe.ru/articles/catalog.
- Алфёров Ж.И., Дураев В.П., Андреев В.М. и др. Омический контакт полупроводниковых приборов. Номер патента: 325908, МПК: H01L 21/28, Заявка: 30.04 1970. Опубликовано: 05.04.1974. URL: https://patents.su/1-325908-325908.html.
- Алфёров Ж.И., Андреев В.М., Каган М.Б. и др. Полупроводниковый фотоэлемент. Номер патента: 344781, МПК: H01L 31/02. Заявка 1465206, 14.07.1970. Опубликовано: 23.07.1981. URL: https://patents.su/2-344781-poluprovodnikovyjj-fotoehlement.html.
- Panish M.B., Hayashi I. and Sumski S. Double heterostructure injection lasers with roomtemperature thresholds as low as 2300 A/cm2. Appl. Phys. Lett. 16, 326–328 (1969). URL: https://pubs.aip.org/aip/apl/article-abstract/16/8/326/41930/DOUBLE-HETEROSTRUCTURE-INJECTION-LASERS....
- Nelson H. Epitaxial growth from the liquid state and its application to the fabrication of tunnel and laser diodes. RCA Rev. 24, 603–615 (1963). URL: https://cir.nii.ac.jp/crid/1571417125842515584?lang=en.
- Солдатенков Ф.Ю., Козлов В.А. Технология жидкофазной эпитаксии для выращивания многослойных гетероструктур силовой электроники на основе арсенида галлия // Наноиндустрия. 2018. Вып. 9. URL: https://www.nanoindustry.su/journal/article/6788.
- Ying Liu, Peng Zhou, et. al. Strain induced anisotropy in liquid phase epitaxy. Nature scientific reports. URL: https://bit.ly/3BUNMEz.
- Alferov Zh.I. Nobel Lecture: The double heterostructure concept and its applications in physics, electronics, and technology. REVIEWS OF MODERN PHYSICS, VOLUME 73, JULY 2001. URL: https://journals.aps.org/rmp/abstract/10.1103/RevModPhys.73.767.
- Alferov Zh.I., Andreev V.M., Garbuzov D.Z., et. al. Journal Sov. Phys. Semicond, v. 4, iss. 9, p. 1573 (1971). URL: https://scholar.google.com/citations?view_op=view_citation&hl=en&user=Mv3S6FkAAAAJ&a....
- Hayashi I., Panish M.B., Foy P.W. and Sumski S. Junction lasers which operate continuously at room temperature. Appl. Phys. Lett. 17, 109–110 (1970). URL: https://www.sciencedirect.com/science/article/abs/pii/B9780120029044500115.
- Алфёров Ж.М., Андреев В.М., Казаринов Р.Ф. и др. Полупроводниковый оптический квантовый генератор. Авторское свидетельство № 392875, СССР, МКИ H01 S 3/19. Заявка № 167749. Заявлено 19.07.1971 г. // Бюллетень изобретений (1), 259, 1977. URL: https://patents.su/patents/h01s-5-32.
- Distributed feedback laser, Wikipedia. URL: https://en.wikipedia.org/wiki/Distributed-feedback_laser.
- Nakamura M., Yariv A., Yen H.W. et. al. Optically pumped GaAs surface laser with corrugation feedback. Appl. Phys. Lett. Volume 22, Issue 10, p. 515–516. Pub Date: May 1973. URL: https://pubs.aip.org/aip/apl/article-abstract/22/10/515/43663/Optically-pumped-GaAs-surface-laser-wi....
- Алфёров Ж.И., Гуревич С.А., Казаринов Р.Ф. и др. ПКГ со сверхмалой расходимостью излучения // Физика и техника полупроводников. 1974*. Т. 8. С. 832. URL: http://journals.ioffe.ru/articles/catalog.
- Scifres D.R., Burnham R.D., Streifer W. Distributed – feedback single heterojunction GaAs diode laser. Appl. Phys. Lett. Vol 25, Issue 4, id. 203 August 1974. URL: https://ui.adsabs.harvard.edu/abs/1974ApPhL..25..203S/abstract.
- Alferov Zh.I., Andreev V.M., Konnikov S.G. et. al. Heterojunctions on the base of AIIIBV semiconducting and of their solid solutions. Proc. Int. Conf., Budapest, October 1970, ed by G. Szigeti, Academiai Kiado, Budapest, Vol. 1, p. 93, 1971. URL: https://link.springer.com/article/10.1007/BF01596252.
- Solcore 5.10.0 documentation. Materials and units. The Material System. URL: http://docs.solcore.solar/en/latest/Systems/Materials.html.
- Маричев А.Е. Исследование твёрдых растворов InGaAsP для фотоэлектрических преобразователей лазерного излучения. ФТИ имени Иоффе, 2023. URL: https://www.ioffe.ru/serve/theses/avtoref/Thes_0589.pdf.
*Примечание: статьи в журнале «Физика и техника полупроводников» доступны для всех желающих на сайте ФТП (http://journals.ioffe.ru/articles/catalog) только начиная с 1988 года. Более ранние статьи предоставляются по дополнительному согласованию с редакцией журнала.
© СТА-ПРЕСС, 2024
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!





