В процессе проектирования печатной платы разработчик иногда сталкивается с необходимостью выполнения несквозных отверстий, то есть переходов с одного слоя на другой, без сверления печатной платы насквозь. Это может быть вызвано следующими причинами:
- сложный компонент с маленьким шагом выводов, например BGA с шагом 0,5 мм и менее;
- слишком плотная трассировка при небольшом размере печатной платы и необходимость создания дополнительных «каналов» трассировки в зоне под переходным отверстием;
- необходимость устранения той части переходного отверстия, которая не задействована в электрическом контакте между слоями (так называемый stub), чтобы не создавать лишних проблем для высокоскоростных сигналов;
- потребность в ограничении распространения сигнала только в нескольких слоях, с экранированием остальных слоёв, например при разделении аналоговой и цифровой частей схемы.
В англоязычной литературе для обозначения таких отверстий применяют термины blind via (отверстие выходит только на один из внешних слоёв), buried via (отверстие полностью находится внутри платы, соединяя два или несколько внутренних слоёв), microvia или uvia (отверстие выполнено лазером между двумя соседними слоями). Технология, подразумевающая высокую плотность соединений, очень маленькие зазоры и ширину проводника на плате, и применение несквозных отверстий имеют обобщающее название HDI PCB (High Density Interconnect – межсоединения высокой плотности). Существует несколько международных стандартов, имеющих отношение к HDI-платам, их конструированию, производству и контролю качества, например:
- IPC/JPCA-2315: Design Guide for High-density Interconnect Structures and Microvias;
- IPC-2226: Sectional Design Standard for High-density Interconnect (HDI) Printed Boards;
- IPC/JPCA-4104: Qualification and Performance Specification for Dielectric Materials for High-density Interconnect Structures (HDI);
- IPC-6016: Qualification and Performance Specification for High-density Interconnect (HDI) Structures.
В русскоязычной литературе применяются термины «глухие отверстия», «слепые отверстия», «погребённые отверстия», «микроотверстия» и другие. При этом данные термины не всегда понимаются одинаково различными специалистами.
При формировании несквозных отверстий и их описании в САПР печатных плат важно заранее понимать, какая технология будет использоваться заводом-производителем для их создания. В этой статье будут описаны несколько основных типов несквозных отверстий на примере изготовления 4-слойной печатной платы с несквозным отверстием между слоями 1 и 2 (см. рис. 1).

Здесь также приводятся рекомендации по их применению, в том числе для случаев высокочастотных материалов и препрегов, таких как Rogers серии 4000. На основе приводимых ниже рекомендаций можно создавать более сложные конструкции, комбинируя между собой различные виды отверстий и технологий.
Существуют четыре основных вида несквозных отверстий:
- Stack up + HDI (прессование с фольгой снаружи плюс микроотверстия);
- Core + Core + HDI (ядро плюс ядро плюс микроотверстия);
- Drill + Resin flow (сверление плюс вытекание смолы);
- Drill + Resin plug (сверление плюс забивка смолой).
Рассмотрим последовательности операций по изготовлению каждого типа отверстий.
Stack up + HDI (прессование с фольгой снаружи плюс микроотверстия)
В таблице 1 приведена последовательность технологических операций.
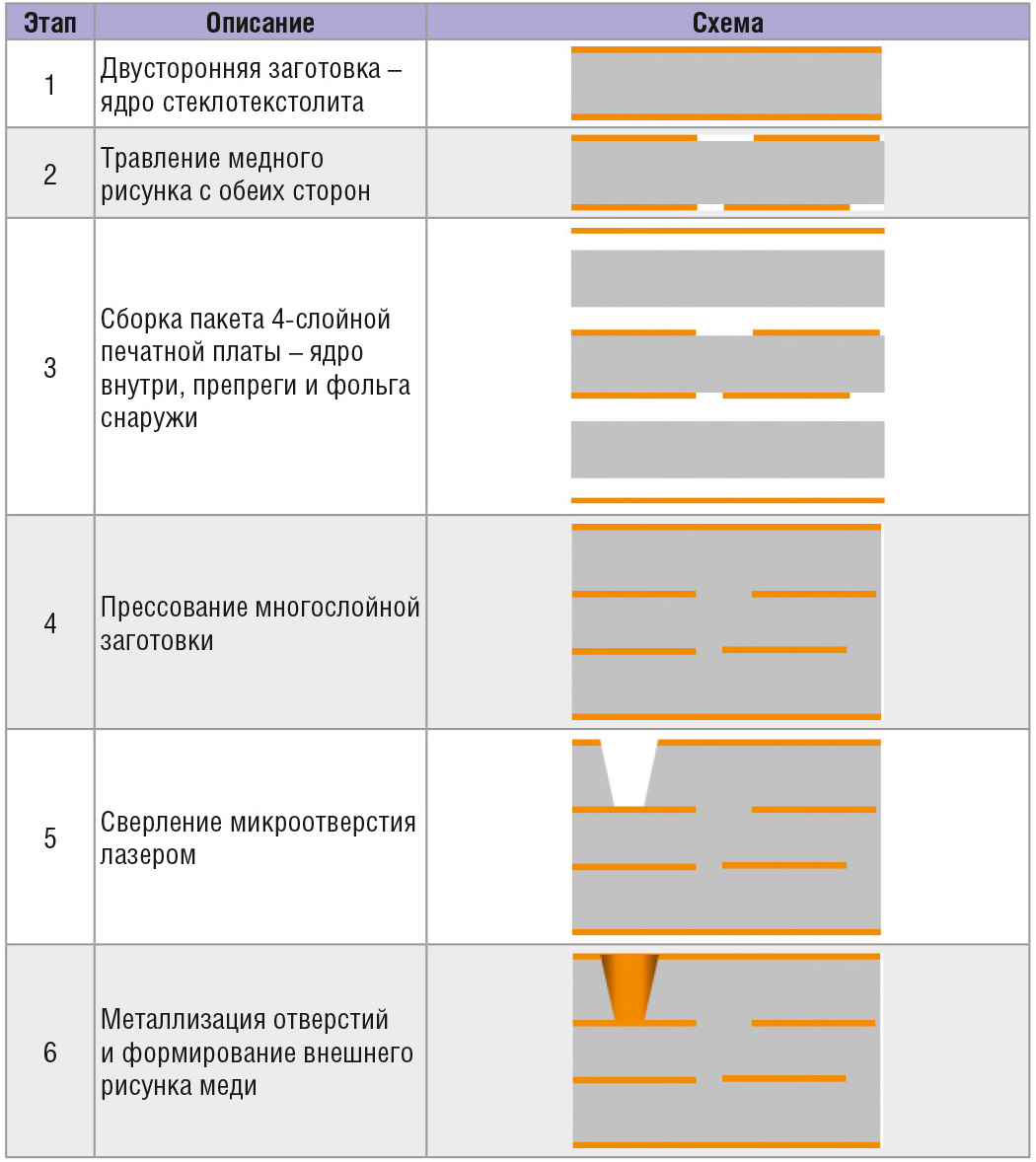
Рекомендации при исполнении такого типа конструкции следующие:
- нельзя использовать ВЧ-препрег типа Ro4450;
- расстояние между слоями 1 и 2 должно быть менее 0,15 мм (рекомендуется 0,05…0,1 мм);
- глубина отверстия не должна превышать его диаметр.
Core + Core + HDI (ядро плюс ядро плюс микроотверстия)
В таблице 2 приведена последовательность технологических операций.
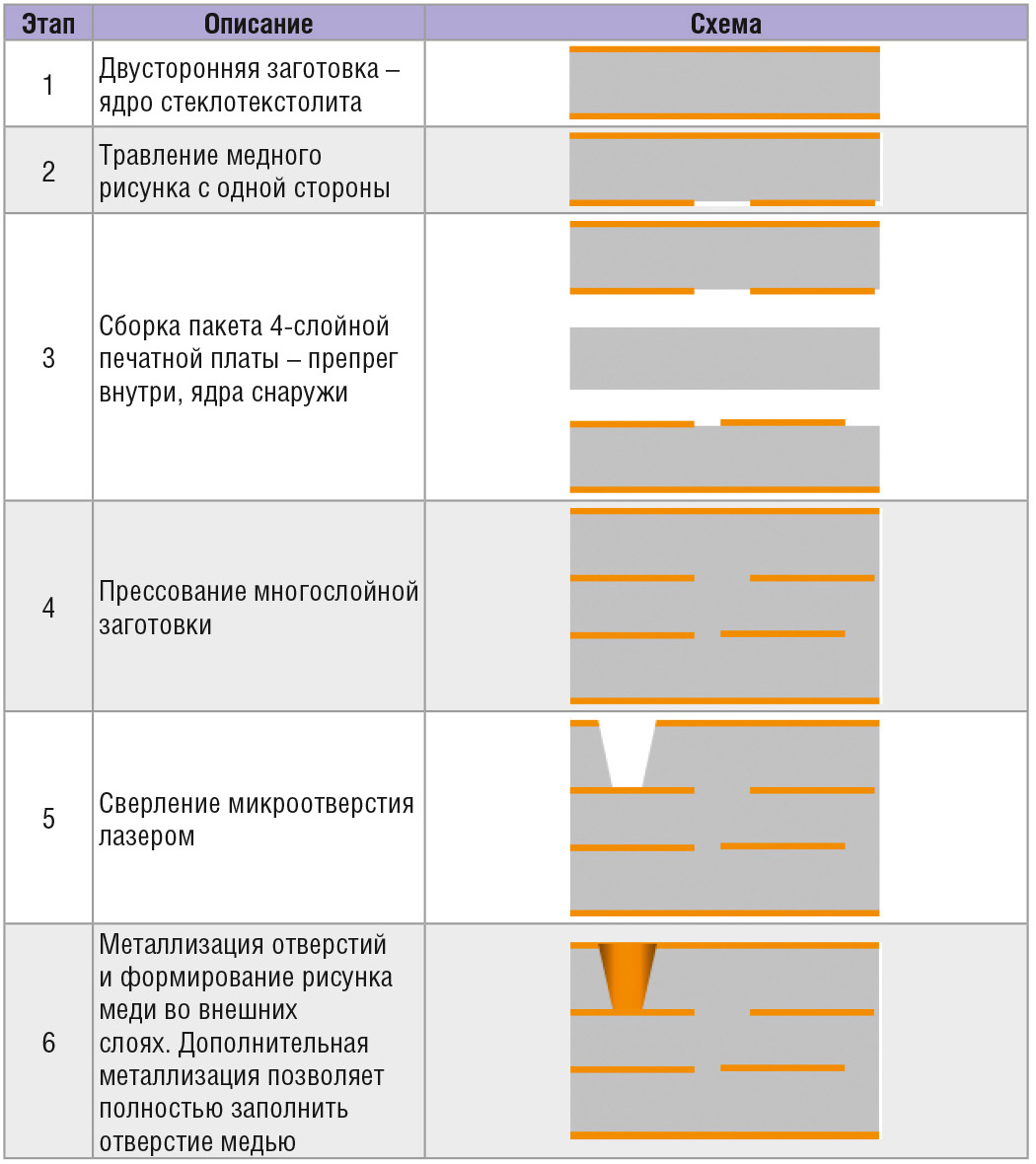
Рекомендации для такой конструкции:
- расстояние между слоями 1 и 2 должно быть менее 0,15 мм (рекомендуется 0,1 мм);
- если препрег – один слой Ro4450, нужно выбирать толщину меди не более 18 мкм;
- если препрег – один слой Ro4450, то конструкция Via-In-Pad (заполнение и дополнительная медная крышка на переходных отверстиях) в этой ситуации не рекомендуется.
Drill + Resin flow (сверление плюс вытекание смолы)
В таблице 3 приведена последовательность технологических операций.

Рекомендации для такой конструкции:
- нельзя использовать только один слой препрега;
- толщина меди во внутренних слоях – не более 18 мкм;
- если применяется препрег Ro4450, то конструкция Via-In-Pad невозможна;
- диаметр отверстия не должен превышать 0,25 мм;
- плотность таких несквозных отверстий не должна быть чрезмерной.
Drill + Resin plug (сверление плюс забивка смолой)
В таблице 4 приведена последовательность технологических операций.

Рекомендации для такой конструкции:
- для обеспечения стабильности размеров толщина ядра диэлектрика между слоями 1 и 2 должна быть не менее 0,2 мм;
- из-за увеличенной финишной толщины меди в слоях 1 и 2 (в связи с дополнительным этапом металлизации) зазоры и проводники в этих слоях должны иметь размеры не менее 0,1 мм.
Дополнительные рекомендации
Иногда разработчики применяют слишком много видов несквозных отверстий в одном проекте, что может привести к проблемам при производстве плат. Например, в приведённой на рисунке 2 6-слойной структуре имеются три типа отверстий, которые выходят на слой Top. В связи с этим при изготовлении такой платы три раза выполняется металлизация, и суммарная толщина меди является проблемой для создания прецизионной топологии.
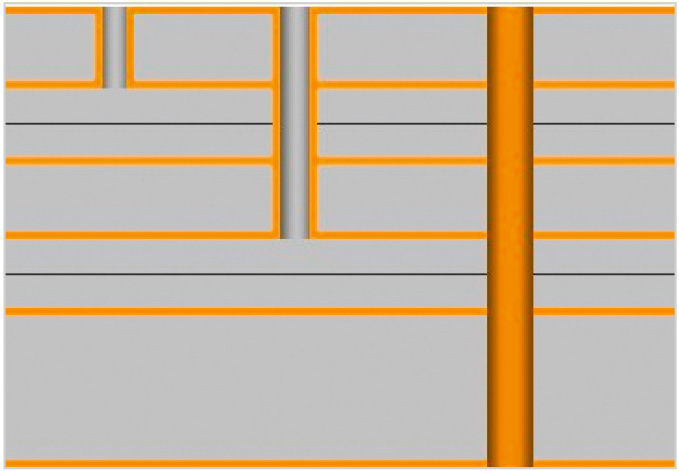
Необходимо минимизировать число типов отверстий, выходящих на один и тот же слой, или применять в таком слое менее прецизионные проводники и зазоры.
Перед проектированием структуры слоёв и созданием новых видов несквозных переходных отверстий следует проработать вопрос о том, как именно будет изготавливаться данная печатная плата, на каком заводе-изготовителе, и в какой последовательности будут выполняться циклы прессования слоёв, сверления и металлизации отверстий, заполнения отверстий медью или смолой и т.д.
Чем меньше циклов прессования, чем меньше видов переходных отверстий, тем дешевле получится плата. В среднем каждый дополнительный вид несквозных переходных отверстий может добавлять от 20 до 50% к стоимости заказа печатной платы. Тем не менее следует иметь в виду, что в ряде случаев наличие таких отверстий может позволить сократить общее количество слоёв в плате, снизить нормы проектирования, уменьшить общие габариты платы. А зачастую, как в случае с BGA-компонентами с шагом 0,5 мм, без несквозных отверстий и вовсе нельзя обойтись.
Поддержка несквозных отверстий в САПР
Стоит отметить, что в современных САПР поддержка технологий несквозных отверстий реализована на довольно высоком уровне. Например, в САПР Cadence Allegro и её подмножестве OrCAD имеется возможность «в один клик» создать «падстек» для заданной пары слоёв просто на основе выбранного в проекте печатной платы сквозного «падстека». В процессе трассировки пользователь может выбрать, с какого на какой слой ему нужен переход, и при этом указать, какой тип из существующих в проекте несквозных отверстий выбрать для данной операции. При формировании конструкторской документации и файлов Gerber САПР автоматически формирует необходимый комплект файлов сверления. Кроме того, в Allegro имеется специальная опция Allegro PCB Miniaturization Option, предназначенная специально для работы с HDI-платами и позволяющая работать не просто с отдельными микроотверстиями, а с их ступенчатыми и стековыми структурами, как «объектами топологии». В этом случае объект «структура микроотверстий» может быть не просто размещён на плате, но и модифицирован под требования конкретной ситуации, например связанные в единую структуру ступенчатые микроотверстия в слоях 1–2, 2–3 и 3–4 могут быть должным образом ориентированы в топологии, чтобы упростить трассировку. Также опция Allegro Miniaturization позволяет выполнять все необходимые технологические требования (DFM – Design for Manufacturing, «разработка для производства»), чтобы обеспечить возможность эффективной разработки и качественного изготовления печатных плат с первой итерации.
Поддержка в CAM-системах
Современные CAM-системы, применяемые для проверки производственных файлов печатных плат, также поддерживают несквозные отверстия. Например, редактор Gerber-файлов CAM350 версии 14 позволяет в момент загрузки файлов Gerber и NC-drill удобным образом отсортировать их и указать, между какими парами слоёв должны располагаться те или иные несквозные отверстия, и задать тип микроотверстий. Более того, CAM350 предлагает автоматически извлечь таблицу соединений на основе топологии слоёв и отверстий. Если у пользователя имеется возможность извлечь аналогичный нетлист из САПР, то с помощью CAM350 можно проверить полученные Gerber-файлы на корректность и соответствие этому нетлисту.
Заключение
Изложенные в статье принципы выполнения несквозных отверстий и HDI-структур и рекомендации по их применению позволят разработчику печатных плат более эффективно реализовать конкурентоспособные проекты и избежать ряда критических ошибок. Дополнительную информацию по этим и другим вопросам проектирования печатных плат можно найти в профессиональном блоге PCB Soft [1].
Литература
- Профессиональный блог по проектированию печатных плат: https://www.pcbsoft.ru/blog.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!







