Введение
Важнейшим вопросом, стоящим перед разработчиками силовой электроники, является выбор правильного силового ключа. В данной статье речь пойдёт о перспективах развития кремниевых IGBT-транзисторов с максимальным запирающим напряжением 600–750 В. В некоторых случаях свойства рассматриваемых транзисторов можно перенести и на транзисторы более высокого по напряжению класса.
«Идеальный» силовой ключ
Одним из главных показателей в работе силового ключа является величина энергетических потерь. В связи с этим потери в открытом и закрытом состояниях должны быть сведены к минимуму. Потери при переключении определяются перекрытием во времени переходных процессов напряжения и тока в ключе [1]. Потери на управление силовыми приборами гораздо меньше потерь переключения и поэтому учитываться далее не будут.
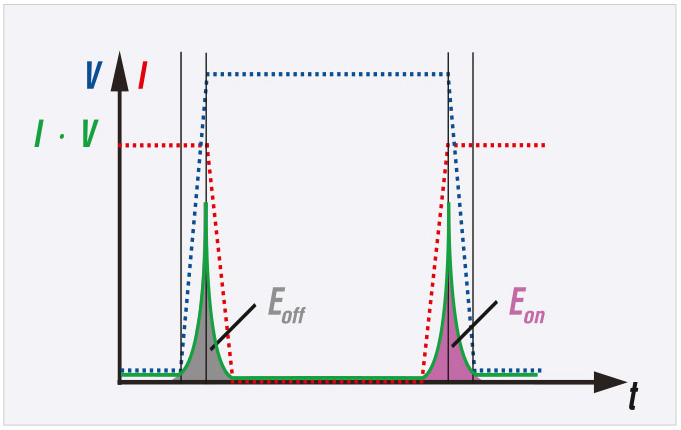
На рисунке 1 показаны процессы «жёсткого» включения и выключения идеального силового ключа без учёта влияния различных паразитных элементов. Если приложением заданы предельные значения скорости переходных процессов напряжения и тока (dU/dt и dI/dt), то потери в «идеальном» ключе представляют собой минимально достижимую величину. Минимальные потери мощности в ключе могут быть легко рассчитаны как интеграл произведения напряжения и тока. Дальнейшее снижение коммутационных потерь возможно только в том случае, когда приложение способно работать при более крутых переходных процессах. Данное ограничение применяется независимо от типа полупроводникового ключа и справедливо как для кремния, так и для других материалов с широкой запрещённой зоной.
Реальный силовой ключ
Для приложений с запирающим напряжением до 600 В IGBT-транзисторы применялись на протяжении нескольких десятилетий. В конце XX века появились инновационные технологии, которые повлияли на развитие IGBT-транзисторов. Речь идёт о совместном использовании в транзисторе Trench-ячеек и вертикальной оптимизации полупроводниковой структуры с использованием слоёв Field Stop (FS). Эти инновации позволили значительно снизить потери при переключении и потери проводимости.
В силовой электронике площадь кристаллов и, соответственно, цена конечного устройства определяются рассеиваемой мощностью. Чем больше площадь кристалла, тем лучше теплообмен с окружающей средой. Снижение цены за счёт применения малогабаритных полупроводниковых кристаллов возможно только при уменьшении потерь в ключах.
В настоящее время силовая полупроводниковая электроника развилась настолько, что ограничения на переходные процессы определяются уже не самим полупроводником, а конкретным приложением. В связи с этим основные усилия разработчиков сосредоточены на снижении потерь при включённом состоянии ключа.
Уменьшение потерь в IGBT-транзисторах
Параметры современных IGBT-транзисторов во включённом состоянии были улучшены за счёт наполнения электронами и дырками слаболегированной зоны, необходимой для формирования запирающего напряжения. При переходе из открытого в закрытое состояние снятие имеющегося избыточного заряда приводит к возникновению потерь при переключении. Потери проводимости могут быть снижены за счёт применения Trench-ячеек. Оптимизация вертикальной структуры (в основном за счёт FS-слоёв в комбинации со слабым эмиттером со стороны коллектора) позволяет снизить потери проводимости и потери при переключении. В настоящее время Trench FS IGBT-транзисторы уверенно доминируют в силовой электронике, вытеснив punch-through и non-punch-trough IGBT-транзисторы предыдущего поколения.
Снижение потерь во включённом состоянии
Совершенствование производственных процессов позволило создать тонкие структуры для силовых транзисторов и Trench-ячеек с мелким шагом и узкими мезами между затворными областями. Это сделало возможным дальнейшее увеличение концентрации носителей заряда под эмиттером благодаря ограничению потока дырочного избыточного заряда через p-слой к эмиттеру (см. рис. 2).
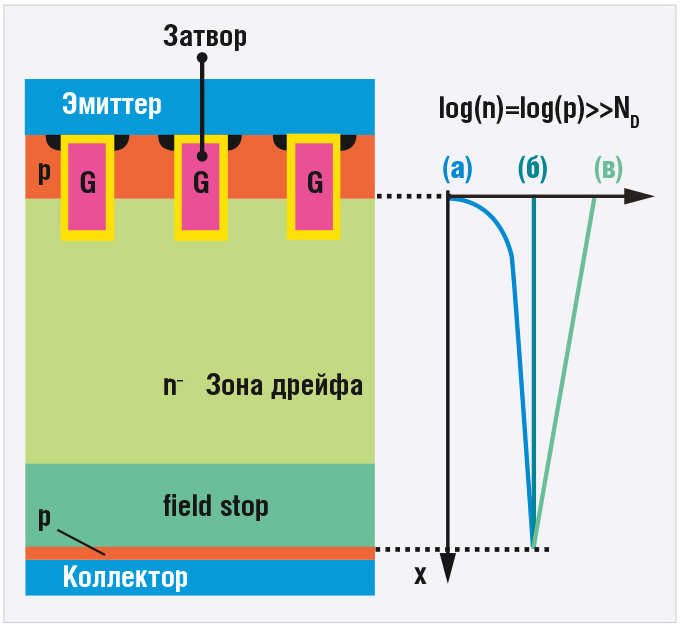
По сравнению с классическими Trench IGBT-транзисторами наличие большого запаса заряда под эмиттером приводит к значительному росту электрической проводимости в зоне дрейфа и таким образом улучшает значение прямого напряжения [2] (см. рис. 3). Стоит обратить внимание, что номинальное напряжение в IGBT-транзисторе с узкими мезами на 100 В выше по сравнению с обычным Trench FS IGBT-транзистором.
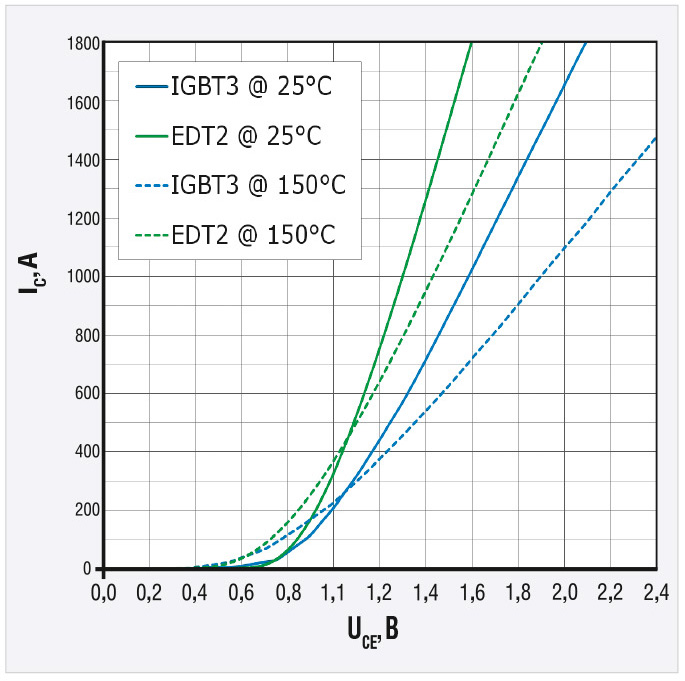
Наличие градиента носителей вызывает диффузию электронов через зону дрейфа, тем самым давая вклад в полный ток. Таким образом, необходимая часть дрейфового тока и падение напряжения в зоне дрейфа снижаются [3]. Тонкая структура Trench-ячеек может быть использована, например, для регулировки ёмкостей между коллектором и затвором или для регулировки соотношения ёмкостей коллектор-затвор/коллектор-эмиттер. В [2] предложено решение, согласно которому отдельные полупроводниковые области между Trench-затворами не соединяются либо отделяются нелегированными зонами. Таким способом можно, например, варьировать межэлектродную проводимость IGBT-транзистора или ток короткого замыкания [5].
Снижение потерь при выключении
При выключении IGBT-транзистора электроны и дырки должны быть удалены из зоны дрейфа для создания области пространственного заряда (ОПЗ) в обеднённой низколегированной области. Электрическое поле в созданной ОПЗ блокирует приложенное напряжение.

На рисунке 4 схематично изображены процессы, происходящие при выключении IGBT-транзистора с узкими мезами. Избыточный заряд в зоне дрейфа уже частично снят, а дырки уходят через область пространственного заряда к p-областям и затем к эмиттеру. Наличие положительного заряда дырок, проходящих в электрическом поле через ОПЗ, приводит к появлению потерь при переключении. Из рисунка 4 видно, что IGBT-транзистор с узкими мезами убирает высокую концентрацию дырок, блокируя электрод эмиттера. По потерям переключения IGBT-транзисторы с узкими мезами практически не уступают обычным Trench FS IGBT-тразисторам, обладая при этом гораздо лучшими характеристиками во включённом состоянии. В любом случае всегда можно найти приемлемое решение при выборе между потерями проводимости и потерями при переключениями. Заряд избыточных электронов выводится через терминал коллектора через оставшуюся зону с высокой проводимостью. Этот заряд выводится через область, практически лишённую электрического поля, и, следовательно, вносит лишь косвенный вклад в потери переключения, вызывая дополнительную инжекцию дырок с обратной стороны эмиттера.
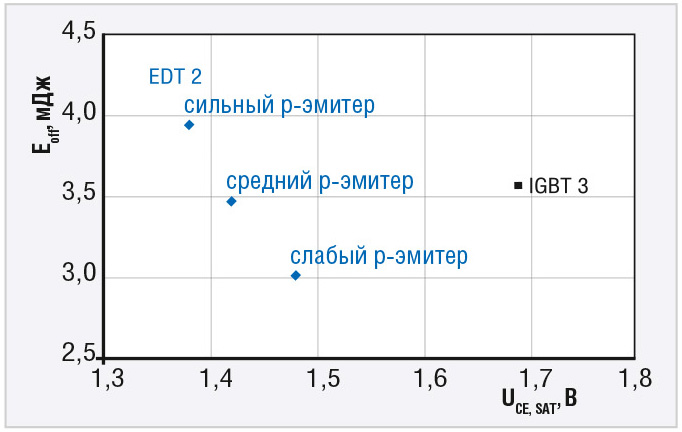
На рисунке 5 показана зависимость потерь при выключении от напряжения для IGBT-транзистора с узкими мезами и обычного IGBT-транзистора. В [4] представлены варианты оптимизации тонко структурированных IGBT-ячеек в сочетании с различными способами формирования вертикальной структуры и особенно расположением и параметрами p-эмиттера. Из рисунка 4 также видно, что использование слабых p-эмиттеров приводит к более низкой точке привязки для плотности избыточного заряда в зоне дрейфа со стороны коллектора и, соответственно, к более низким потерям при выключении. Это связано с тем, что при выключении через ОПЗ необходимо пройти меньшему количеству дырок.
Таким образом, предложенная концепция позволяет настраивать IGBT-транзисторы с узкой мезой для различных приложений: классических приводных преобразователей, резонансных топологий, быстрых ключей (которые в настоящее время конструируются на основе МОП-транзисторов). Для чип-версий с низкой плотностью избыточного заряда перед коллекторным электродом потери при переключении сопоставимы с характеристиками Superjunction МОП-транзисторов предыдущих поколений.
Во время выключения IGBT-транзистора необходимо ограничивать наклон тока, т.к. при наличии паразитных индуктивностей возникает большое пиковое перенапряжение. Этот скачок напряжения не должен превышать предельного значения запирающего напряжения транзистора. Величина наклона тока при выключении зависит от плотности избыточного заряда перед коллектором и p-эмиттером. Как показано на рисунке 5, потери при выключении для сильного p-эмиттера на 1/3 больше, чем при использовании слабого p-эмиттера. При этом во втором случае снижение прямого напряжения составляет всего 0,1 В. В связи с этим применение IGBT-транзисторов с узкой мезой даёт большие преимущества при работе в цепях постоянного тока с минимальными паразитными индуктивностями. Быстрые переходные процессы во время выключения могут оказаться приемлемыми при использовании IGBT-транзисторов с узкой мезой, имеющих низкую эффективность p-эмиттера и, следовательно, более низкие потери в целом.
Все IGBT-транзисторы с высокой (близкой к максимальной) плотностью избыточного заряда под электродом эмиттера имеют несколько бо¢льшую задержку выключения, т.к. высокая плотность носителей под электродом эмиттера снижается. Во время этой задержки не возникает значительных потерь, поскольку напряжение на выводах IGBT всё ещё близко к напряжению насыщения. Новые компоненты, имеющие характеристики, близкие к предельным для IGBT [3], по физическим причинам будут иметь ещё бо¢льшее время задержки выключения из-за перераспределения плотности носителей избыточного заряда.
Процессы при включении IGBT
Для многих схем и приложений по ряду причин накладываются определённые ограничения на максимальную величину наклона изменения тока в нагрузке при включении (dIc/dt). Такие ограничения могут быть вызваны, в частности, необходимостью обеспечения электромагнитной совместимости или предотвращения появления чрезмерных скачков напряжения при наличии паразитных индуктивностей. Например, при мостовом включении IGBT-транзистора слишком большие значения dIc/dt могут привести к выходу из строя соответствующего шунтирующего диода. Кроме того, падение напряжения во время включения (dVCE/dt) не должно превышать заданных приложением пределов. В связи с этим для замедления переходных процессов при включении часто применяются резисторы, подключаемые к затвору. Более медленные переходные процессы (dIc/dt и dVCE/dt) вследствие наличия ёмкостной обратной связи между коллектором и затвором также увеличивают энергетические потери при включении.
В быстрых переключаемых источниках питания, где важно обеспечить низкий уровень потерь при переключении, вместе с IGBT применяются карбид-кремниевые диоды Шоттки. При таком подходе удаётся избежать части потерь, вызванных накопленным зарядом биполярных диодов.
Заключение
В последние годы характеристики IGBT-транзисторов при включении заметно улучшены за счёт применения новых технологий обработки полупроводников. Тем не менее, достигнутые значения всё ещё далеки от физических пределов или ограничений, накладываемых размерами устройств [3]. Следует ожидать, что ещё несколько поколений IGBT-устройств будут развиваться в сторону улучшения рабочих параметров.
Для многих приложений чётко установлены предельные значения скорости нарастания/падения напряжения и тока, что накладывает соответствующие ограничения на величину потерь при переключении. В то же время самые современные устройства на основе кремния позволяют достичь скорости переключения, намного превышающей требования большинства приложений.
Коммутационные характеристики современных IGBT-транзисторов с узкими мезами могут удовлетворять требованиям самого широкого спектра задач. Так, например, для некоторых приложений, где важно обеспечить низкий уровень потерь при переключении, IGBT-транзисторы могут успешно заменить обычные или даже Superjunction МОП-транзисторы. Даже в решениях с жёсткими ограничениями на скорость роста/падения напряжения или тока данные транзисторы позволяют значительно уменьшить потери проводимости и потери при переключении.
Литература
- Wolter, F., Rupp, R., Haberlen, O. Next level Silicon, SiC and GaN – a balanced view on future power semiconductor switches. Proceedings of APE – Congress on Automotive Power Electronics, Paris, 2015.
- Wolter, F., Rosner, W., Cotorogea, M., Geinzer, T., Seider-Schmitt, M., Wang, K.-H. Multi-dimensional trade-off considerations of the 750V Micro Pattern Trench IGBT for Electric Drive Train Applications. Proceedings of the 27th ISPSD, Hongkong, 2015, p. 105–108.
- Nakagawa, A. Theoretical Investigation of Silicon Limit Characteristics of IGBT. Proceedings of the 18th ISPSD, Naples, 2006, p. 5–8.
- Kimmer, T., Griebl, E. Trenchstop 5: A new application specific IGBT series. Proceedings PCIM Europe 2012, Nurnberg, 2012, p. 120–127.
- Jager, C., Philippou, A., Vellei, A., Laven, J. G., Hartl, A. A new sub-micron trench cell concept in ultrathin wafer technology for next Generation 1200 V IGBTs. Proceedings of the 29th ISPSD, Sapporo, 2017, p. 69–72.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!