Уровень и перспективность электроники определяются свойствами базового материала – кремния, германия на кремнии, арсенида и нитрида галлия, карбида кремния и, в перспективе, алмаза и нитрида бора, в том числе и в таком новом направлении, как бета-вольтаика. Нет смысла лишний раз подробно интерпретировать и подчёркивать значение рынка объёмом $20 млрд в областях кардио-, нейростимуляторов, слуховых аппаратов, устройств для преодоления слепоты, дефибрилляторов, биосенсорики, аппараты для онкологии, оружия будущего (сенсорных и психотронных микро-БЛА – беспилотных летательных аппаратов – MAV), сферы действия МЧС («чёрные ящики», поиск в недоступном пространстве, безопасность АЭС, строительных конструкций и другое). Важно найти качественно новые прорывные технологические платформы в этом направлении. Один из вариантов таких новых решений и предлагается в настоящей статье.
Относительная эффективность бета-источников
Из физики твёрдого тела известно, что взаимодействие пучка высоко-энергетичных электронов с кристаллической структурой ковалентных (Si, Ge, diamond и других) и ионных (GaAs, InP, InSb и других) монокристаллов сопровождается многими явлениями, среди которых прежде всего следует отметить рассеяние (Elastically and Inelastically Scattered Electrons) и дифракцию электронов, генерацию рентгеновского излучения (X-rays), фотонов низкой энергии, оже-электронов (Auger-Electrons) и других в широком диапазоне значений hn – энергии с длиной волны от длины де Бройля λ ≈ 1,22/Е1/2, где [λ] = нм, а [Е] = эВ (Е – энергия электрона) до энергии запрещённой зоны полупроводника (то есть включая оптическое свечение). Скорость электронов в излучающем пучке зависит от энергии, предположим, в РЭМ-излучении с энергией 100 кэВ она составляет ≈ 1,6 × 108 м/с или » ½ С (скорость света).
Чем выше энергия релятивистского электрона, тем больше энергии в виде ионизации электронов и волновых квантов выделится в монокристалле. Но здесь есть свои ограничения, которые связаны с механизмом радиационных повреждений приёмного монокристалла, обусловленных выбиванием атомов из «седла» кристаллической решётки и, соответственно, созданием вакансий и междоузлий (пары Френкеля). Интенсивность этого процесса напрямую зависит от энергии электронов, облучающих монокристалл. Порог смещения данной энергии Et также определяется энергией связи атомов и энергии смещения Ed и атомным весом элемента (элементов) кристаллической решётки. Экспериментальные данные энергии смещения Ed для ряда атомов и функция от пороговой энергии пучковых электронов показаны на рисунке 1 [1].

Из анализа пороговой энергии выбивания и с учётом того, что чем выше энергия лучевого электрона и чем выше флюенс электронного излучения, в таких соединениях, как алмаз, полупроводниковых кристаллах с соединениями лёгких атомов, таких как BN и MOCVD SiC, GaN и другие, с позиции эффективной бета-вольтаики «искать нечего», в пограничной зоне (< 150–170 кэВ) эффективность/неэффективность – кремний (Si), несмотря на все известные Trench-конструкции. Очень выигрышно выглядит германий (Ge), но на нём проблематично создать монокристаллы с собственной шириной физического p–n-перехода в единицы и, тем более, в десятки микрометров. В подтверждение вышесказанного в блестящей монографии по бета-вольтаике [2] показана бессмысленность создания бета-токового генератора на основе MOCVD политипов 4H-, 6H-SiC, где даже высокая плотность неосновных носителей в виде дырок с энергией 3,2–3,4 эВ «строит» атомную решётку (SF-эффект). А что тогда говорить про электрон с энергией 200–300 кэВ?

* По разным источникам.
** Прогнозируемый по дефектообразованию пары Френкеля уровень радиационной стойкости LPE i-GaAs.

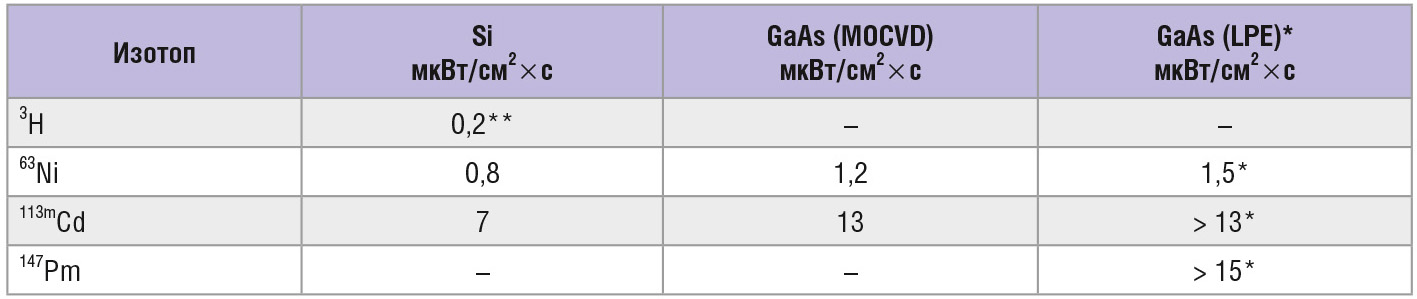
* Прогнозируемая плотность энергии при бета-генерации.
** Мощность преобразования, на взгляд авторов настоящей публикации, завышена в сотни раз (см. рис. 6).
Экспериментальные исследования энергии дефектообразования по Френкелю в известных полупроводниковых монокристаллах (с нашим техническим прогнозом) показаны в таблице 1 (по данным работы «Advances in Power Sources» [3]).
Из вышеприведённого следует, что мы подошли к проблеме выбора эффективных природных источников лучевой энергии электронов – изотопов.
В таблице 2 показаны наиболее распространённые в бета-вольтаике изотопы, такие как источники излучения высокоэнергетичных электронов (с энергией не выше 250 кэВ).
Из таблицы 2 следует, исходя из пороговой энергии дефектообразования (пар Френкеля), наиболее приемлемыми изотопами для кремниевой бета-вольтаики являются изотопы 3Н и 63Ni, а такие изотопы, как 113mCd и 147Pm – находятся либо на грани, либо в абсолютной зоне радиационного дефектообразования (резкого падения эффективности бета-источника питания). По данным публикации «Бета-вольтаический МЭМС – преобразователь энергии» [4] можно сравнительно оценить (см. табл. 3) теоретически максимально возможную энергию бета-генерации (мощность преобразования / см2 × с) в кремнии и арсениде галлия (MOCVD) и прогнозируемую в LPE GaAs.
Анализируя значения параметров, показанных на рисунке 1, в таблицах 1, 2 и 3, можно сделать вывод, что наиболее эффективная бета-вольтаика может быть построена на основе практически бездефектного (около 101 см-2) LPE i-GaAs, структурная однородность которого значительно выше, чем у i-GaAs-полуизолятора, полученного по MOCVD-технологии.
Физическая модель бета-генератора на основе LPE i-GaAs
Исходя из анализа максимальных значений энергии излучения протонов, максимальная длина пробега радиационных электронов изотопов 63Ni и 147Pm в атомных решётках Si и GaAs составляет 12 и 55 мкм соответственно. У 113mCd чуть выше – 40 мкм. Число генерируемых электронных носителей в Si и GaAs при облучении одним электроном со средними энергиями в 17,1 кэВ (63Ni), 57кэВ (113mCd), 65 кэВ (147Pm) будет, соответственно, от 3800 электронов (63Ni) до 17 000 электронов (147Pm). Другими словами, предположим, что изотоп имеет флюенс электронов ≈ 1010 см—2, тогда фактическая генерация свободных электронов (способных участвовать в проводимости s = qnm) в кремнии и арсениде галлия будет соответственно 3,8 × 1013 и 1,7 × 1014 – в объёме 1,0 см2 × длину пробега. Другой вопрос: все ли электроны «добегут» до контактов, пока их не вернёт «на своё место» атомно-кристаллическая решётка? Далеко не все. Всё будет зависеть от подавления вероятности рекомбинации (возврата электронов в атомно-связанное состояние, непроводящее состояние, то есть обнуляющей дивергенцию зарядов в объёме полупроводника). Уровень паразитной в данном случае рекомбинации электронов зависит от их свойств (время жизни, диффузионная длина, коэффициент диффузии) и от материала полупроводника, но важнейшую роль приобретает сила электрического поля в зоне физического p–i–n-перехода, которое зависит от величины собственного потенциала p–n-перехода

и пролётной скорости электронов в области физического p–n-перехода (то есть области пространственного заряда), которая определяется формулой v = µE. Как известно, чем шире область пространственного заряда (ОПЗ) p–n-перехода, тем ниже напряжённость поля в нём и, соответственно, ниже пролётная скорость электронов. Разница состоит в том, что зависимость VGaAs и VSi при слабых полях отличается на порядок в пользу GaAs, соответственно, и время пролёта меньше на порядок. Предположим, что мы для изотопа63Ni выбрали высокоомный кремний с ρ ≈ 500 Ом × см. Расчёт показывает, что резкий Si p–i–n-переход с указанной омностью будет иметь ширину ОПЗ ≈ 12 мкм (максимальная глубина пробега высокоэнергетичных электронов 63Ni – 12 мкм), а это значит, что большая часть ионизированных электронов окажется в ОПЗ – области p–i–n-перехода. Но здесь вмешивается пролётный механизм сепарирования электронов и дырок, то есть нужно, чтобы пролётное время было гораздо ниже типовых значений времени жизни в высокоомном кремнии, достигающих нескольких микросекунд. Проблема пролётного времени связана с начальной характеристикой подвижности электронов и дырок на графике насыщения V = f(E), которые имеют в слабых полях на порядки меньшие значения, чем в зоне насыщения.
Таким образом, на КПД генерации очень сильно влияет ряд факторов: ширина ОПЗ, время жизни генерируемых носителей заряда, которое может быть сверхкоротким (ионизированные «лёгкие» электроны с глубоких атомно-орбитальных уровней), а также глубина p+-областей p–i–n-переходов, нанокластеры и другое. Но (!) необходимо подчеркнуть, что вышеописанная модель генерации электронно-дырочных пар основана на свойствах зонной энергетики полупроводника с традиционными классическими понятиями переноса зарядовой частицы (электрон/дырка) в объёме полупроводника в пределах их времён жизни в неравновесном состоянии. Но физика высоких энергий высокоэнергетичных частиц (десятки, сотни кэВ) резко отличается от физики слабоэнергетичной электроники (ширина запрещённой зоны полупроводника, используемая в практических целях, всего 0,18–5,5 эВ), по-этому и динамика дивергенции зарядов несколько иная (см. раздел статьи «Динамические свойства бета-источников питания»).
Ширина физических p–i–n-пере-ходов при собственном потенциале у 500-омного кремния и LPE p-i-n GaAs может отличаться на порядок (12 мкм и 100 мкм соответственно), а это значит, что для бета-источников на LPE i-GaAs более предпочтительны изотопы с более высокой энергией излучения электронов, например, 147Pm (максимальная энергия электронов в процессе распада достигает 220 кэВ), который неприемлем для кремния. В этом случае теоретическая эффективность применения структур LPE p-i-n GaAs для бета-вольтаики, по сравнению с кремнием (Si), возрастает более чем на порядок.
Что касается GaN и политипов 4H-, 6H-SiC, то несколько факторов исключают возможность их применения для производства бета-источников, а именно: сверхмалые области ОПЗ (в несколько раз ниже, чем в Si и, тем более, в LPE i-GaAs), высокая дефектность структур, малые времена жизни носителей заряда, низкая радиационная стойкость по электронному дефектообразованию из-за наличия лёгких атомов азота и углерода. Да и стоимость, к примеру, слабодефектного SiC площадью в 1 см2 будет в пределах более чем $1000 за чип. Радиационная стойкость твёрдого углерода – алмаза – к высокоэнергетичным электронам показана на рисунке 1.
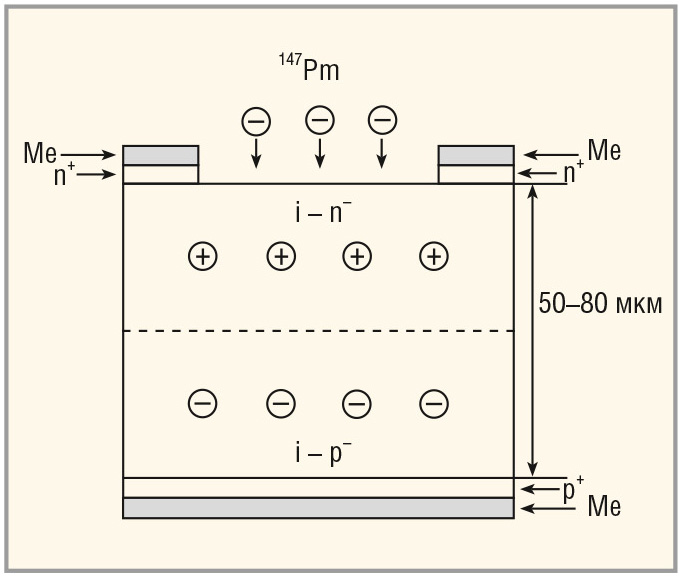
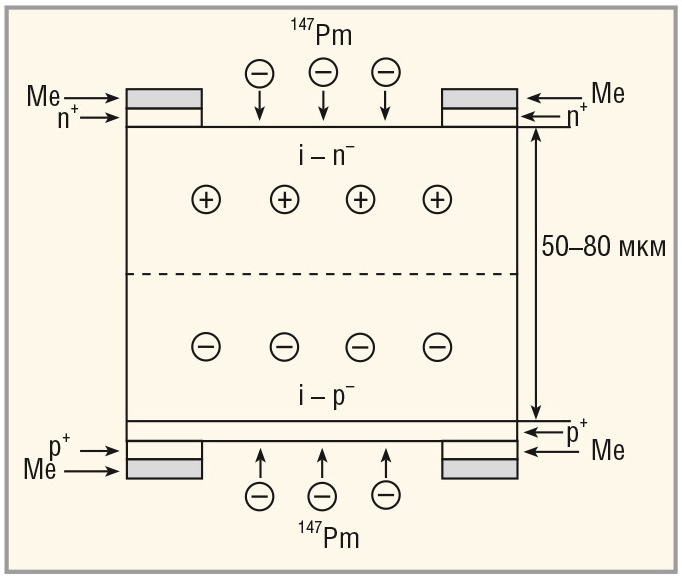
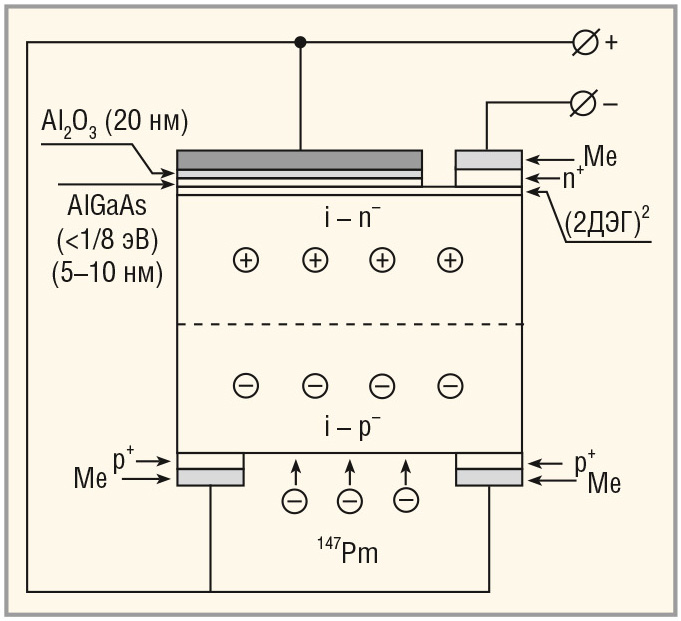
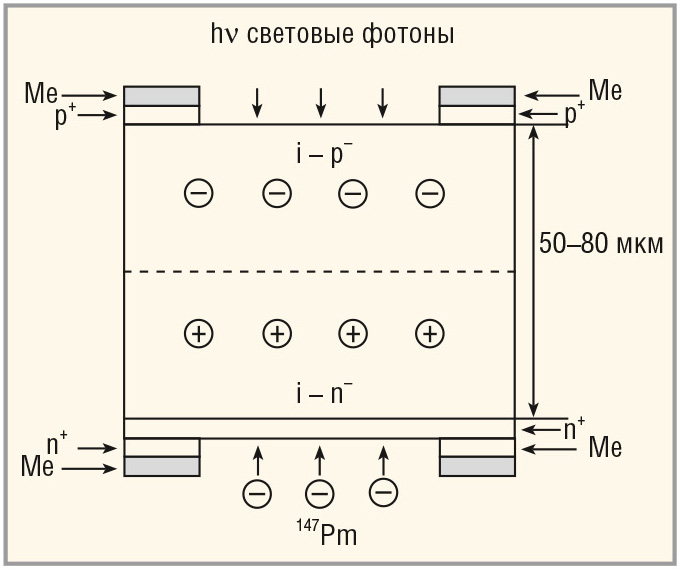
На рисунках 2, 3, 4 и 5 показаны различные модификации конструктивного исполнения бета-источников на LPE i-GaAs, в том числе гибридный с оптико-инфракрасным широкополосным квантовым приёмом в диапазоне эффективной энергии солнечной радиации 0,4–5,0 микрометров (на эффекте «расщепления» уровня Ферми в запрещённой зоне LPE i-GaAs). Не стоит также удивляться и тому, что широкозонный SiC (4H-, 3C – дилатационные политипы) сможет усваивать энергию hn на длинах волн ≈ 1,0 мкм, что в классической физике возможно только на полупроводниках с шириной запрещённой зоны 1,14 эВ (немного больше, чем у кремния), что в три раза меньше, чем у политипов 4H-, 6H-SiC. В определённых научных кругах это уже известный факт.
Расчётная сравнительная эффективность бета-источников питания на основе систем 63Ni/Si и 147Pm/GaAs
На рисунках 2, 3, 4 и 5 показаны простейшие первичные варианты конструкций бета-источников питания, выполненных на основе системы 147Pm/i-GaAs (LPE i-GaAs). Один излучаемый изотопом 147Pm электрон со средней энергией 67 кэВ, проникая в монокристалл LPE i-GaAs на глубину более чем 50 мкм, генерирует свыше N147Pm = 17 000 электронно-дырочных пар. Один электрон изотопа 63Ni со средней энергией 17,3 кэВ, проникая в кремний на глубину порядка 12 мкм, генерирует не более 4000 электронно-дырочных пар.
Предположим, что мы имеем дело с «концентрированными» изотопами 147Pm и 63Ni, то есть большинство атомов в кристаллических решётках 147Pm и 63Ni ионизированы (в ускорительных циклотронах или в реакторах), тогда при «паритетной» концентрации радиоактивных атомов в 147Pm и 63Ni интенсивность излучения (флюенс) электронов на единицу площади, допустим, на 1,0 см2 будет определяться соотношением периодов полураспада (TП), то есть коэффициент эффективности К равен

В итоге, гипотетическая эффективность источников бета-питания на основе систем 147Pm/GaAs и 63Ni/Si с одинаковой концентрацией радиоактивных атомов (изотопов) будет выражаться в соотношении количества генерируемых (ионизируемых) электронов в решётках Si и GaAs от изотопов 63Ni и 147Pm, умноженного на коэффициент КЭ.
Отсюда следует, что теоретический потолок соотношения эффективности КЭ2 бета-источников питания на основе 147Pm/GaAs и 63Ni/Si составляет

То есть чисто теоретически, при равной концентрационной радиоактивности изотопов 147Pm и 63Ni (её выражают в мкКи), потолочная эффективность систем бета-источников на основе изотопов – аналогов 147Pm, то есть с максимальной энергией электронов 220 кэВ и 63Ni – 67 кэВ, на кремнии и арсениде галлия отличается более чем на два порядка. Для сравнения, реальное значение соотношений радиационной активности в расчёте на 1,0 г изотопа прометия 147 и никеля 63 выражается дробью [5] и, с учётом лавинизации электронов при прочих равных условиях, эффективность бета-источников на основе 63Ni/Si и 147Pm/GaAs реально будет отличаться как минимум в 45 раз!
Отсюда следует, что относительно несложно рассчитать толщину плёнки изотопа 147Pm на поверхности LPE i-GaAs c учётом вынужденного саморассеяния радиационных электронов в кристаллической решётке 147Pm. Чаще всего приемлемая толщина радиоизотопа 147Pm с учётом ТКР и фактора саморассеяния на поверхности полупроводника составляет около 6 мкм. В принципе, такие толщины являются потолочными и для 63Ni. Иначе, предположим, при температуре кристалла свыше Tj > 100°C изотопы металлов просто разорвут полупроводник на куски, не говоря уже о «катакомбной» Trench–63Ni/Si-конструкции, в которой при высокой рабочей температуре будет наблюдаться обычная «закоротка». Здесь также уместно привести зависимость количества генерируемых электронов в полупроводнике от энергии изотопного электрона в реальных условиях, то есть при ра-зумно допустимых толщинах плёнок металлических изотопов на поверхности полупроводника (≤ 6,0 мкм) и газового 3Н [8] (см. рис. 6).
![Рис. 6. Зависимость генерации электронов от энергии изотопного электрона [8]](/images_soel/publications/2015/2015-6/СоЭл_2015-6pr_page15_pic6.jpg)
Из графика следует, что при энергиях изотопных электронов ≈ 5 кэВ генерация электронно-дырочных пар практически отсутствует (например, изотопы 3Н), поэтому изотопы с энергией ≈ 5 кэВ исключительно удобны для создания электронных пучков для процесса электронной нанолитографии (10,0–1,0 нм).
Приведённый выше расчёт произведён для материалов:
а) Si с ρ ≈ 500 Ом × см с Wp–n ≈ 12 мкм;
б) i-GaAs c ρ > 109 Oм × см с Wi ≥ 55 мкм,
где Wp–n и Wi – ширина физического p–n-перехода, содержащего область пространственного заряда.
При расчёте не учитывался фактор, связанный с энергией ионизации атомов в кристаллических решётках Si и GaAs. Энергия ионизации атома кремния (по водороду) составляет 8,15 эВ, у германия – 7,88 эВ, приблизительно этого же порядка и у атомов Ga и As. Снижение энергии ионизации у более тяжёлых атомных элементов связано с увеличением плотности электронов на орбитах вокруг атомного ядра (Si – 3S23P2; Ga – 4S24P1; Ge – 4S24P2; As – 4S24P3), что, в принципе, хорошо коррелируется с зависимостью числа генерируемых электронов от энергии изотопного электрона. Но при этом не нужно путать энергию образования пары по Френкелю и энергию ионизации собственного атома. Это разные вещи.
Следовательно, если считать эффективность генерации электронов по кремнию изотопными электронами, то повышающий коэффициент генерации электронов составит ≈ 1,04 или ≈ 3–4%, что может служить поправкой в пользу GaAs. В начале статьи было подчёркнуто, что кремний – это полупроводник с ковалентной связью, а GaAs – с ионной, а это значит, что на повышении эффективности генерации электронов в бета-вольтаике на основе GaAs может также сказаться и атомно-дипольная поляризация молекулы GaAs, которая, кстати, и приводит к электронной генерации доменов Ганна. Этот фактор является пока только прогнозируемым, с учётом анизотропии кристалла. Упомянутая выше энергия ионизации, допустим, того же Si Eи = 8,15 эВ – это не что иное как первичная ширина запрещённой зоны сверхчистого идеального атомарного (без всякой примеси и дефектов) кремния, реальную оптическую ширину запрещённой зоны Eg Si = 1,12 эВ все хорошо знают со школьной скамьи. Это говорит о том, что энергия оптической запрещённой зоны на сегодня «висит» в энергопространстве, поскольку она не привязана к энергии ядра атома. Бета-электроника неизбежно поднимает этот вопрос, и здесь в расчётах принимается энергия ионизации атома, которая, допустим, выше классической энергии оптической запрещённой зоны более чем в 5–7 раз! В процессе взаимодействия высокоэнергетического электрона с атомной решёткой полупроводника генерируется часть электронов с глубоких орбитальных уровней, которые имеют сверхмалую эффективную массу m*, которая имеет неклассическое соотношение с массой связанного электрона в GaAs m*/m0 ≈ 0,068 (а гораздо меньшую величину и их подвижность может достигать в десятки тысяч см2/В × с). Время жизни таких сверхлёгких («сверхглубинных», валентных) электронов имеет сверхмалые значения по сравнению даже с очень малыми значениями τn в GaAs, составляющих десятки наносекунд. Таким образом, взгляд на традиционную оптическую рекомбинацию электронов также предстоит пересматривать, как, впрочем, и энергию излучения при торможении изотопного электрона в полупроводниковой решётке (энергия торможения), которую удобно использовать для генерации от терагерцового (субмиллиметрового) диапазона, ближнего/среднего/дальнего инфракрасного, оптического диапазонов, вплоть до X-рентгеновского диапазона (прикладывая сильное электрическое поле к p-i-n GaAs образцу, тем самым регулируя тормозную энергию электрона в области пространственного заряда физического p–n-перехода). О радиационной стойкости в пользу LPE i-GaAs говорит и патент по созданию нейтронного датчика на основе LPE i-GaAs сотрудниками МИСИС, г. Москва (RU 2532647, авторы Бритвич Г.И., Кольцов Г.И. и другие), выдерживающего огромный флюенс импульсного нейтронного облучения.
На основании наших последних достижений по пассивации LPE p-i-n GaAs высоковольтных переходов (1,0 мкА, +300°С, сотни вольт при площади чипа 1,7 × 1,7 мм2) мы планируем резко улучшить характеристики нейтронных датчиков, сверхчувствительность как обратного смещённого, так и прямосмещённого действия, а это не что иное, как тоже бета-, а точнее, протоно-вольтаика. Совершенно очевидно, что наши технологии будут более приемлемы для обеспечения безопасности АЭС.
Подводя итог приведённой информации по достигнутому уровню качества пассивации p-i-n GaAs переходов, можно с исключительным оптимизмом констатировать, что на рынке появится новейшее поколение электронных приборов, то есть новая электронная индустрия на основе монокристаллов LPE i-GaAs. Это абсолютно новая электроника, отличающаяся тем, что она будет работоспособна при температурах кристалла GaAs вплоть до 320–350°С и будет отличаться исключительной радиационной стойкостью, гиперскоростью. На основе кристаллов LPE i-GaAs можно создать все известные физические прототипы полупроводниковых приборов, созданные на основе кремния, карбида кремния, полу-изолятора арсенида галлия, нитрида галлия и других, вместе взятых. Впереди феноменальные разработки и серийный выпуск силовой электроники, СВЧ и, с учётом бета-электроники, терагерцовой электроники, инфракрасной, оптической/световой, ультрафиолетовой и рентгеновской электроники, то есть во всём диапазоне частот от 100 до 1017 Гц. На основе данного кристалла прорабатываются модели высоковольтных терагерцовых генераторов субмиллиметрового диапазона на новых принципах модуляции Максвелловской анизотропии скорости распространения электромагнитных волн.
Кристаллы LPE i-GaAs, наряду с чис-тым кристаллическим алмазом (Dia-mond), имеют собственную концентрацию электронов <2 × 106 см-3, то есть это чистые диэлектрики. Проводимость GaAs кристаллов хорошо модулируется от сопротивлений выше, чем 109 Ом × см до металлической (ρ < 10-5 Ом×см), то есть монокристаллы LPE i-GaAs и алмаза нарушают общепринятое классическое деление твёрдых тел по проводимости на диэлектрики, полупроводники, проводники. Более того, в работе «Новая экстремальная электроника на основе LPE i-GaAs монокристаллов» [6] показано, что при безрассеянном пролёте электронов в GaAs на расстояниях меньше 4,5 нм данный кристалл является идеальным проводником, у которого почти нет электрического сопротивления и, более того, при попадании одного электрона 147Pm в наноплощадку GaAs размером 4,5 × 4,5 нм мы, очевидно, будем наблюдать явление комнатной сверхпроводимости, поскольку концентрация генерируемых электронов от радиационного электрона может превысить количество атомных ядер в данном объёме.
Смысл подлинной наноэлектроники (10–1,0 нм) заключается в приближении к размерам постоянной кристаллической решётки, к примеру, кремния, германия, арсенида галлия (в пределах 0,54–0,56 нм). Приближение к технологической субнаноразмерности – это ключ к сверхэнергии (сверхчастоте) – E = hn, а та нация, которая владеет этой сверхэнергией, обладает сверхмощностью. Вот почему стратегически важно не уступать технологиям компании Intel на материалах AIIIBV, то есть на том же GaAs. Но пока, к счастью, предлагаемая нами технология получения монокристаллов GaAs имеет значительные преимущества.
Динамические свойства бета-источника питания
Из элементарной физики известно, что электрическая энергия измеряется произведением ватт на секунду (Дж) или, как общепринято, в кВт × час (3,6 × 106 Дж) То же самое и в бета-источнике питания. В связи с этим очень важно знать, а что же «выдаст» бета-источник питания для обеспечения взмаха крыльев MAV–стрекозы с частотой до 100 Гц или для работы бортового пассивного микрорадара, допустим, в середине X-диапазона (10 ГГц)?
Ещё раз подчеркнём ранее упомянутый фактор, а именно: если изотоп 147Pm с энергией 220 кэВ имеет флюенс/см2 1010 в секунду, то число генерируемых электронов в полупроводнике будет порядка 1,7 × 1014 (в лучшем случае) за 1,0 с. Следовательно, на частоте 10 ГГц электронов будет всего 10 000, то есть меньше, чем от воздействия одного высокоэнергетичного электрона. Другими словами, при работе микро-P-HEMT надо надеяться, что хотя бы один электрон изотопа попадёт в кристалл. Вот и все расчёты. Для количественной оценки уместно привести хотя бы приблизительную формулу расчёта динамической энергии ΔEi:

где τ – время обработки сигнала (допустим, 10-10 × с), n – концентрация генерируемых электронов, η – КПД генерации бета-ЭДС. Отсюда вытекает, что если мы используем «слабые» по флюенсу изотопы, хотя и с хорошей энергией, то мы ничего серьёзного не получим, как например, в случае давно известного технеция (99Te) при энергии электронов 292 кэВ, в принципе, такая оценка применима и для 63Ni.
Для полупроводниковой бета-вольтаики нужны мощные, сверхрадиоактивные изотопы с энергиями, близкими к 220–250 кэВ и с периодом полураспада хотя бы год или два. Факти-чески, нужен аналог 147Pm с флюенсом выше чем 1012–1013 см-2 × с. В таком случае можно выстраивать бета-источники, приближающиеся к фотовольтаике на уровне единиц процентов. Но и это не всё. На динамику бета-источника питания исключительное влияние имеет… динамическая нагрузка, то есть скорость отбора генерируемого заряда в твёрдотельном вакууме (в данном случае из кристаллической решётки GaAs) – объёмная масса частиц атома полупроводника, включающая в себя ядро: протоны/нейтроны и орбитальные электроны, допустим, в таких тяжёлых полупроводниках, как Ge или GaAs, – не более 10% общего объёма (для сравнения, в атоме водорода всего 2,0%), а остальное пространство – это электромагнитная масса, из которой можно получить в будущем мегаэффективные генераторы). В системе 147Pm/GaAs в твердотельный вакуум вбрасывается релятивистский электрон со значительной энергией, допустим, ≈ 100 кэВ при флюенсе/см2 1010 и, следовательно, за τ = 10-10 × с мы имеем «удар» одной элементарной частицы, имеющей начальную скорость V = ½ С (1,6 × 1010 см/с), которая затем, в конце концов, в глубине кристалла гасится до «зонной», то есть в i-объёме до уровня ≈ 106 см/с при E ~ 100 В/см (критическая электропрочность в GaAs ≈ 4–6 × 105 В/см).
В процессе гашения пролётной скорости электрона от релятивистской до зонной мы имеем фактически преобразование энергии изотопного электрона с длиной волны де Бройля от 100 кэВ до ширины запрещённой зоны – 1,43 эВ (проводящее состояние). Вопрос в том, какова динамика преобразования? Физическое, очень глубокое понимание процесса бета-преобразования в «зону» изложено в работе «Электронная микроскопия и ионная спектроскопия» [1]. Механизм рассеяния энергии высокоэнергетичного электрона путём упругих, неупругих взаимодействий изотопного электрона с орбитальными (оболочными) электронами приводит к «дроблению» энергии электрона изотопа в генерационную коллективную энергию зонных электронов (см. рис. 6). Но на рисунке 6 не показаны другие виды генерации энергий электронов в процессе рассеяния электрон/электрон и электрон/ядро, а также необходимо сюда приплюсовать и энергию g-квантов тормозной энергии электрона в кулоновском поле ядра с длиной волны λ = 1,24/Е, где [λ] = нм, [E] = кэВ.
Другими словами, речь идёт о том, что в решётке GaAs генерируются электроны с промежуточной длиной волны де Бройля гораздо большей начальной, и с промежуточными скоростями генерируемых электронов в диапазоне от 1,6 × 1010 см/с до 106 см/с. В связи с этим и возникает вопрос: а сколько времени «живёт» эта промежуточная энергия, пока кристалл не «успокоится», то есть не придёт к своему обычному «зонному состоянию»? И сможет ли «сверхбыстрая» неравновесная энергия генерации достичь контактов? Попробуем обосновать, что это, в принципе, возможно. Прежде всего, необходимо отметить, что при пробеге электрона в кристаллической решётке GaAs, конечно, будет присутствовать угол рассеяния электронов, который характеризуется начальным и конечным сечением процесса s.
Из работы «Электронная микроскопия и ионная спектроскопия» [1] известно, что начальное сечение процесса s взаимодействия электрона с решёткой твёрдого тела, зависящее от плотности атомов решётки, атомного веса на глубинах в десятки нанометров от поверхности, составляет σ ≈ 10-25 м2 при энергии электрона E = 100 кэВ.
Исходя из того, что в GaAs допустима энергия облучения вплоть до 225 кэВ (см. таб. 1), угол рассеяния электронов в GaAs будет очень мал. Сделаем грубые допущения, что радиационный (плазменный) канал имеет форму конуса от поверхности облучения с верхним сечением ≈ 10-25 м2 до нижнего основания на глубине 50 мкм с радиусом r = 5 нм (то есть пло-щадью сечения π2 → 10-16 м2 или в миллиард раз большей, чем верхнее сечение). В таком случае в объёме конуса V = 1/3πr2 × h будет сосредоточено ≈ 19 × 108 атомов, что при конечной генерации электрона с E = 200 кэВ составит ≈ 60 000 зонных электронов, а это соответствует уровню легирования ≈ 1018 см-3 донорной примеси в полупроводнике. На самом деле конус имеет на порядки меньшее нижнее сечение и, следовательно, даже сверхлёгкие электроны с энергиями больше, чем водородоподобная запрещённая зона (энергия ионизации атомов GaAs ≈ 6,8 эВ), будут иметь очень большую плотность в плазменном электронно-дырочном канале, стремящуюся к уровню > 1018 см-3. В таком случае, из слабого приближения бета-генерации V = µE скорость сверхлёгких электронов будет не меньше 108 см/с (в GaAs максимальная «зонная» скорость пролёта электронов – 2 × 107 см/с, а подвижность электронов может достигать при энергиях до ≈ 7 эВ до половины значения такого «сверхподвижного» полупроводника, как InSb (0,18 эВ). В таком случае возникает вопрос: а как эффективно «собирать» сверхлёгкие электроны в том же СВЧ-диапазоне? И далее: что же с временем пролёта электронов в ОПЗ шириной 50 мкм? Из приведённых рассуждений вы, вероятно, поняли, что поверхность области пространственного заряда в данном случае не является эквипотенциальной, и она в филаментарных объёмах (в субнано/наноскопических объёмах) при уровне плотности «сверхлёгкой» электронно-дырочной плазмы > 1018 см-3 составит ширину ОПЗ всего не более 100 нм. Фактически, это – субнано-, нано-плазменный генератор, с другими механизмами скорости пролёта носителей, которые будут близки к временам релаксации в полупроводнике. Как же конструктивно «собрать» такую мгновенную энергию по разные стороны ОПЗ i-слоя GaAs? На первый беглый взгляд есть два варианта. Один из них – на высоколегированные нанослои наносить, например, «прозрачную» для 100 кэВ плёнку металла в несколько десятков нанометров, допустим, плазмоидного алюминия. В другом варианте, вероятно, более эффективном, на поверхности i–n- и i–p-областей i-слоя GaAs можно вырастить от 30 нм «собственного» германия, в котором образуется очень плотный 2ДЭГ (> 1014 см-2), который, обладая прекрасной подвижностью электронов, выполнит необходимую дивергенцию генерируемых зарядов в сверхлёгкой плазме. Напомним, что, в отличие от гетероструктуры Si-Ge, система Ge-GaAs имеет очень хорошее физическое согласование (по построенной решётке они практически идентичны: по а = 0,56 нм, а по ТКР расхождение составляет ≈ 1–2%, в то время, как рассогласование решёток Si и Ge составляет более 4,0% (что для эпитаксии на грани фола). По ТКР разница вовсе катастрофическая: почти в 2,5 раза (!), что в итоге скажется на возможности достижения высоких рабочих температур. Необходимо отметить и высокую подвижность дырок в собственном германии ≈ 2 × 103 см2/В × с, что почти в два раза выше подвижности электронов в GaN. Сюда же, в качестве положительного показателя, следует отнести и высокую радиационную стойкость Ge к дефектообразованию пар Френкеля > 350 кэВ, а это говорит о возможности расширения выбора высокоэнергетичных изотопов для системы Ge–i-GaAs.
В актив бета-процессов в LPE i-GaAs можно отнести и поглощение квантового излучения рентгеновского диапазона, который имеет угол излучения 2π, то есть во всем объёме кристалла полупроводника, прилегающего к плазменному генерационному каналу (не путать с «тормозным» излучением при траектории электрона в ядерном кулоновском поле, которое резко анизотропно и, фактически, является волновым каналом для облегчения пролёта электронов в решётке). Рентгеновские кванты поглощаются достаточно сильно легированной амфотерными атомами кремния или германия решёткой GaAs, допустим, на типовом уровне ~ 1 × 1015 – 5 × 1015 см-3 с энергией ионизации (по водороду) ≈ 0,7 эВ, что приведёт к генерации одновременно (!) электронов и дырок (попарно, поскольку это и акцепторные, и донорные примесные центры), идентичной фото–ЭДС-генерации (солнечная фотовольтаика), что также усилит КПД бета-источника питания на основе LPE i-GaAs.
Влияние поверхности p–n-переходов на эффективность бета-источников питания
Известно, что дивергенция тока через равновесный p–n-переход равна нулю, то есть в объёме p–n-перехода генерационный ток уравновешивается рекомбинационным. При радиационном воздействии электроном на кристалл мы смещаем равновесие в сторону генерации, но вопрос в том, насколько эффективно. Эффективность зависит от рекомбинационных процессов как в объёме полупроводника, так и на поверхности, и будет сильно зависеть от времени жизни носителей заряда. Площадь поверхности p–n-переходов в бета-источниках достигает значительных размеров, и токи «обратной» утечки будут резко снижать долю генерируемых электронно-дырочных пар. В этой ситуации очень важно энергетически оптимально связать энергетику поверхности в части резкого снижения плотности поверхностных зарядовых состояний Nss/cм2 до уровня не выше чем 1011 см-2. Во-вторых, необходимо, чтобы эти заряды не «двигались» при высоких рабочих температурах и не усиливали обратный паразитный ток через p–n-переход во время бета-генерации. В-третьих, что исключительно важно, необходимо, чтобы поверхность p–n-перехода была невосприимчива к электронной радиации или, во всяком случае, была бы нивелирована до сверхмалых величин – уровня единиц, максимум десятков фемтоампер. С этой задачей на кремнии неплохо справляется пассивация в виде системы SIPOS (поликремний/оксид/нитрид) или стёкла на основе Al2O3/PbO/SiO2. На арсениде галлия проблема решается сложнее. GaAs – чрезвычайно энергетически активный материал на границе раздела GaAs-среда. Обеднение молекулами As, мгновенное образование хемосорбных оксидных соединений в атмо-сфере (до пяти типов оксидов), активная адсорбция – всего, что есть в пограничной среде, делает его поверхность неуправляемой, что, конечно, сказывается на уровне поверхностной рекомбинации зарядов, вплоть до токов практически короткого замыкания. Распространённая практика пассивации полуизолятора GaAs в P-HEMT, MESFET, Ганна-диодах, GaAs SBD на основе нитрида кремния с его плотностью состояний на границе раздела Si3N4/GaAs на уровне от 1013 см-2 и выше, ни к чему хорошему не приведёт. Это сложная задача, но мы её решили: получили ALD-защиту LPE GaAs p–i–n-перехода, которая гарантирует «темновые» токи на фемтоамперном уровне и, что очень важно, при высоких рабочих температурах, вплоть до +300°С. Факти-чески, это исключительное технологическое достижение, полученное нашими партнёрами по проекту, разработчиками ALD-технологии пассивации поверхности i-GaAs. Это неоценимый результат, открывающий дорогу для новой электронной индустрии.
Заключение
Толстые слои физического LPE GaAs p–i–n-перехода (50–100 мкм) обеспечивают возможность создания бета-источников с двухсторонней изотопной планаризацией и, следовательно, удвоения и без того высочайшей эффективности бета-преобразования (в СССР в г. Томске при создании СВЧ-приборов для Х-диапазона была отлажена технология с GaAs-кристаллами с толщинами ≈ 60 мкм).
Для эффективных бета-источни-ков питания необходимы более совершенные, энергоплотные (> 50 мкВт/см2) изотопные источники электронов с энергиями до 250 кэВ и с более значительными флюенсами электронов в секунду, по сравнению с 113mCd и 147Pm, конкурирующие с современ-ными РЭМ. Россия обладает исключительно высоким технологическим уровнем производства радиоизотопов (источников бета- и альфа-час-тиц) в целом ряде ядерных центров и НИИ, химико-технологических комбинатов, с применением реак-торных, циклотронных и других технологий.
Вполне возможно, что со временем более эффективной технологией создания микро-АЭС станет бинарное преобразование энергии на основе продуктов распада в виде частиц α → β с высочайшей энергетикой и значительно более высокими мощностными характеристиками (до десятков ватт/дм3).
Технологии бета-вольтаики на основе LPE i-GaAs c очень высокой вероятностью могут использоваться для терагерцового (СВЧ) генерирования, инфракрасных излучателей (ионизация глубоких амфотерных центров с высокой концентрацией, до 1017 см-3), а также портативных рентгеновских генераторов (Х – тормозное излучение электронов).
Конструкция бета-источника питания на основе LPE i-GaAs патентуется авторами статьи.
Литература
- Чеченин Н.Г. Научно-техническая библиотека НИИЯФ МГУ. Курс лекций «Электронная микроскопия и ионная спектро-скопия».
- Нагорнов Ю.С. Монография «Современные аспекты применения бетавольтаического эффекта». г. Ульяновск. 2012.
- Revankar Shripad T., Adams Thomas E. Advances in Power Sources. J. Energy Power Sources. Vol. 1. No. 6. 2014. Pp. 321–329.
- Акульшин Ю.Д., Лурье М.С., Пятышев Е.Н., Глуховской А.В., Казакин А.Н. Бета-вольтаический МЭМС-преобразователь энергии. Научно-технические ведомости СПбГПУ. Информатика. Телекоммуникации. Управление. 2014. № 5(205). С. 35–42.
- Adams Thomas E. Status of Betavoltaic Power Sources for Nano and Micro Power Applications. Purdue University. Nuclear engineering. Global Deterrence and Defence Symposium. Bloomington / Monroe County. Indiana. USA. September. 2011.
- Войтович В.Е., Гордеев А.И., Думаневич А.Н. Новая экстремальная электроника на основе LPE i-GaAs монокристаллов. Современная электроника. 2014. № 6.
- Гордеев А.И. Электроника как одна из основ национального суверенитета. Силовая электроника. 2014. № 6.
- Tin Steven, Lal Amit. Ultra-High Efficiency High Power Density Thinned-Down Silicon Carbide Betavoltaics. SonicMEMS Laboratory. School of Electrical and Computer Engineering. Cornell University Ithaca. NY. USA. PowerMEMS. 2009. Washington. DC. USA. December 1–4. 2009.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!