Введение
Силовые полевые МОП-транзисторы широко используются в бортовых системах космических аппаратов в цепях синхронного выпрямления, в качестве основных элементов преобразователей в системах электропитания и силовых ключей.
Задача разработки и серийного производства отечественной радиационно-стойкой компонентной базы в целях импортозамещения чрезвычайно актуальна в настоящее время. Так, в соответствии с постановлением Правительства Российской Федерации от 26 ноября 2007 г. №809 о федеральной целевой программе «Развитие электронной компонентной базы и радиоэлектроники на 2008–2015 гг.», разработка и серийное производство радиационно-стойких отечественных силовых транзисторов является одним из приоритетных направлений развития российской электронной отрасли [1].
В настоящее время в РФ производятся силовые транзисторы, которые не отвечают современным требованиям, предъявляемым производителями космической техники к компонентной базе в том, что касается электрических характеристик и стойкости к ионизирующим излучениям (см. табл. 1). Поэтому ЗАО «Промышленные технологии» ведёт разработку радиационно-стойких силовых МОП-транзисторов n- и p-типов с блокирующими напряжениями 200, 100 и 60 В.
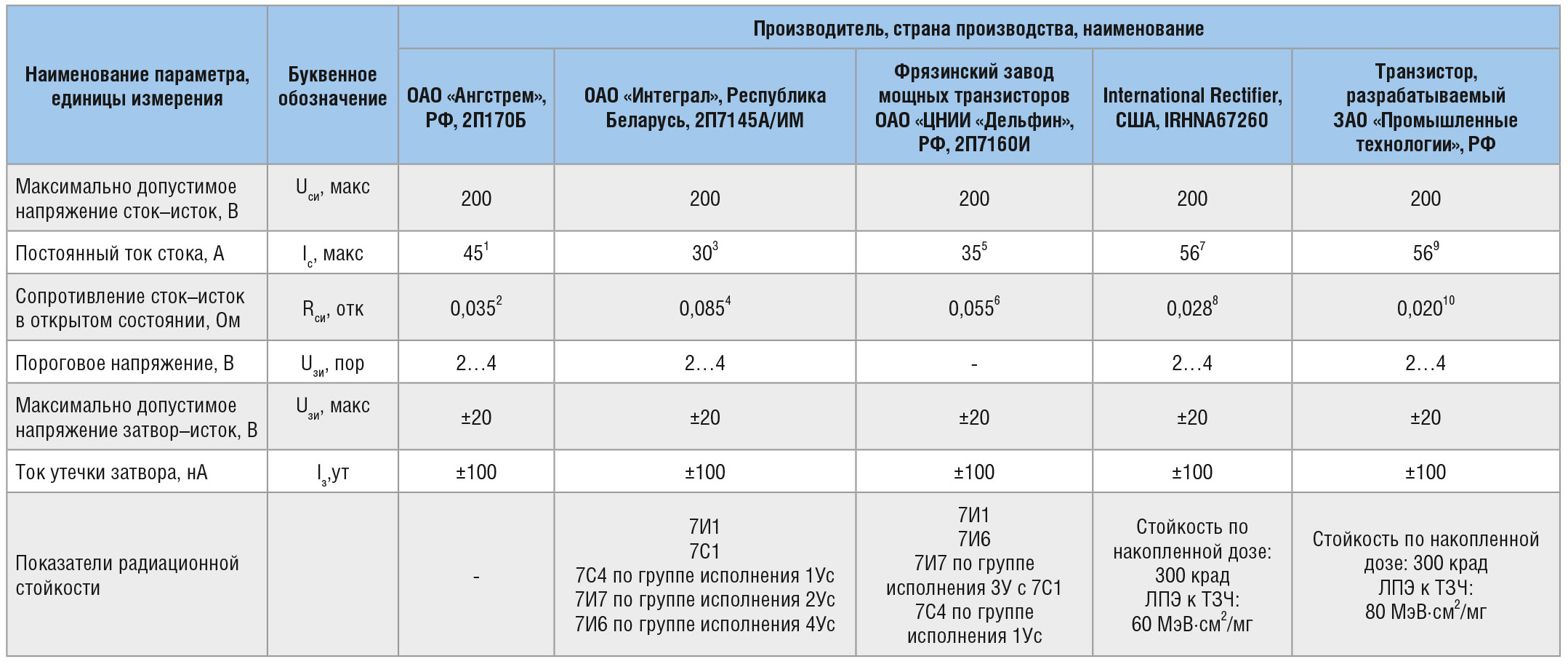
В 1970-х гг. началось производство силовых планарных МОП-транзисторов по технологии двойной диффузии. Силовые МОП-транзисторы имеют вертикальную структуру – носители заряда движутся от истока, расположенного на поверхности кристалла, вертикально к стоку на другой стороне кристалла. В структуре прибора также имеется эпитаксиальный слой кремния, толщина и уровень легирования которого определяется значением блокирующего напряжения, на которое рассчитан прибор.
В 1990-х гг. появились силовые МОП-транзисторы, произведённые по технологии «тренч», то есть канавок, полученных плазмохимическим травлением эпитаксиальных пластин кремния. По сравнению с планарной, эта технология обладает следующими преимуществами:
- радикальным снижением сопротивления открытого канала [2];
- низким значением произведения заряда затвора на сопротивление открытого канала [3];
- улучшенными динамическими характеристиками вследствие уменьшения паразитных ёмкостей [4].
На рисунке 1 показан кристалл силового транзистора, разрабатываемого ЗАО «Промышленные технологии».
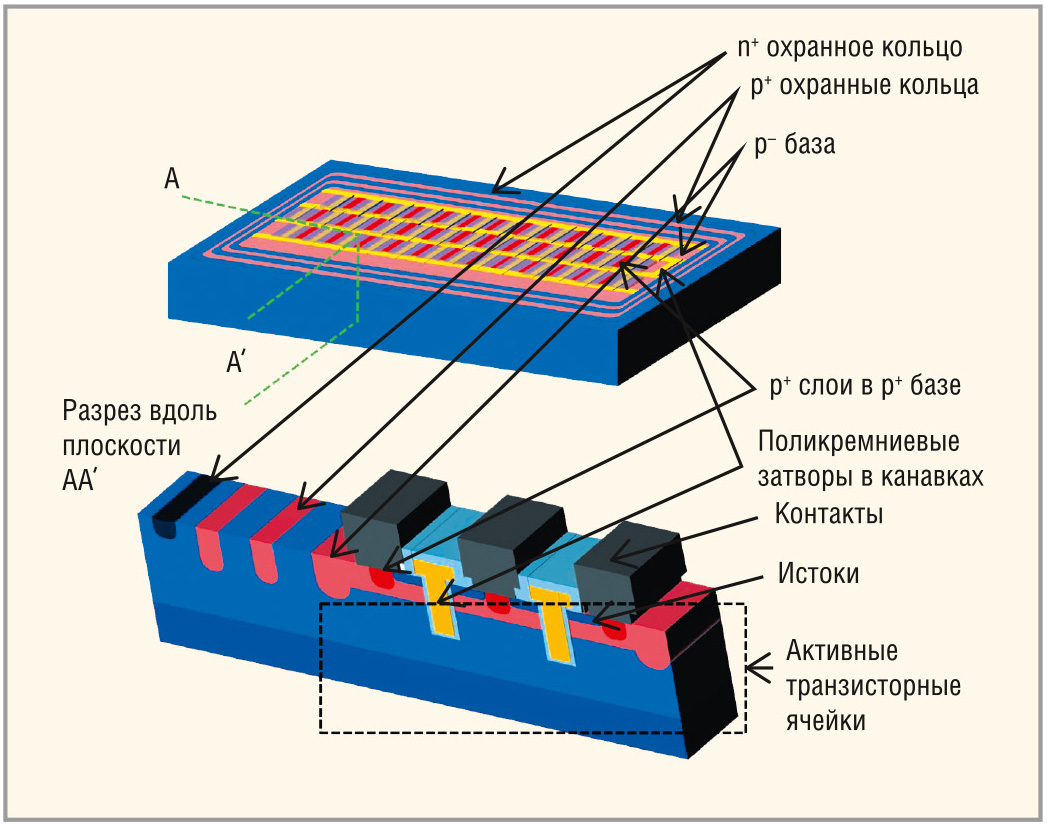
Преимущества электрических характеристик МОП-транзисторов с «тренч»-затворами, по сравнению с обычными планарными транзисторами, стимулировали выпуск радиационно-стойких приборов, специально созданных для космических применений. Радиационная стойкость таких МОП-транзисторов требует дополнительных испытаний, поскольку наличие затвора в канавке и более сложная картина распределения силовых линий электрического поля (по сравнению с планарным ДМОП-транзистором), в процессе работы транзистора усложняет его реакцию на воздействие ионизирующих излучений.
Электрические характеристики МОП-транзисторов в значительной степени подвержены деградации из-за накопленной дозы радиации и одиночных радиационных эффектов (одиночного эффекта выгорания и одиночного эффекта пробоя подзатворного диэлектрика). Рассмотрим более подробно влияние одиночных эффектов на характеристики мощных МОП-транзисторов, в частности, с «тренч»-затворами.
Одиночный эффект выгорания
Одиночные радиационные эффекты возникают из-за взаимодействия высокоэнергетических тяжёлых ионов и протонов (тяжёлых заряженных частиц, ТЗЧ) с полупроводниковым материалом транзистора. Частицы ионизируют атомы кремния на своём пути следования в толще материала. Кроме того, вторичные частицы, возникающие из-за упругих и неупругих столкновений ядер атомов материала, также приводят к его ионизации.
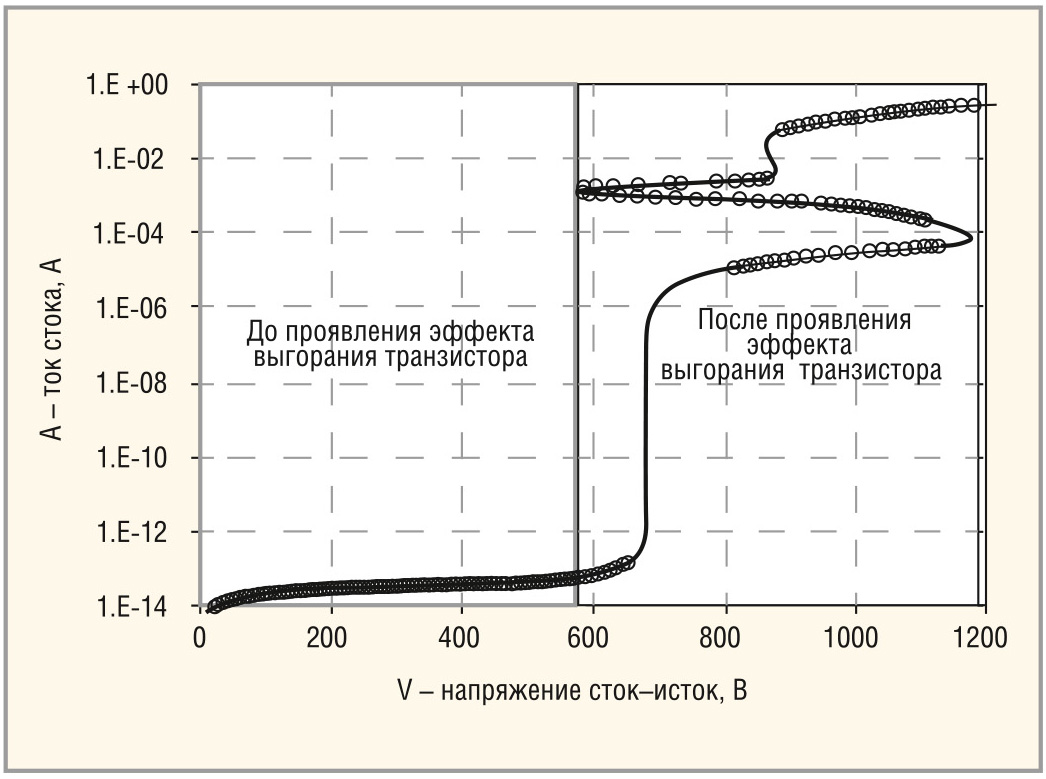
На рисунке 2 представлены вольтамперные характеристики МОП-транзистора на различных стадиях электрического пробоя [5]. При увеличении напряжения сток–исток до определённого значения, МОП-транзистор входит в режим нормального лавинного пробоя. С ростом напряжения на истоке данный процесс продолжается до тех пор, пока падение напряжения внутри p-области не активирует паразитный биполярный транзистор. После этого МОП-транзистор уже не может выдерживать высокие значения напряжения сток–исток. При этом ток стока продолжает увеличиваться, а напряжение на стоке – падать. Из-за обратной связи наступает вторичный пробой, который приводит к короткому замыканию между стоком и истоком, что разрушает прибор.
![Рис. 3. Токи стока и затвора, возникающие вследствие выгорания транзистора под воздействием ТЗЧ [5]](/images_soel/publications/2015/2015-6/СоЭл_2015-6pr_page56_pic3.jpg)
На рисунке 3 представлены графики изменения токов утечки стока и затвора до и после облучения ТЗЧ, которые вызывают выгорание транзистора. В момент времени t = 0 ток истока равен 10–8 А, а ток затвора – 10–10 А. Перед переходом транзистора в состояние выгорания вышеуказанные токи утечки определяются параметрами прибора, а также измерительной установкой. В момент времени t = 50 нс наблюдается значительное увеличение тока стока. При этом ток затвора остаётся неизменным.
Одиночный эффект пробоя подзатворного диэлектрика
При прохождении ТЗЧ в эпитаксиальном слое силового транзистора генерируются электронно-дырочные пары. В вертикальном электрическом поле происходит разделение заряда: дырки дрейфуют в сторону интерфейса Si/SiO2, а электроны – в сторону стока. Кроме того, электроны и дырки радиально диффундируют из ионизационного следа.
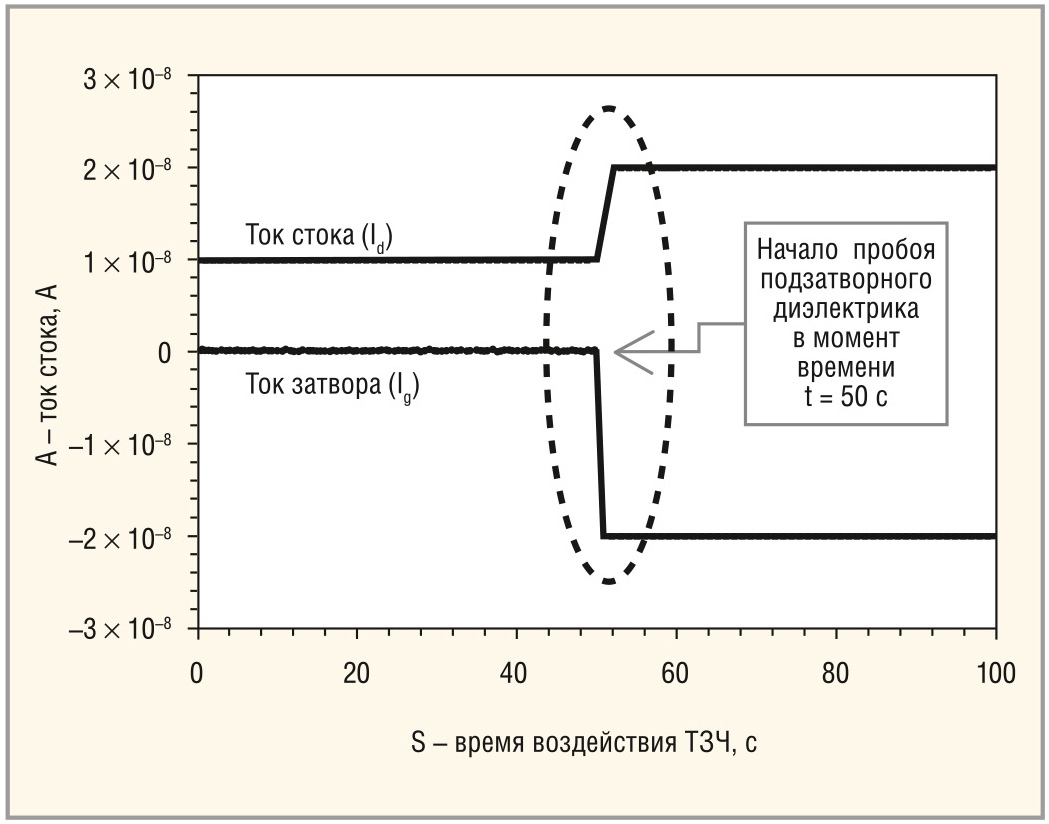
На границе окисел–полупроводник накапливается избыточная концентрация дырок. Это связано с тем, что дырки дрейфуют в горизонтальном электрическом поле медленнее, чем электроны – в вертикальном. Аккумуляция дырок на границе Si/SiO2 приводит к появлению дополнительного заряда, а значит дополнительного электрического поля, которое запускает пробой подзатворного окисла. На рисунке 4 представлены электрические характеристики транзистора (ток стока и ток затвора) до и после пробоя подзатворного диэлектрика [5]. В момент времени t = 0 нс ток стока равен 10–8 А, а ток затвора – 10–10 А. В момент времени t = 50 нс ток затвора значительно увеличивается. Также ведёт себя и ток стока.
Условия проявления одиночного эффекта пробоя подзатворного диэлектрика и эффекта выгорания
На рисунке 5 представлены графики пороговых напряжений, при которых наступает пробой подзатворного диэлектрика при больших значениях напряжения на затворе. При этом напряжение сток–исток может быть малым (см. область I на рис. 5) [6].
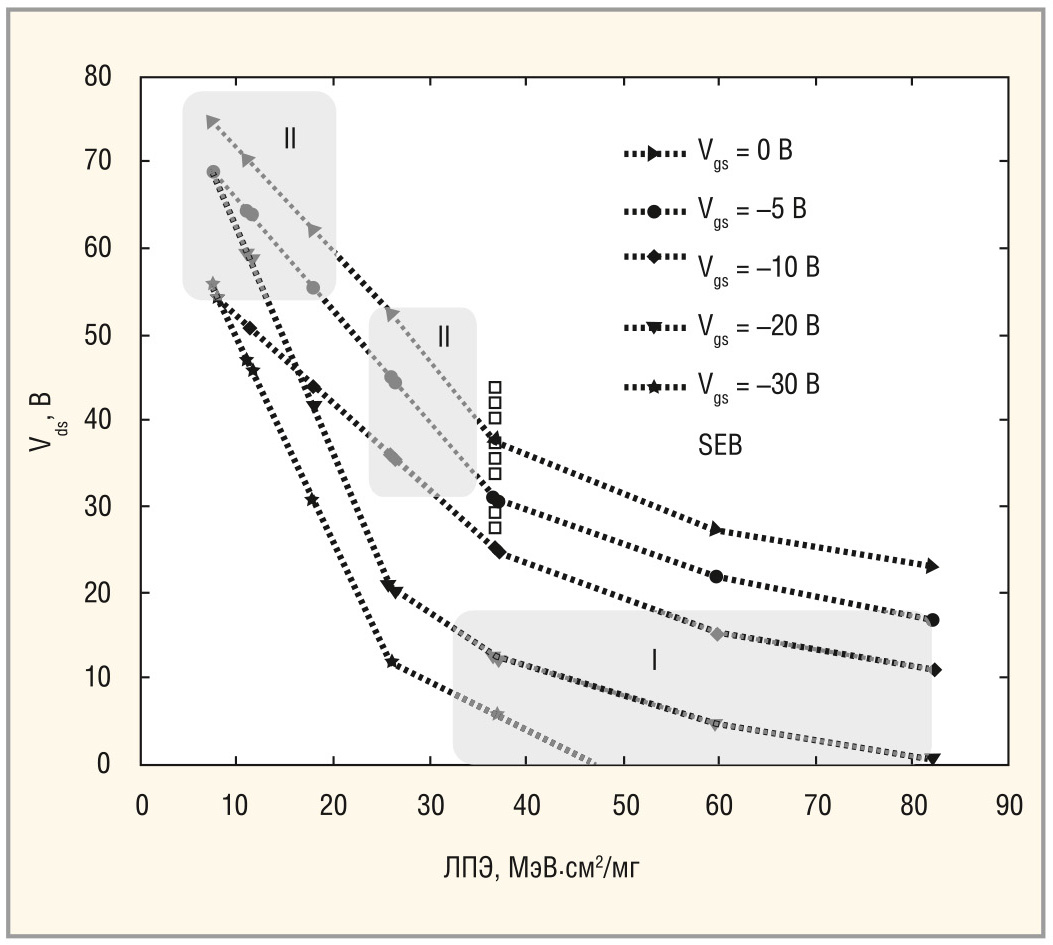
В области малых значений напряжения сток–исток не проявляет себя эффект выгорания, так как пиковая напряжённость электрических полей в эпитаксиальном слое недостаточна для поддержания лавинного пробоя. При малых напряжениях на затворе транзистора и достаточно больших значениях напряжения сток–исток возможно совместное проявление выгорания транзистора и пробоя диэлектрика. В области III напряжение на затворе слишком мало, чтобы инициировать пробой диэлектрика первым (малые значения линейных потерь энергии – ЛПЭ), однако вероятность выгорания транзистора высока из-за высокого напряжения сток–исток. Следовательно, доминирующим механизмом катастрофического отказа является одиночный эффект выгорания транзистора. В области II возможно либо выгорание транзистора, либо пробой диэлектрика под воздействием ионизирующих излучений (для одинаковых значений напряжений Vgs, Vds и ЛПЭ).
Результаты испытаний транзисторов, изготовленных по технологии «тренч», на одиночные эффекты
В настоящее время опубликовано незначительное число результатов испытаний, описывающих влияние одиночных радиационных эффектов на электрические характеристики «тренч»-МОП-транзисторов. Далее представлены результаты испытаний воздействия ТЗЧ на МОП-транзисторы следующих производителей: International Rectifier (США) – IRHLF87Y20SCS, Vishay – SUM45N25-58, Vishay – Si7431DP. Электрические характеристики транзисторов сведены в таблицу 2.

Из анализа рисунков 6–8 следует, что только один из рассматриваемых приборов (International Rectifier) не изменяет своего значения пробивного напряжения (при приложенных напряжениях затвор–исток вплоть до ~2,5 В) под воздействием ТЗЧ (в данном случае ионов брома, йода и золота).
![Рис. 6. Результаты испытаний на одиночные радиационные эффекты для SUM45N25-58 [7]: Vds – напряжение сток–исток; Vgs – напряжение затвор–исток](/images_soel/publications/2015/2015-6/СоЭл_2015-6pr_page57_pic6.jpg)
![Рис. 7. Результаты испытаний на одиночные радиационные эффекты для Si7431DP [8]: Vds – напряжение сток–исток; Vgs – напряжение затвор–исток](/images_soel/publications/2015/2015-6/СоЭл_2015-6pr_page58_pic7.jpg)
![Рис. 8. Результаты испытаний на одиночные радиационные эффекты для IRHLF87Y20SCS [9]: Vds – напряжение сток–исток; Vgs – напряжение затвор–исток](/images_soel/publications/2015/2015-6/СоЭл_2015-6pr_page58_pic8.jpg)
С ростом значений напряжения затвор–исток происходит быстрая деградация прибора. Транзистор SUM45N25-58 производства Vishay обеспечивает радиационную стойкость только для половины заявленного блокирующего напряжения (см. рис. 6). Характеристики p-канального транзистора Si7431DP (Vishay) стабильны при облучении ионами криптона до напряжений затвор–исток 5 В (см. рис. 7).
Заключение
Использование технологии изоляции канавками в производстве радиационно-стойких силовых полупроводниковых приборов – новое направление развития электроники для космических применений. Сложная физика одиночных радиационных эффектов и другая конструкция полупроводниковых приборов требуют модификации существующих конструктивно-технологических подходов обеспечения радиационной стойкости вновь разрабатываемых приборов.
Литература
- Постановление Правительства Российской Федерации от 26 ноября 2007 г. №809 о федеральной целевой программе «Развитие электронной компонентной базы и радиоэлектроники на 2008–2015 гг.». www.consultant.ru/document/cons_doc_LAW_158088.
- Jayant Baliga B. Trends in Power Semiconductor Devices. IEEE Transactions on Electron Devices. 1996. V. 43. №10. P. 1717–1729.
- Ma L., Amali A. et al. New Trench MOSFET Technology for DC/DC Converter Applications. Power Semiconductor Devices and ICs. Proceedings. 2003. P. 354–357.
- Lorenz L. Key Power Semiconductor Devices and Development Trends. International Workshop on Physics of Semiconductor Devices. 2007. P. 743–750.
- Titus J. L. An Updated Perspective of Single Event Gate Rupture and Single Event Burnout in Power MOSFETs. IEEE Transactions on nuclear science. 2013. V. 60. № 3. P. 1912–1920.
- Allenspach M. SEGR and SEB in N-Channel Power MOSFETS. IEEE Transactions on Nuclear Science. 1996. V. 43. № 6. P. 2927–2931.
- Lauenstein J-M. et al. Recent Radiation Test Results for Power MOSFETs. Proceeding of 2013 Nuclear and Space Radiation Effects Conference. 2013.
- Lauenstein J-M. et al. SEE Test Report, V. 2. Single Event Effects Testing of the Vishay Si7431DP P-Type Power MOSFET. 2011.
- www.irf.com/product-info/datasheets/data/irhlf87y20.pdf.
Если вам понравился материал, кликните значок — вы поможете нам узнать, каким статьям и новостям следует отдавать предпочтение. Если вы хотите обсудить материал —не стесняйтесь оставлять свои комментарии : возможно, они будут полезны другим нашим читателям!